Secondary Ion Mass Spectrometry -Time of Flight Secondary Ion Mass Spectrometry-
石川 修司*1
SIMS(二次イオン質量分析)の始まりは1960年代後半頃からである。原理的には、イオンビームを固体試料に照射して、表面から発生する二次イオンを質量分析するものであるが、 質量分析計の方式により、扇型の電場と磁場を組み合わせたセクタータイプのSIMS、四重極型質量分析計を使用したQ-ポールSIMS、飛行時間型質量分析計を使用したTOF(Time of Flight)SIMS がある。また、測定のモードとして照射イオンの線量により、試料表面を掘り進みながら測定するダイナミックSIMS(D-SIMS)、最表面の情報を非破壊に近い状態で測定するスタティックSIMS(S-SIMS)がある1)。一般的にはセクタータイプ、Q-ポールはD-SIMSとして使用され、TOF-SIMSはS-SIMSとして使用されている。
イオン照射量が少ないTOF-SIMSは、絶縁物の測定が容易であり、比較的低ダメージの測定が可能である。D-SIMSと違い、有機化合物の化学構造をかなり保ったままイオン化できるので、有機化合物の同定が容易であるという特長を持つ。また、最近はクラスタイオンソースの実用化により、m/zが数百以上の高いマスフラグメントの検出が容易になった。さらに、低ダメージでスパッタリングが行える、ガスクラスターイオン銃(GCIB)などの採用により、微量成分、有機物質に対して極表面分析及び深さ方向分析においてもますます有力な手段になってきている。
TOF-SIMS は、大きく分けると一次イオン源、超高真空試料チャンバー、飛行時間型質量分析計から構成される。装置の概観とその構造の一例(ION-TOF社TOF.SIMS5、以下の説明に使用する数値、構造はこの装置に基づく)をそれぞれ図1、図2に示す。
一次イオン源には、液体金属イオン銃(LMIG:Liquid Metal Ion Gun)が使用される。イオンソースとしてはGa、In、質量数が高く、クラスタイオンが使用できるAuなどが使用されてきたが、最近ではクラスタイオン発生率の高いBiが主に使用されている。クラスタイオン(Au(3)+、 Bi(3)+など3量体が一般的)の使用により、質量数が数百の領域での二次イオン検出感度が2~3桁向上する。クラスタイオンを使用するイオン銃では、これらのクラスタイオンを質量で選別する機能を有している。一次イオンは、幅0.7 nsec以下、繰り返し周波数が数KHzから50 KHzのパルスに成型され、さらに数ミクロン以下にフォーカスされて試料上を走査する。試料から発生した二次イオンは、引き込み電極(Extractor Electrode)に電圧を印加し、飛行時間型質量分析計へと導かれる。図のシステムでは、反射型(リフレクトロン)のフライト(ドリフト)チューブを使用していて、2 mの距離を飛行する時間により質量分離を行っている。

図1 TOF-SIMS装置の一例(ION-TOF 社TOF.SIMS5)
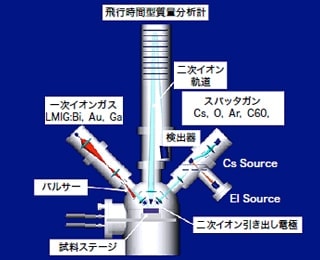
図2 TOF-SIMS の構造の一例
*ION-TOF社製 TOF.SIMS5(*出典元本文末参照)
図3は飛行時間型質量分析計の原理を模式的に示したもので、飛行時間(t)はイオンの質量数(m)の平方根に比例することが分かる。一次イオンパルスが照射され、続いて引き込み電極に電圧が印加され、二次イオンがドリフトチューブを通過して検出器に到達するまでがTOF-SIMSの1サイクルになる。このサイクルの繰り返しにより測定が行われる。
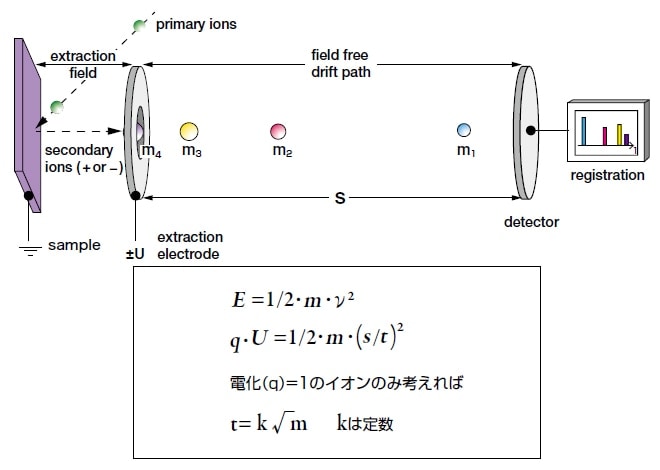
図3 飛行時間型質量分析計の原理
TOF-SIMSでは、通常m>10,000以上の検出が可能である。検出器にはマルチチャンネルプレート、シンチレータとフォトマルチプライアーを組み合わせたものが使用される。ここでイオンはパルス信号に変化され(電流増幅率:約108)、到達時間を横軸としたスペクトルとして記録される。検出系の時間分解能は約50 psecである。
TOF-SIMS装置には、深さ方向の分析を行うための独立したスパッタ専用のイオンガンを装着することができる。これにより、ダイナミックSIMSと同じように、深さプロファイリングの測定が可能になる。図2に主な機器構成を示す。スパッタイオンとしては、主に陰イオン測定を行う場合セシウム(Cs)、陽イオン測定を行う場合には酸素が使用される。深さ方向分析は従来、無機物質に限られていたが、最新の装置ではガスクラスタを利用するGCIB(Gas Cluster Ion Beam)を使用することにより、有機物、高分子試料の深さ方向分析も一般的な分析手法となってきている。
表面測定データの解析には、定性分析を目的としたスペクトル解析と構成物質の面内分布を解析するイメージング解析がある。これらはどちらも生データから再構成できるが、測定時に行なう場合、データの取り込み時間はスペクトル測定のみで1~2分、イメージングを同時作成しながらの場合で数分~十数分である。未知試料の場合は、PositiveとNegative両方のスペクトルを測定する。

図4 *スペクトル例(PET,クリア)(*出典元本文末参照)
測定されたスペクトルデータそのままでは、横軸が時間、縦軸はイオンカウントなので、まず時間軸を質量数に変換するマスキャリブレーションを行う。TOF-SIMSはミリマス測定が可能であり、例えばCHO(29.003u)とC2H5(29.039u)のように同一の整数質量数(単位質量数)の同じフラグメントの分離、 同定が可能である。また、質量精度を高めるためにはキャリブレーションが重要なポイントとなる。

図5 TOF-SIMS SurfaceLab6 質量スペクトル解析
同位体のピーク確認、有機物の場合には分子構造が分かっていれば、近傍にあるピークとの質量差やフラグメンテーションの妥当性を考慮しながら、ピークの同定を進めてゆくことになる。ソフトウェアには、この検討を支援するツールが用意されている。
イメージ解析を目的とした測定には、ステージを固定して、500 µm角から10 µm角程度の視野観察ができるビームラスターと、ステージ動作を組み合わせながら、標準システムでは最大9 cm角の視野を観察するステージラスターの二つの方式がある。
また、イオンビームの設定により、さまざまな測定が可能になる。通常一次イオンビームは高質量分解能(M/ΔM ≒12,000)を得るために、パルス圧縮(バンチング)をかけて使用する。このモードでは、収束レンズの色収差によりビーム径は1-2 µm程度となり、観察視野範囲は100 µm程度が下限となる(最新の装置では、ビーム径0.6 µm以下に調整が可能となっている)。通常 TOF-SIMSでは、空間分解能(ビーム径)と質量分解能はトレードオフの関係になり、空間分解能を優先するモード(図6のBurst Alignment)の場合、ビーム径120 nm、視野範囲20 µm程度の観察が容易に可能になる。
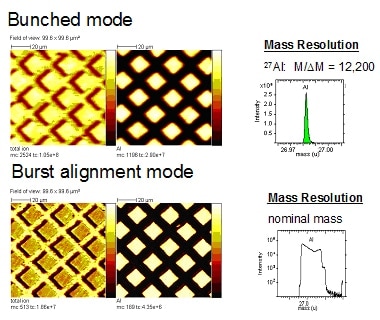
図6 *測定モードによる空間分解と質量分解能(*出典元本文末参照)
絶縁物の測定が可能となったことは、TOF-SIMS が近年特に注目されている大きな要因の一つである。一次イオンの照射によって試料から大量の二次電子が発生するためにプラスに帯電するが、TOF-SIMSでは低加速(20 eV 以下)の電子銃を試料に照射することにより容易に中和できる。
図7は液晶のカラーフィルターを測定したものである。測定範囲は50 µm×50 µm、一次イオンソースにBi(3)++を使用し、測定時間は190秒である。ブルーの染料に対しては質量数413、グリーンには641のピーク強度を使用して右に示すイメージングを得ている。
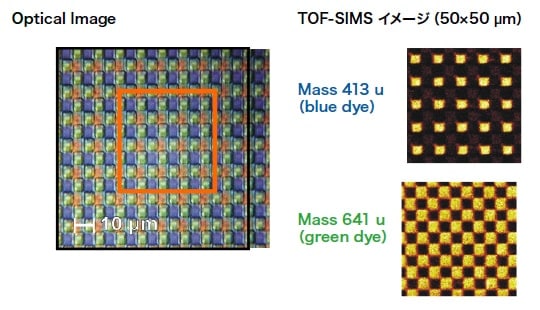
図7 *カラーフィルターの分析例(*出典元本文末参照)
図8は自動車塗装膜の欠陥部(浮きが出た部分)の解析例である。左下が正常部分の質量スペクトルでクリアコート材料からのCxHyのフラグメントピークのみであるが、左上の欠陥部分の質量スペクトルからは潤滑剤からのCxFyのフラグメントが観察された。さらにスペクトルの解析の結果、潤滑剤は搬送ラインの機材のものと同定され、搬送途中に付着したものと判明した。右の画像は潤滑剤とクリアコート、それぞれのイオン強度を三次元表示したものである。
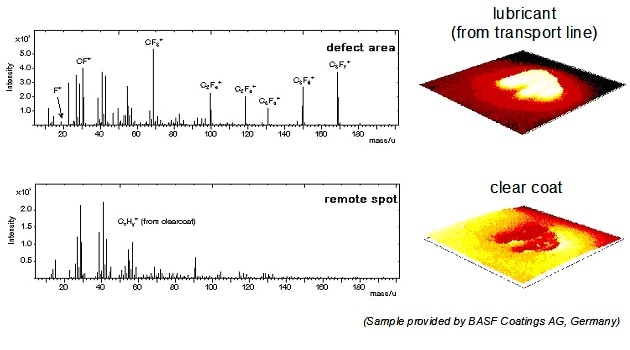
図8 *自動車の塗装の欠陥解析(*出典元本文末参照)
図9は一般的な有機ELの深さ方向分析を行った例である。従来までのTOF-SIMS 分析では、深さ方向へスパッタリングするエネルギーにより有機物情報が破壊され、有機ELを構成する分子情報が得られなかった。測定には斜め切削などの特殊な前処理が必要であったが、GCIBを使用することにより特別な前処理を必要とせず、分析が可能となってきている。なお、GCIBは無機物の深さ方向分析には適さないために、図9のデータはAl電極をグローブボックス内で剥離したのち、トランスファーベッセルによる雰囲気遮断を実施し、装置内へ導入して測定している。同深さ方向の分析を行うことにより、膜成分、界面情報などを得ることができる。
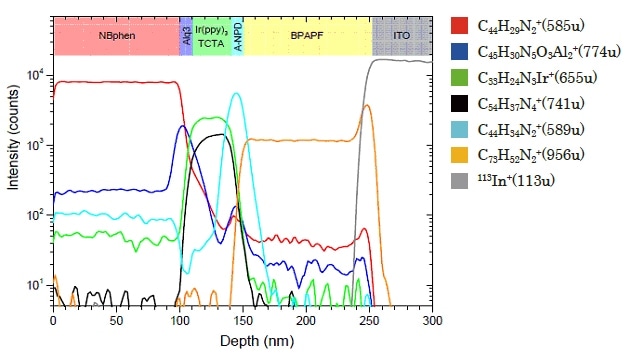
図9 *有機EL 深さ方向分析(*出典元本文末参照)
TOF-SIMSは、不良解析、製品開発のための分析手段として非常に広い産業分野で使用され始めている。各種製品の素材が金属から高分子、それらの複合材料に広がり、構造も微小化されているため、TOF-SIMS でないと分析が困難な試料も多くなってきている。一方で文頭でも述べたように、装置の普及台数はまだまだ他の表面分析装置に比べて少なく、その分析手法、応用範囲に関しての情報提供が充分行なわれているとは言い難い。本稿が読者皆様の分析手法上の問題解決手段として、TOF-SIMS を検討する際の手助けに少しでもなれば幸いである。
本稿の作成においてION-TOF社Dr. M.Terhorstより資料、データの提供(図中*)、助言を頂きましたことを感謝致します。
著者所属
さらに表示