실시간 3D Analytical FIB-SEM 장비 NX9000

3차원 구조 해석의 이상을 추구했습니다
FIB에 의한 단면 제작과 SEM 관찰을 자동으로 반복함에 따라 연속 단면 시리즈 Image를 수집하여 특정 미소 부분을 3차원 구조로 재구축할 수 있습니다.
최적의 칼럼 레이아웃 채용으로 첨단 재료나 Device에서 생물 조직에 이르는 폭넓은 분야에 걸쳐 종래의 장비에서 어려웠던 높은 정밀도의 3차원 구조 해석을 실현합니다.
특징
- SEM 칼럼과 FIB 칼럼을 직각으로 배치하여 3차원 구조 해석에 최적인 칼럼 레이아웃을 실현
- 고휘도 냉음극 전계방출형 전자총과 고감도 검출계의 조합으로 자성재료부터 생물조직까지 다양한 시료의 해석 지원
- 정평이 난 Micro Sampling®*과 Triple Beam® 시스템* 으로 TEM이나 Atom Probe의 고품질 시료 제작 지원
본래의 시료 구조를 충실하게 반영하는 수직 입사 단면 SEM 관찰
SEM 칼럼과 FIB 칼럼을 직각으로 배치함으로써 FIB 가공 단면의 수직 입사 SEM 관찰을 실현.
종래의 FIB-SEM의 경사 단면 관찰에서는 불가피했던 단면 SEM Image의 수축이나 연속 Image 수집 시의 시야 이탈을 회피.
본래의 구조에 충실한 화상을 안정적으로 얻을 수 있어 정밀도가 높은 3차원 구조 해석을 실현.
또, FIB 가공 단면 (SEM 관찰 단면) 이 시료 표면과 평행이 되므로 광학현미경 Image와의 연계 작업이 가능합니다.
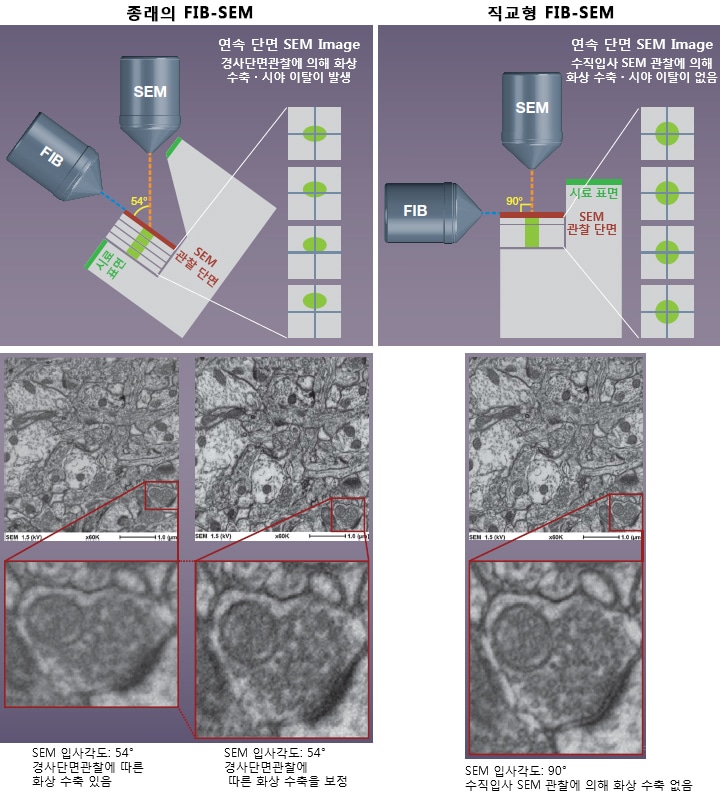
시료: 쥐 뇌신경 세포
시료 제공: 자연과학 연구기구 생리학 연구소 쿠보타 요시유키 님
다양한 재료에 대응하는 Cut&See・3D-EDS*1・3D-EBSD*1
Cut&See
생물 조직 및 반도체부터 철강이나 니켈 등의 자성재료까지. 저가속 전압에서의 고분해능・높은 Contrast 관찰에 대응.
FIB 가공과 SEM 관찰 간, 장비 조건 변경도 불필요하며, 높은 Throughput으로 연속 단면 Image를 수집 가능.
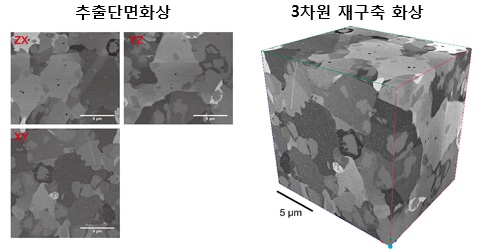
시료: 니켈
SEM 가속 전압: 1 kV
가공 Step: 20 nm
반복 회수: 675회
3D-EDS*1
단면 SEM Image뿐만 아니라 단면 원소 Map의 연속 시리즈 수집에도 대응.
실리콘 Drift식 대구경 입체각도 EDS 검출기*1와 조합하여 측정 시간의 단축・저가속 전압에서의 원소 Mapping도 가능
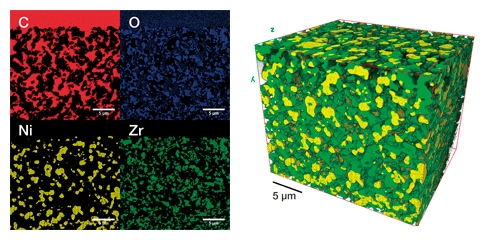
시료: 연료전지전극
SEM 가속전압: 5 kV
가공 Step: 100 nm
반복 회수: 212회
시료 제공: 도쿄대학 생산기술연구소 시카조노 나오키 교수
3D-EBSD*1
SEM・FIB・EBSD 검출기*1 최적의 배치를 통해 FIB 가공과 EBSE 분석 사이에 Stage를 이동할 필요 없이 3D-EBSD를 실현. Stage를 이동하지 않으므로 3차원 결정방위 해석의 정밀도・Throughput을 큰 폭으로 향상.

시료: 니켈
SEM 가속 전압: 20 kV
가공 Step: 150 nm
반복 회수: 150회
*1 반복 회수: 150회
* 「Micro Sampling」은 주식회사 히타치 제작소의 일본 국내 등록상표입니다 (상표등록 제4399203호, 상표등록 제4401176호).
* 「Triple Beam」은 주식회사 히타치 하이테크 사이언스의 일본 국내 등록상표입니다 (상표등록 제5136729호). 2015년 5월 현재 내용. 특허 상황은 심판 등에 따라 변동될 수 있습니다.
*
집속 이온 빔 (FIB) 기술, Micro Sampling 기술에 관하여, 이하의 특허 등을 소유하고 있습니다.
특허 제3547143호, 특허 제3613039호, 특허 제3624721호, 특허 제3677968호, 특허 제3709886호, 특허 제3736333호, 특허 제4096916호, 특허 제4100450호, 특허 제4111227호, 특허 제4177860호, 특허 제4185961호, 특허 제4185962호, 특허 제4185963호, 특허 제4353962호, 특허 제4354002호, 특허 제4570980호, 특허 제4590007호, 특허 제4590023호, 특허 제4612746호, 특허 제5017059호, 특허 제5125174호, 특허 제5125184호, 특허 제4878135호, 특허 제3544438호, 특허 제4570980호, 특허 제5017059호, 특허 제5595054호, 특허 제5710887호, 특허 제5612493호
사양
| 항목 | 내용 | |
|---|---|---|
| SEM | 전자원 | 냉음극 전계방출형 |
| 가속 전압 | 0.1 ~ 30 kV | |
| 분해능 | 2.1 nm@1 kV | |
| 1.6 nm@15 kV | ||
| FIB | 이온원 | 칼륨 액체 금속 이온원 |
| 가속전압 | 0.5 ~ 30 kV | |
| 분해능 | 4.0 nm@30 kV | |
| 최대 빔 전류 | 100 nA | |
| 표준 검출기 | In-column 2차전자검출기/In-column 반사전자검출기/ Chamber 설치 2차전자검출기 |
|
| Stage | X | 0 ~ 20 mm *2 |
| Y | 0 ~ 20 mm *2 | |
| Z | 0 ~ 20 mm *2 | |
| θ | 0 ~ 360° *2 | |
| τ | -25 ~ 45° *2 | |
| 최대 시료 크기 | 각 모서리 6 mm×두께 2 mm | |
*2 시료 홀더에 의한 스트로크 제한이 있습니다
Hitachi FIB Application Data
This journal addresses a wide range variety of research papers and useful application data using Hitachi science instruments.



