電子顕微鏡(SEM/TEM/STEM)

日立電子顕微鏡の歩み
年表で見る日立の電子顕微鏡の歩みをご紹介します。随時改訂公開していきます。
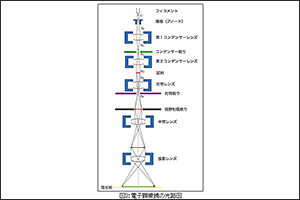
構造細胞生物学のための電子顕微鏡技術
臼倉先生に電子顕微鏡技術のお話しをしていただきました。