FIB-SEM複合装置トリプルビーム®装置 NX2000
特長
高コントラスト・リアルタイムSEM加工終点検知により、20 nm以下の超薄膜試料作製にも対応
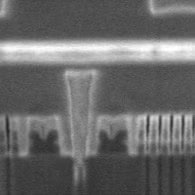
FIB加工中のリアルタイムSEM観察*2例
試料:NANDフラッシュメモリ
加速電圧:1 kV
FOV:0.6 µm
姿勢制御技術(マイクロサンプリング®*2システム(オプション)+高精度・高速試料微動機構*)が、カーテン効果の抑制や均一な厚さの薄膜試料作製に寄与します
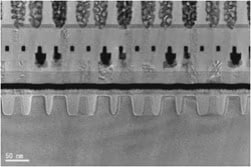
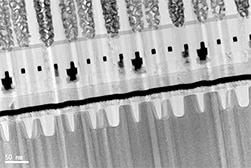
トリプルビーム®*1システム(オプション)が、FIB加工ダメージ除去のスキルレス化・高スループット化を推進します
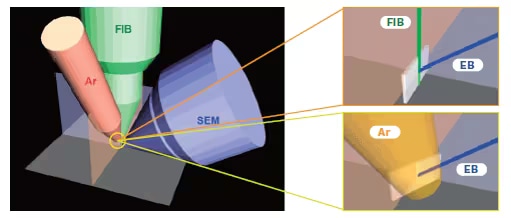
EB:Electron Beam(電子ビーム)
FIB:Focused Ion Beam(集束イオンビーム)
Ar:Ar ion beam(Arイオンビーム)
*1 FIB、Ar/Xeビーム、SEM複合装置「トリプルビーム®」は、日立特許により保護されています(特許第4309711号、 特許第4365438号、特許第4878135号、特許第4995802号など)。また、「トリプルビーム®」は、株式会社 日立ハイテクサイエンスの日本国内における登録商標です(登録商標第5136729号)。
*2 「マイクロサンプリング®」は、株式会社日立ハイテクの日本国内における登録商標です(登録商標第4399203号)。
この特許の記載内容は2014年7月現在のものです。特許の状況は審判等により変動する可能性があります。
仕様
| 項目 | 内容 |
|---|---|
| FIBカラム | |
| 分解能 | 4 nm @ 30 kV、60 nm @ 2 kV |
| 加速電圧 | 0.5~30 kV |
| ビーム電流 | 0.05 pA ~ 100 nA |
| FE-SEMカラム | |
| 分解能 | 2.8 nm @ 5 kV、3.5 nm @ 1 kV |
| 加速電圧 | 0.5~30 kV |
| 電子銃 | 冷陰極電界放出型 |
| 検出器 | |
| 標準検出器 | In-lens SE検出器/チャンバーSE検出器/反射電子検出器 |
| ステージ | X:0 ~ 205 mm Y:0 ~ 205 mm Z:0 ~ 10 mm R:0 ~ 360°エンドレス T:-5 ~ 60° |

特別付属品(オプション)
- Ar/Xeイオンビームシステム
- マイクロサンプリング®*3システム
- 欠陥検査装置とのリンケージソフトウェア
- CADナビゲーションリンケージソフトウェア
- EDS(エネルギー分散型X線分析装置)
- TEM試料仕上加工ウィザード
- TEM試料厚み管理ソフトウェア
- 連続A-TEM
- リアルタイム画質改善システム
- Swing加工機能(トリプルビーム®*1用)
- プラズマクリーナー
- 大気遮断搬送機構
- 冷却ステージ
- 自動 マイクロサンプリング®
自動 マイクロサンプリング®(オプション)
概要
マイクロサンプリング®は、FIB加工による①表面保護、②周辺加工、③底部切断の工程と、精密プローブ操作を伴う④プローブ接着、⑤支持部切断、⑥摘出、⑦TEM試料台への固定、⑧プローブ切断の工程から成ります(図1)。
①~③のFIB加工工程は既に自動化が実現していますが、④~⑧の精密プローブ操作工程は、ユーザーが全ての工程を手作業で行うとともに、三次元で高精度に位置を制御する必要があるため、熟練した操作技術が求められていました。
自動 マイクロサンプリング®システムでは、これまで④~⑧の精密プローブ操作工程において自動化の課題となっていたプローブの先端位置の自動認識に対し、当社が長年培ってきたビームテクノロジーと独自の画像処理・マッチング技術を用いることにより、精密プローブの高精度な自動位置制御を実現しました。これにより、精密プローブ操作工程を自動化し、熟練した操作技術を必要とせず容易にTEM観察用の微小試料の摘出を可能としました。
さらに、複数の加工位置と摘出試料の固定先を事前登録することで無人連続運転を行うことができるため、処理数の増加による解析スループット向上を実現し、半導体デバイスの歩留まり向上や量産体制の早期立ち上げに貢献します。
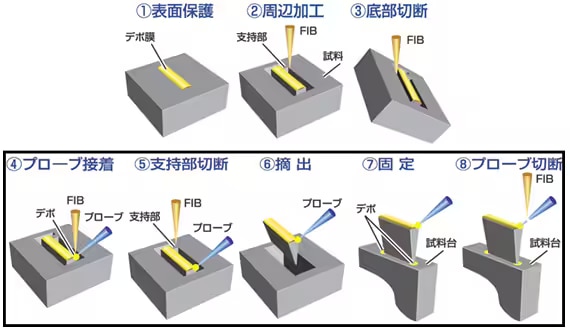
自動 マイクロサンプリング®システムでは、①~③FIB加工工程に加え、④~⑧精密プローブ操作工程を自動化
* 本図は概念図のため、実装置では、試料・プローブ・試料台の位置関係が異なる場合があります。
仕様
| 設定数 | 最大20サンプル |
|---|---|
| 所要時間 | 1サンプルあたり40分以下 |
| マイクロサンプルサイズ | 10 µm(幅) × 2 µm(厚さ) × 5 µm(深さ) |
事前設定
搭載先TEM試料台の指定 および 参照画像登録

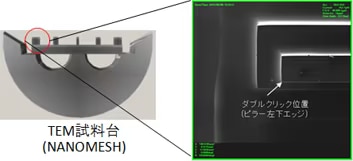
マイクロサンプリング加工位置登録 および TEM試料台上の固定先ピラーの割付け
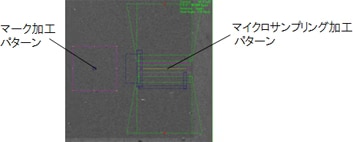

自動 マイクロサンプリング®のプロセス
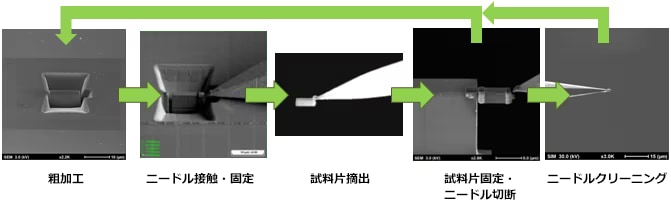
20箇所での自動 マイクロサンプリング®実施結果
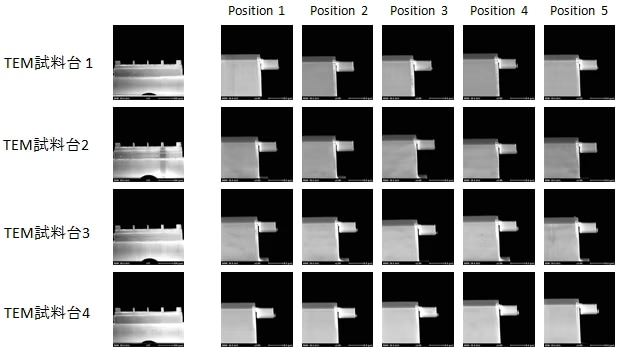
トピックス

・技術機関誌 SI NEWSの関連記事のご案内
1958年の創刊以来、SI NEWS(エスアイニュース)は、弊社製品を使用した社内外の研究論文、アプリケーションおよび新製品情報を公開しています。
FIB-SEM複合装置、トリプルビーム装置 NX2000の記事のご案内です。