FIB-SEM 장비, Triple Beam NX2000
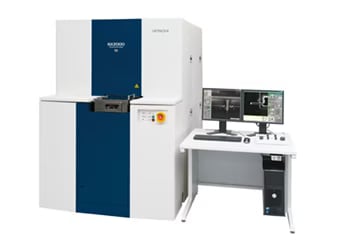
궁극의 TEM 시료 제작 Tool을 목표로
최첨단 Device 및 다양한 나노 재료의 평가・해석에 있어서 FIB-SEM은 필수불가결한 Tool이 되고 있습니다.
최근 들어 대상의 구조가 미세화됨에 따라 더 얇고, 시료가공 시의 Artifact를 최소화한 TEM 박막 시료 제작 니즈가 많아지고 있습니다.
히타치 하이테크에서는 정평이 난 고성능 FIB 기술과 고분해능 SEM 기술에 자세제어와 Triple Beam®*1(옵션)을 조합한 NX2000을 개발하였습니다.
특징
높은 Contrast・실시간 SEM 가공 End Point 검지에 따라 20 nm 이하의 초박막 시료 제작에도 대응
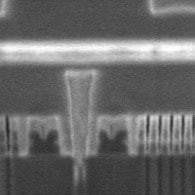
FIB 가공 중 실시간 SEM 관찰*2 예시
시료: NAND 플래시 메모리
가속 전압: 1 kV
FOV: 0.6 µm
자세제어 기술 (Micro Sampling®*2 시스템 (옵션) + 높은 정밀도・고속 시료 미동기구*) 가 커튼 효과 제어와 균일한 두께의 박막 시료 제작에 기여합니다
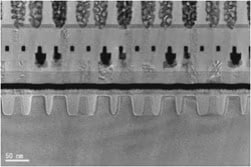
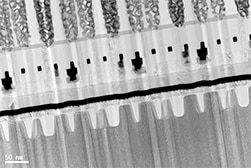
Triple Beam®*1 시스템 (옵션)이 FIB 가공 Damage 제거의 간편화・높은 Throughput화를 추진합니다
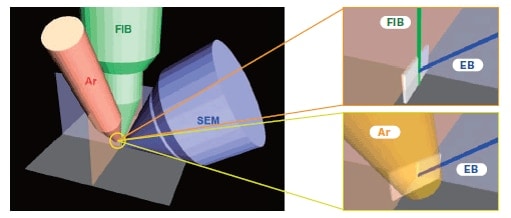
EB: Electron Beam (전자 빔)
FIB: Focused Ion Beam (집속 이온 빔)
Ar: Ar ion beam (Ar 이온 빔)
사양
| 항목 | 내용 |
|---|---|
| FIB 칼럼 | |
| 분해능 | 4 nm @ 30 kV, 60 nm @ 2 kV |
| 가속전압 | 0.5~30 kV |
| 빔 전류 | 0.05 pA ~ 100 nA |
| FE-SEM 칼럼 | |
| 분해능 | 2.8 nm @ 5 kV, 3.5 nm @ 1 kV |
| 가속전압 | 0.5~30 kV |
| 전자총 | 냉음극 전계방출형 |
| 검출기 | |
| 표준 검출기 | In-lens SE검출기/Chamber SE 검출기/반사전자검출기 |
| Stage | X: 0 ~ 205 mm Y: 0 ~ 205 mm Z: 0 ~ 10 mm R: 0 ~ 360° Endless T: -5 ~ 60° |
특별 부속품 (옵션)
- Ar/Xe 이온 빔 시스템
- Micro Sampling® *3 시스템
- 결함 검사 장비와의 Linkage 소프트웨어
- CAD Navigation Linkage 소프트웨어
- EDS (에너지 분해형 X선 분석 장비)
- TEM 시료 완성 가공 마법사
- TEM 시료 두께 관리 소프트웨어
- 연속 A-TEM
- 실시간 화질 개선 시스템
- Swing 가공 기능 (Triple Beamreg; *1용)
- Plasma Cleaner
- 대기 차단 반송 기구
- 냉각 Stage
Hitachi FIB Application Data
This journal addresses a wide range variety of research papers and useful application data using Hitachi science instruments.



