集束イオンビーム(FIB)原理解説
解説
集束イオンビーム(FIB)の原理と応用例をご紹介しております。是非ご覧ください。
集束イオンビーム(FIB)の原理紹介
集束イオンビーム装置は、きわめて細く集束したイオンビームを試料表面で走査することにより、発生した二次電子などを検出して顕微鏡像を観察したり、試料表面を加工したりすることのできる装置です。
集束イオンビーム装置は、走査電子顕微鏡と同様の構成・機能を持っています。まず、走査顕微鏡の原理についてご紹介します。続いて、いくつかの点で走査電子顕微鏡と集束イオンビーム装置は大きく異なっています。その相違点に着眼して、集束イオンビーム装置の特徴を紹介いたします。
走査顕微鏡概要
光源から発生した光をアパーチャや集束レンズ(コンデンサレンズ、CLとも呼ばれる)で集束してビームにします。続いて、対物レンズ(オブジェクティブレンズ、OLとも呼ばれる)で試料表面に焦点を合わせます。
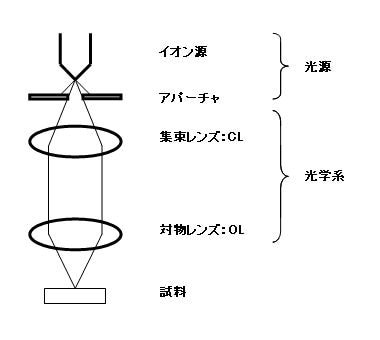
集束され試料表面に焦点の合わせられたビームは、偏向器によって試料表面を走査されます。そして、ビーム照射によって試料表面から発生する二次信号を検出器によって検出し、二次信号に対応したデータを、ビーム照射位置座標に対応した画像データメモリに記憶します。画像データメモリに記憶されたデータをコンピュータ画面上に表示することにより、ビームを照射した領域の顕微鏡像を観察することができます。
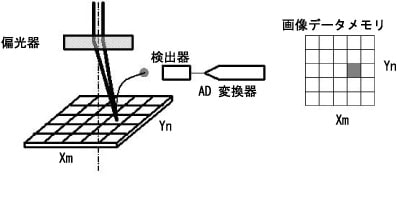
走査電子顕微鏡と集束イオンビーム装置
光源
ビームの発生源を光学顕微鏡と同様に光源と総称します。走査電子顕微鏡の場合は電子銃、集束イオンビームの場合はイオン銃またはイオン源と呼ぶのが一般的です。
先端の鋭利な金属の先端と引き出し電極の間に電界をかけて、荷電粒子を引き出します。引き出された荷電粒子は、加速電源による電圧で加速されて試料に衝突します。
イオンの場合、鋭利な金属の先端に液体金属ガリウムを流して供給し、電界の力で放射させます。
加速電圧は+5kVから+30kV程度が一般に用いられます。
加速電圧が高いほど、ビームを細く絞ることができます。しかしながら、同時に、試料へのダメージが大きくなることから、経験的に最適な値として、30kVでの加工観察が一般的です。
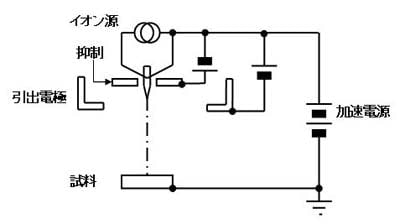
光学系
光源より発生した荷電粒子を磁界または電界を用いて集束し、試料表面に焦点を合わせ、走査させます。
電子顕微鏡では、電磁石から発生する磁界を用いて制御するのが一般的です。電磁石を制御する電流回路が外来ノイズの影響を受けにくいこと、電磁石を真空中に作製する必要がないことなどから比較的安価に高性能を実現することができます。
一方、集束イオンビーム装置では、磁界による制御を行いません。磁界では、荷電粒子の重量によって軌道が変わってしまいます。イオンビームの場合、同位体などの存在により、重量の異なるイオンが存在することから磁界を用いて集束させることができません。そこで、電界を用います。
電界を用いる場合、まず、真空中に設置された電極に高電圧を印加しなければなりません。高電圧を印加しても放電しないようにする必要があります。そして、電圧回路は電流回路と比較してノイズの影響を受けやすいですので、そのノイズ対策が必要となります。さらに、電極の機械的配置によって性能が決定されます。高性能を実現するため、ミクロン・オーダの精度で部品を組み立てる必要があります。日立ハイテクサイエンスはこれらの課題を克服して集束イオンビーム装置の製品化を実現しています。
電子ビームと集束イオンビーム
走査電子顕微鏡では電子ビームが、集束イオンビーム装置ではガリウムイオンによるイオンビームが試料に照射されます。
電子ビームを試料の表面に照射しますと、試料表面から二次電子が発生します。これは、照射された電子のエネルギーによって励起された電子がそれまでの軌道から外れて飛び出したものです。さらに、電子ビームの加速電圧が高くなると材質によって異なる特性X線が発生します。
二次電子は、表面の形状や材質によって発生量が異なります。この発生量の二次元分布を得ることにより、試料表面の顕微鏡像を観察することができます。
特性X線はその波長分布(スペクトラム)を分析することにより、試料表面を構成する原を特定することができます。さらに、特性X線の二次元分布を得ることにより材質の分布を観察することもできます。

イオンビームを試料の表面に照射しますと、試料表面から電子ビームと同様に二次電子が発生します。また、ガリウムイオンが電子と比較してはるかに重いことから、試料を構成する原子をはじき出すいわゆるスパッタリング現象が発生します。はじき出された原子は、二次イオンとなって試料から飛び出します。
電子ビームのときと同様に、二次電子の二次元分布を求めることにより、試料表面の顕微鏡像を観察することができます。
また、二次イオンを検出器で検出し、二次元分布を求めることにより、試料表面の顕微鏡像を観察することもできます。

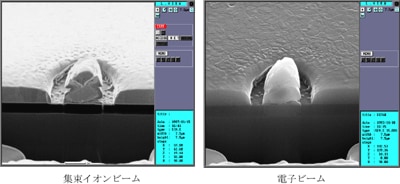
一般に、これら二次信号の空間分解能と材質依存性の関係は以下のようになります。

集束イオンビームによる加工
電子ビームと異なる機能として、試料をイオンビーム照射により加工することができます。
エッチング
先に、イオンビーム照射に寄ってスパッタリング現象が発生することをご紹介いたしましたが、イオンビームの量を増やしてスパッタリングされる原子の量を増やすことにより、試料表面をエッチング加工することができます。
これにより、イオンビームの照射された部分だけを選択的にエッチングするマスクレス加工を実現します。
この技術を応用して、試料の所定箇所のエッチングを行い、断面を露出させて観察する断面加工観察や、さらに、試料の所定箇所を薄片として取り出すTEM試料作製加工を行うことができます。
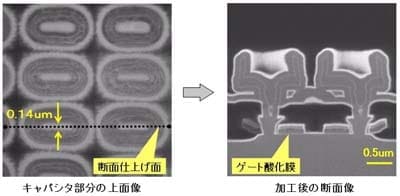
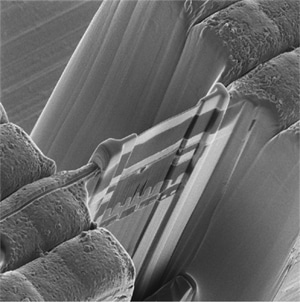
デポジション
化合物(前駆体)ガスを試料表面に吹き付けながらFIB照射することにより、局所的(FIB照射領域)にデポジションを行うことができます。
図10にイオンビーム支援デポジション(Focused Ion Beam Assisted Deposition:FIB-AD)の概念図を示します。
試料表面に吸着したガス分子に一次イオン(FIB)が衝突すると、ガス分子が解離し、気体成分は真空中に放出され、個体成分は試料表面に堆積します。
また、一次イオンの衝突により発生する二次電子も化合物ガスの解離に寄与します。これらによって、イオンビーム照射領域に選択的にデポジションをマスクレスで行うことができます。
デポジションの最中もスパッタリング現象は平行して起こっており、スパッタリングで除去される体積よりもデポジションで付く体積の方が勝る場合、デポジション膜が形成できます。
日立では、デポジションの原料となる化合物ガスをイオンビーム照射領域周辺に効率良く供給できる化合物ガス供給装置を開発しました。
カーボン C、タングステン W、プラチナ Pt、シリコン酸化物 SiOxなどのデポジションが行えます。
FIB-SEMのSEM機能を利用して局所デポジションを行う場合、電子ビーム照射によって発生する二次電子を利用してガス分子を解離することになります。
この場合、イオン衝突による解離現象が無いことから、一般的にデポジションのレートが低くなりますが、スパッタリング現象が平行して起こらないため、試料最表面に損傷を与えずにデポジション膜(保護膜)をつけることができます。