高性能集束イオンビーム装置 MI4050
特長
最大プローブ電流90nAにより加工の高速化と大面積加工を実現

ワイヤーボンディングの断面加工
(加工サイズ 幅:95µm 深さ:55µm、 加工時間 20min)
極低加速電圧(0.5kV~)加工および低加速電圧時の二次電子像分解能向上により、更なる低ダメージTEM試料作製が可能
* 1kV以下はオプション
二次電子像分解能4nm@30kVによる高分解能SIM像観察が可能

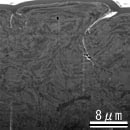
アルミ缶の断面SIM像
高精度5軸電動メカニカルユーセントリックステージ採用
ステージ移動(含むチルト)を伴う複数箇所の多様な加工が自動運転で可能です。
優れた操作性と豊富な加工モード
- 断面作製プログラム加工
- TEM/STEM試料プログラム加工
- 連続自動加工
- 連続TEM試料自動仕上げ加工ソフトウェア
- ビットマップ加工
- ベクタースキャン加工
- 3Dナノ精度構造物作製 その他

試料提供: 兵庫県立大学 松井真二様
SIM像の3D再構築解析
等間隔のスライス断面加工と観察を繰り返し、複数枚の断面SIM像を取得し3D再構築することが可能です。複合粒子の分散状態や空孔などの3次元情報を可視化する場合などに有効です。
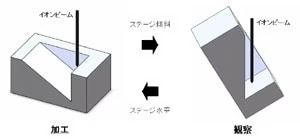

マルチガス供給システム(MGS-II)を用いた回路修正
保護膜材料、配線材料、絶縁膜、増速エッチングなどさまざまな用途に合わせて、複数のガスを照射できるシステムです。
- タングステンデポジションガス
- プラチナデポジションガス
- 絶縁膜生成用デポジションガス
- 弗化キセノンエッチングガス
- 有機系エッチングガス
- カーボンデポジションガス
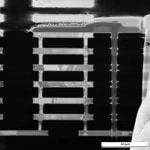
およびタングステンデポジションによるパッド出し
豊富な座標リンケージ機能
日立ハイテクサイエンス独自の豊富な座標リンケージ機能により、正確な加工位置決定と大幅時間短縮が図れます。
-
光学顕微鏡像とSIM像のリンケージ
ダブルカーソル機能 日本特許第4634134号
米国特許第7595488号 -
欠陥検査装置との座標リンケージ
割断されたウエーハやチップでも欠陥検査装置との座標リンケージが可能です。 - CADナビゲーションシステムとのリンケージ
仕様
| 項目 | 内容 |
|---|---|
| 試料サイズ | 50mm×50mm×12mm(t)以下 |
| 試料ステージ | 5軸電動ユーセントリックステージ |
| 加速電圧 | 1~30kV (0.5kV~ オプション) (0.5~1.0kV : 0.1kVステップで変更可能) (1.0~2.0kV : 0.2kVステップで変更可能) |
| 二次電子観察像分解能 | 4nm@30kV |
| 最大プローブ電流 | 90nA |
| 最大プローブ電流密度 | 50A/cm2 |
特別付属品(オプション)
- 4chマルチガス供給システムII
- 連続自動加工ソフトウェア
- TEM試料自動加工ソフトウェア
- マニピュレータ顕微鏡 他
* その他MIシリーズの豊富なオプションを選択できます。
トピックス

・技術機関誌 SI NEWSの関連記事のご案内
1958年の創刊以来、SI NEWS(エスアイニュース)は、弊社製品を使用した社内外の研究論文、アプリケーションおよび新製品情報を公開しています。
高性能集束イオンビーム装置 MI4050の記事のご案内です。


