高性能FIB-SEM複合装置 Ethos NX5000 シリーズ

高性能と柔軟性の両立
「Ethos」は、日立ハイテクのコア技術である高輝度冷陰極電界放出型電子銃と新開発の電磁界重畳型レンズにより、低加速電圧での高分解能観察を可能とし、リアルタイムFIB加工観察と両立しました。
さらに、SEMカラム内に3つの検出器を搭載することで、二次電子による形状コントラストや反射電子による組成コントラストを同時観察でき、ナノメータースケールの構造物を見逃すことなく観察・解析し、特定箇所を正確に捉えたFIB加工を可能としています。
また新設計の大容量試料室には、EDS*1やEBSD*2などの各分析装置に対応する多数のアクセサリーポートを設置するとともに、直径150 mmサイズの試料の全面加工観察ができる高耐振の大型試料ステージを搭載しています。
これにより、最先端半導体デバイスだけでなく、生物組織から鉄鋼などの磁性材料まで、さまざまな試料の複合解析に対応しています。
*1 Energy Dispersive x-ray Spectrometer(エネルギー分散型X線分析装置)
*2 Electron Backscatter Diffraction(電子線後方散乱回折分析装置)
特長
キーコンセプト
1. 2つのレンズモードを有する高性能SEMカラム
- HRモードでの高分解能観察(セミインレンズ)
- FFモードでの高精度加工終点検知(タイムシェアリングモード)
2. 高スループット加工
- 電流密度FIBによる高速加工(最大ビーム電流100 nA)
- ユーザー自身がプログラムできる加工観察スクリプト
3. マイクロサンプリング®システム*3
- ACE技術(姿勢制御)によるカーテン効果の抑制
- イオンビームの入射角度を制御して均一な厚さの薄膜試料作製
4. 低損傷加工を実現するトリプルビーム®システム*3
- 低加速稀ガス(Ar/Xe)イオンビームによる低損傷加工
- ガリウムコンタミネーションの除去
5. さまざまなアプリケーションに対応できる試料室とステージ
- 多ポート試料室(大小ポート)
- 大型低振動ステージ(150 mm)
*3 オプション
高性能SEMカラム
Ethosに搭載されたSEMでは、2つのレンズモードが選択できます。HRモードでは試料はレンズ磁界の中に入り、高分解能観察が可能になります。FFモードでは、FIB照射とSEM観察を最短10 nsecで切り替えることができます。これにより、速いフレームレートのSEM像を見ながらFIB加工が行えるので、加工終点の判断が容易です。また、電磁界重畳型レンズの採用により、FFモードでも分解能の劣化を防いでいます。
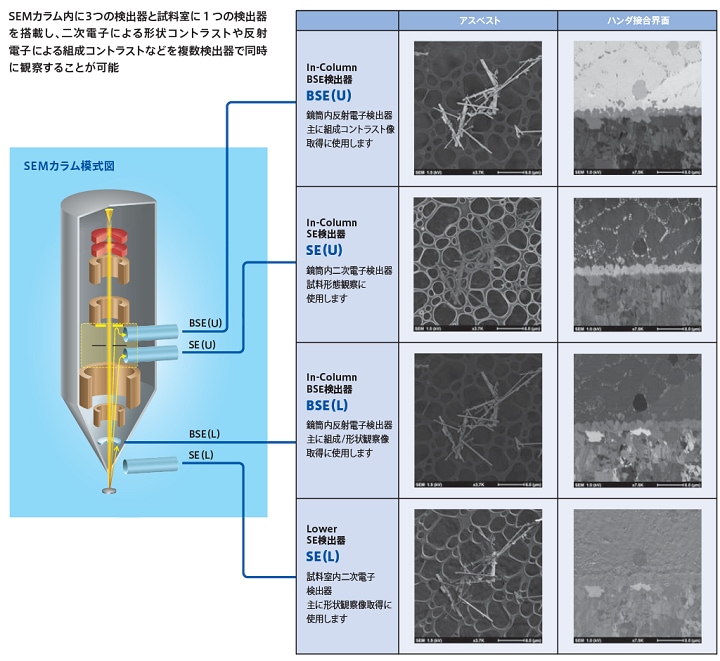
高分解能SEM観察例
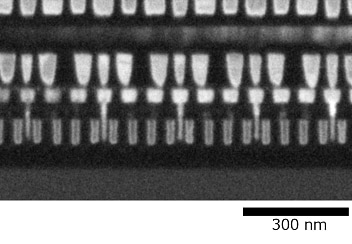
SEM検出器:BSE(U)
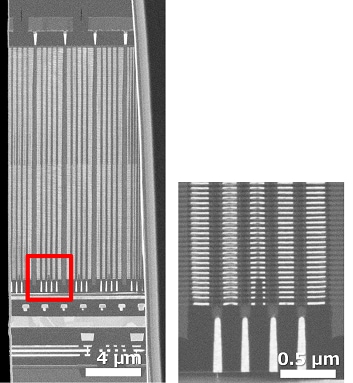
SEM検出器:BSE(U)
高性能FIBカラム
高電流密度FIBにより高速加工を実現し、大面積領域の加工や数ヶ所のプログラム加工が可能

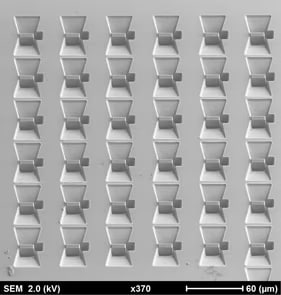
タイムシェアリングモード
FIB、Ar/Xeビームによる加工中にリアルタイムでシーンに分けたSEMによる観察が可能
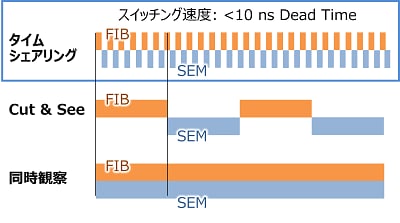
■ 最適な位置での終点検知を優先したタイムシェアリングモード
■ 高分解能なSEM観察を目的したCut & See®モード
■ FIBによる加工時間を優先した同時観察モード
Cut & See®による三次元再構築イメージング

FOV:20 μm
Cut & See®:200枚
Slice pitch:20 nm
SEM加速電圧:1.5 kV
固体酸化物形燃料電池の燃料極
試料名:Ni-YSZ
試料ご提供:東京大学生産技術研究所
鹿園 直毅 教授
Cut & Seeは株式会社日立ハイテクの国内における登録商標です。
FIB加工ダメージを抑制した良質なTEM試料作製
低加速アルゴンイオンビーム電流密度FIBにより高速加工を実現し、大面積領域の加工や数ヶ所のプログラム加工が可能
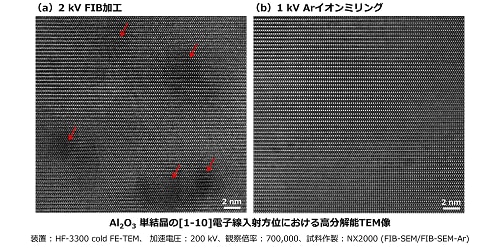
一方、1 kV Arイオンミリングにおいては、FIBダメージ層は除去され、結晶格子像が明瞭に観察できました(図b)。

極薄試料の作製には、平坦化でかつダメージの少ない加工方法を用いる必要があります。
Ethosでは試料の姿勢制御と低加速アルゴンイオンビーム加工とを組み合わせたACE技術により、良質なTEM薄膜試料を作成します。
ACE: Anti Curtaining Effect
視覚・効率を向上したGUIデザイン

4信号表示による信号選択性の向上
■ In-Column検出器(SED×1、BSE×2)、試料室SE検出器の同時取り込みが可能
■ 各SEM光学系のBeam条件の保存・呼び出し機能を搭載
■ 形状、組成等観察目的に合わせた最適な検出器が選択可能
■ 検出器ごとにコントラスト、ブライトネス等の個別設定、保存、呼び出しが可能
充実した加工モードとシーケンスの作成

各種加工モード/観察条件の登録と呼び出し
■ ドラッグ&ドロップで簡単に加工/観察のシーケンスが作成可能
■ 各加工モードやプログラム加工は、自由に編集、登録が可能
■ 登録されたプログラム加工を呼び出すだけの簡単操作で加工設定が可能
■ 登録されたシーケンスを読み出すことで繰り返しの作業を効率化
■ シーケンスをコピーして編集することで、拡張性や柔軟性を向上
さまざまな加工モードによる加工枠設定の柔軟性
■ 加工モードは、矩形、円形、三角形、平行四辺形だけでなく、スロープ加工やビットマップ加工などの設定が可能
■ アプリケーション加工として、断面観察用加工やTEM観察用試料作製を準備
■ ベクタスキャン*3では、ベクタ情報から加工枠を表示し位置決めが可能。また、画像(bmp)をベクタに変換して加工も可能
■ 各種イオンビーム照射位置補正機能(ドリフト補正)を準備し正確な加工が可能
*3 オプション
さまざまな用途に対応する大型試料室
■ 高分解能観察に対応した高耐振試料ステージを搭載
■ 多様な加工・観察・解析のためのオプション対応を考慮したポートレイアウトを採用
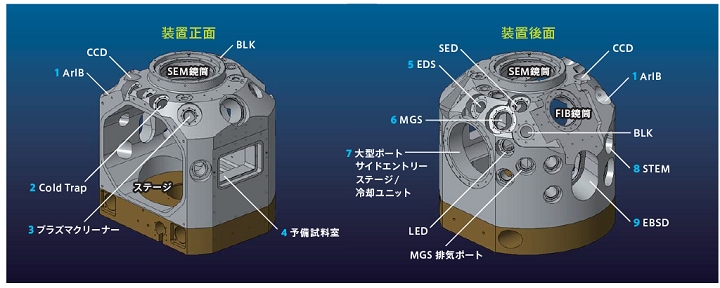
仕様
| 項目 | 内容 | |
|---|---|---|
| FIB [NX5000] |
二次電子像分解能(C.P) | 4 nm @ 30 kV 60 nm @ 2 kV (エッジ分解能) |
| 加速電圧 | 0.5 kV – 30 kV | |
| プローブ電流範囲 | 0.05 pA – 100 nA | |
| イオン源 | Ga液体金属イオン源 | |
| FIB [NX5200] |
二次電子像分解能(C.P) | 4 nm @ 30 kV 50 nm @ 2 kV(エッジ分解能) |
| 加速電圧 | 0.5 kV – 30 kV | |
| プローブ電流範囲 | 0.05 pA – 100 nA | |
| イオン源 | Ga液体金属イオン源 | |
| SEM | 二次電子像分解能(C.P) | 1.5 nm @ 1 kV、0.7 nm @ 15 kV |
| 加速電圧 | 0.1 kV – 30 kV | |
| プローブ電流範囲 | 5 pA – 10 nA | |
| 電子銃 | 冷陰極電界放出型 | |
| 標準検出器 | In-Column二次電子検出器 SE(U) In-Column反射電子検出器 BSE(U) In-Column反射電子検出器 BSE(L) チャンバー二次電子検出器 SE(L) |
|
| 駆動範囲 (5軸フィードバック制御) |
X | 155 mm |
| Y | 155 mm | |
| Z | 16.5 mm | |
| R | 0 - 360° エンドレス | |
| T | -10~59° | |
| 試料サイズ | 最大 150 mm径 | |
| 主要オプション | Ar/Xeイオンビームシステム マイクロサンプリング®システム* ガスインジェクションシステム(2または3リザーバ仕様)
手動搬送式予備試料室 サイドエントリーステージシステム OM Linkシステム 自動マイクロサンプリング®システム* 連続自動加工ソフトウェア 連続A-TEM2 各種試料ホルダ EDS(エネルギー分散型X線分析装置) EBSD(電子線後方散乱回折分析装置) STEM検出器 プラズマクリーナー |
|
* マイクロサンプリングは国内における株式会社日立ハイテクの登録商標です


