日立暗視野式ウェーハ欠陥検査装置 DI2800
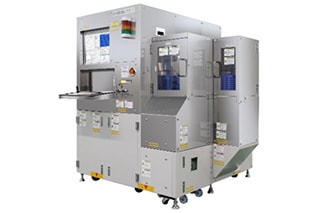
G&Cデバイス*の製造工程中の
パターンサンプル上に発生する欠陥検出と管理に貢献
散乱強度シミュレーション技術を活用した照明及び検出光学系の最適化により、製造工程中のパターン付きウェーハ上の欠陥を高感度に検査可能で、その検出感度は鏡面ウェーハ上の0.1 μm標準粒子検出を実現しています。
これにより、G&Cデバイス*で採用される0.3 mm角の非常に小さな半導体チップのサイズも検査することが可能となり、検査シーケンス最適化により200 mmウェーハ上の欠陥検査で40枚/時間以上の処理性能を実現しています。
*) G&Cデバイスとは、グリーン&コミュニケーションデバイスの略語。具体的には、Φ100/125/150/200 mmのウェーハで生産される電子デバイス及び電子部品。(例:SAW/BAW、MEMS及びセンサー、パワー及びアナログデバイス等)
取扱会社:株式会社 日立ハイテク
特長
- 日立ハイテク独自の暗視野検査方式による欠陥検出
- 製造工程中のライン管理(プロセスモニター)及び良品選別(スクリーニング)に対応
- Φ100 mm, Φ150 mm, Φ200 mmのパターン/ノンパターンウェーハサンプルに対応
仕様
| 検出感度 | 標準粒子径: 0.1 μm検出 |
|---|---|
| 処理能力 | 40枚/時間以上 |
関連製品

高分解能FEB測長装置 CS4800
CS4800は 4、6、8インチのウェーハサイズに対応した測長SEMです。

欠陥形状評価SEM CT1000
欠陥及びパターン形状の3D観察でG&Cデバイスの開発TAT短縮と品質向上に貢献
