日立イオンミリング 進化の系図
イオンミリング装置 歴史と進化
イオンミリング装置とはアルゴンイオンを用いて試料をスパッタする(削る)装置で、主にSEM用試料の内部構造露出や表面を平滑にするための試料加工装置です。機械研磨など、他の断面試料作製法と比べて応力をかけずに試料を加工することができるので、多岐にわたる試料の前処理に活用されています。
1985年の初代イオンミリングE-300形からご愛顧いただき、おかげさまで現在の最新機種ArBlade® 5000に進化を遂げました。
ここでは日立イオンミリングの歴史を製品と共に紹介いたします。


2017年発売
ハイブリットイオンミリング装置IM4000の上位機種として発売(2017年)。ミリング時間の短縮、広域加工対応化への要求に応えるため、新規開発の高ミリングレートPlus IIイオンガン(断面ミリングレート1000 µm/h以上*)と広域断面ミリング機能を標準装備。 さらに、複数の条件を組み合わせて最適な加工ができる2ndミリング機能、間欠ビーム照射機能など1グレード上の加工を実現。また、様々なミリング条件を細かく設定できるよう、液晶タッチパネルを採用し、ユーザビリティを向上させた。
イオンミリングの多機能化に伴い、PCからの操作・制御を実現(2019年、オプション)。複数個所をそれぞれの条件で加工できる多点断面ミリング機能や、ミリング条件レシピの保存・読込での作業性向上、リモートでも加工終了がわかるメール送信機能を搭載。加工前後のプロセスにおいても作業性の向上が図られている。
*ミリング条件 加速電圧:8 kV 放電電圧:2 kV マスクからの突出量:100 μm 試料:Si
最新のイオンミリング機能紹介
広領域加工
電子基板の広領域断面加工

加工の自動化
電子基板の連続多点断面加工

ACSは複数の加工位置の指定ができ、さらに加工位置毎にミリング条件の設定が可能です。必要箇所のみを最適条件で加工することで、欲しいサンプル断面を短時間で得ることができます。
雰囲気遮断機能
LIB負極(充電済)の断面加工


イオンミリング装置から試料を取り出す際に、大気に晒すことなくSEMやグローブボックスへ試料を搬送できる機能です。特に大気中の酸素や水分と反応しやすいリチウムイオン電池材料などの断面作製に有効です。
冷却温度調整機能
低融点材料(ウッド合金)の断面加工
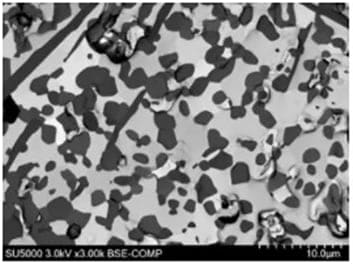

イオンビーム照射による試料の温度上昇が原因で、加工中に融解や変形する試料に有効なシステムです。過冷却によって試料が割れてしまう試料には、冷却温度を調整して加工することも可能です。
*1 冷却温度調整機能はArBlade® 5000本体と同時出荷オプションです。
進化の系図
E-300

1985年発売
ツインガン装備によるTEM用薄膜作成装置として発売。
排気系をSEMと共通化したフロアトップタイプで、カートリッジ式ホロカソード/アノード型イオンガンを採用。また、ミリング中も光学顕微鏡による反射・透過像観察を実現したほか、レーザーによる終点検知機能(オプション)を搭載した。
E-300LSI / E-3100

1988年発売
E-300形をベースにステージを新規開発し、パッケージ半導体試料の絶縁保護膜除去を目的としたSEM用試料用のイオンミリング装置としてE-300LSI形を出荷。日立独自のフラットミリング機能により5 ㎜Φを平滑化でき、半導体に限らず機械研磨時の研磨痕除去にも広く適用できることからE-3100形として発売した(1989年)。
E-3200
1992年発売
E-3100形に試料サイズの大型化、マスフローコントローラによる精密ガス量調整機能等の改良を加えたE-3200形を発売。
E-3500

2005年発売
断面イオンミリング装置として発売(2005年)。ベアリング式ターボ分子ポンプ採用により排気系を小型化し卓上設置に対応。断面イオンミリング用として、新規開発のカートリッジ式セミ・ペニングイオンガンを実装し、高ミリングレート化を実現(E-3200比)した。このE-3500形から海外発売を開始した(2009年)。
さらに、断面ミリング時間短縮化の要求に対応するため、新型ペニング式イオンガンを開発しオプション化(E-3500Plus : 2009年)。
IM-3000

2007年発売
先行発売していたE-3500と排気系を共通化し,机上設置形としたフラットミリング装置として発売。従来装置が、一方向のステージ回転のみだったのに対し、反転や回転速度を設定可能とした。
各樹脂包埋カップサイズに対応した3種類の試料ホルダを標準付属させた。
E-3500形と同様に2009年より海外発売を開始。
IM4000/4000Plus

2010年発売
イオンミリング装置の多機能化の要求に対応するため、フラットミリングと断面ミリングの両方に対応したハイブリットミリングとして発売。イオンガンはE-3500Plusで高評を得たペニング式イオンガンを標準装備。ソフトマテリアルへの対応として、間欠ビーム照射モードの追加、冷却断面ミリングのオプション化、LIB材の対応として雰囲気遮断ミリングホルダをオプション化した。
また、断面ミリングの短時間化の要求に対応するため、高レートイオンガン(Plusイオンガン:断面ミリングレート500μm/h以上)をオプション発売(2013年)。

2017年発売
ハイブリットイオンミリング装置IM4000の上位機種として発売。ミリング時間の短縮、広域加工対応化への要求に応えるため、新規開発の高ミリングレートPlus IIイオンガン(断面ミリングレート1000 µm/h*)と広域断面ミリング機能を標準装備。
さらに、複数の条件を組み合わせて最適な加工ができる2ndミリング機能、間欠ビーム照射機能など1グレード上の加工を実現。また、様々なミリング条件を細かく設定できるよう、液晶タッチパネルを採用し、ユーザビリティを向上させた。
一方、イオンミリングの多機能化に伴い、PCからの操作・制御を実現(2019年、オプション)。複数個所をそれぞれの条件で加工できる多点断面ミリング機能や、ミリング条件レシピの保存・読込での作業性向上、リモートでも加工終了がわかるメール送信機能を搭載。加工前後のプロセスにおいても作業性の向上が図られている。
*ミリング条件 加速電圧:8 kV 放電電圧:2 kV マスクからの突出量:100 μm 試料:Si
