イオンミリング装置
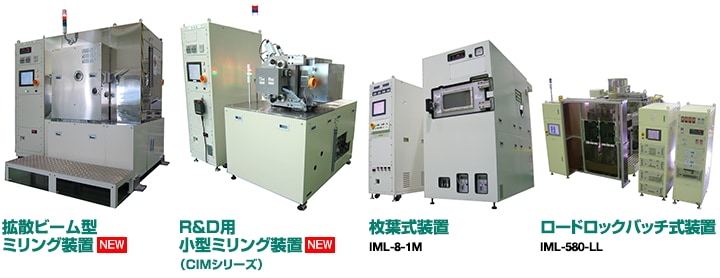
IOT・車載デバイスの圧電・磁性材料のエッチングに実験から量産まで貢献
新型拡散ビーム装置
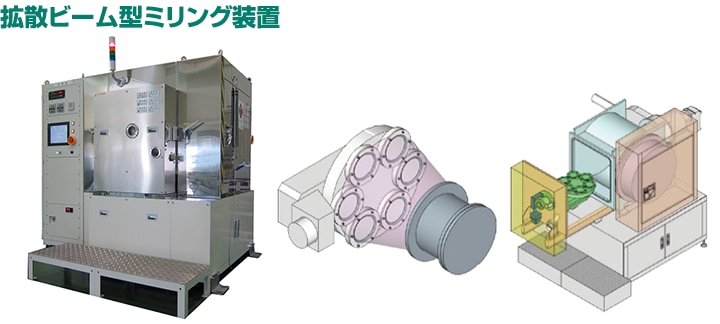
特徴
- 新開発の拡散ビームにより小径の電極で大面積の加工が可能
- φ100mmウェハ×6枚を全数同時処理可能
- 自公転型ウェハホルダーにより良好な面内均一性を実現
| Batch No. | Etching Rate(SiO2) (nm/min) | Uniformity(±%) |
|---|---|---|
| 1 | 21.4 | 2.2 |
| 2 | 21.5 | 2.1 |
| 3 | 21.6 | 2.2 |
R&D用小型ミリング装置

特徴
- 実験開発向けに特化したスタンドアローン型装置
- 電装系、電源類等を1台に納めたコンパクト設計
-
φ75、φ100、φ125mmウェハまで対応
*特殊ワーク形状に関しては御相談ください。 - 基板冷却、基板電位中和機能、基板自転、ステージ傾斜付き
枚葉式装置

特徴
-
物理エッチング:Arビームにより、材料の反応性に関わらず加工が可能
(例)PZT、LN、LT、NiFe、Au、複合材料、多層膜等) - 加工温度:優れた冷却機構により、材料の圧電特性消失、結晶構造変化、膨張、PRの変化を抑制
- 帯電抑制:独自の中和機構により、加工時に材料の帯電を抑制
- 選択性:安定、高均一なエッチング、更に終点検知器によるJUSTエッチングが可能
- 加工形状:ビーム入射角、ビーム発散角コントロールによりテーパー角度を調整
- 面内分布:優れた面内均一性、面内での内外周レートのコントロールを実現
- 装置仕様:豊富な装置ラインナップにより、小径から大口径、枚葉からバッチ式まで対応
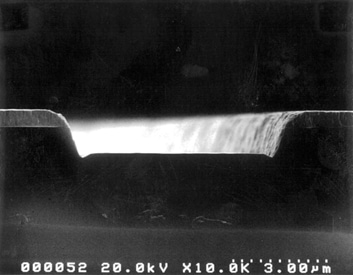
LLバッチ式装置

特徴
-
物理エッチング:Arビームにより、材料の反応性に関わらず加工が可能
(例)PZT、LN、LT、NiFe、Au、複合材料、多層膜等) - 加工温度:優れた冷却機構により、材料の圧電特性消失、結晶構造変化、膨張、PRの変化を抑制
- 帯電抑制:独自の中和機構により、加工時に材料の帯電を抑制
- 選択性:安定、高均一なエッチング、更に終点検知器によるJUSTエッチングが可能
- 加工形状:ビーム入射角、ビーム発散角コントロールによりテーパー角度を調整
- 面内分布:優れた面内均一性、面内での内外周レートのコントロールを実現
- 装置仕様:豊富な装置ラインナップにより、小径から大口径、枚葉からバッチ式まで対応