半導体

半導体デバイスの微細化は、驚くべき速度で進んでいます。また、近年の技術の進歩により、デバイスの構造は原子レベルで制御することも可能になっています。この中で、電子顕微鏡は、短いターンアラウンドタイムで高分解能観察を実現し半導体製造解析の現場では欠かせない技術となっています。電子顕微鏡は、パッケージ品から原子レベルで制御されたゲート構造の詳細まで、非常に広い範囲をカバーし、あらゆるものの評価に利用されています。
日立ハイテクは、半導体デバイスの開発・製造・不良解析・品質保証に用いられる、最先端のインライン、および、オフラインの解析装置を提供しています。電子顕微鏡についても、世界トップレベルのFE-SEM、FIB-SEM、TEMを含む、幅広い製品をラインアップしています。
半導体デバイスの解析領域
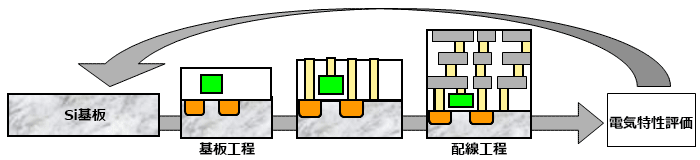
半導体デバイスの製造プロセスでは、次世代半導体デバイスの開発や製造歩留まり改善のためのQTATプロセスコントロールなどに、電子ビームを用いた装置が広く利用されています。
FEOL(基板工程)とBEOL(配線工程)での主要な解析
- CD測長
- 汚染、異物解析
- 電位コントラスト
- 特定トランジスタの電気測
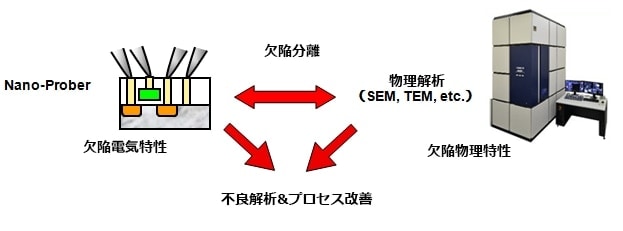
デバイス不良の原因解析や製造プロセス改善にも、電子ビームを用いたさまざまな装置が用いられています。
また、デバイス品質の向上や顧客との信頼関係構築のために、QTAT不良解析への需要が高まっています。
不良解析における、主な関心事項:
- 汚染、異物解析
- 特定Netの可視化
- 電位コントラスト
- 特定トランジスタの電気測定
- CD測長
- 拡散層領域解析
チップ
| 目的 |
|
|
|
|
|---|---|---|---|---|
| 観察例 |
|
|
|
|
| 装置 |
プリント基板、パッケージ
| 目的 |
|
|
|
|---|---|---|---|
| 観察例 |
|
|
|
| 装置 |
プリント基板上はんだ付けデバイス
求められる技術
- 大型ステージ、低真空モード
対象デバイス
- プリント基板実装デバイス

ソリューション
ワイヤボンディング
求められる技術
- 機械的応力の無い高精度断面ミリング、低真空モードでの高品位SEM観察
対象デバイス
- パッケージ品

ソリューション
電位コントラスト、電流像
求められる技術
- 迅速性、明瞭性、簡易性を備えた、電位コントラスト/電流像観察
対象デバイス
- <2Xnm Logic、DRAM、NANDフラッシュ
対象欠陥
- オープン、リーク
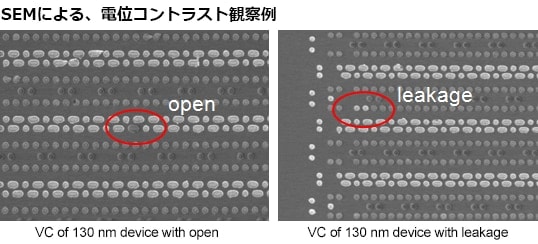

ソリューション
SEM:
電気特性評価
求められる技術
- <5 nm デバイスの評価能力
- ダメージの無い、クリアかつ高分解能なSEM像
対象デバイス
- <5 nm ノード Logic、DRAM、NANDフラッシュ
評価特性
- 静特性、AC特性、電子ビーム吸収電流像
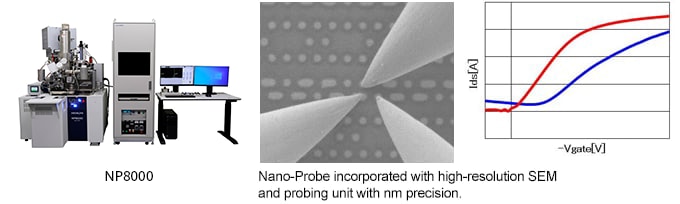
ソリューション
TEM試料作製
求められる技術
- 断面加工時の終点検知
- 高分解能TEM解析のための、ダメージ/カーテン効果の無い、容易かつ高品位な断面試料作製
対象デバイス
- <20 nmノード Logic、DRAM、NANDフラッシュ
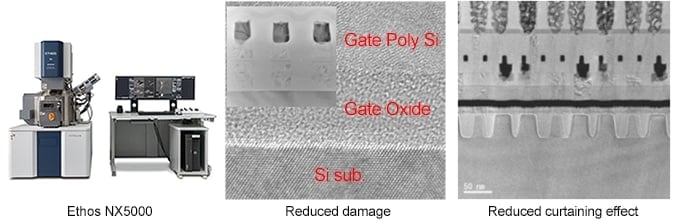
ソリューション
TEM/STEMによるCD測長
求められる技術
- 超高分解能TEM/STEM(CD測長)
対象デバイス
- <10 nmノード Logic、DRAM、NANDフラッシュ



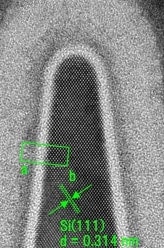
ソリューション
TEM:
拡散領域
求められる技術
- 迅速なTEM解析(低濃度不純物元素検出)
- 迅速なAFM解析(拡散領域評価)
対象デバイス
- <20 nmノード Logic、DRAM、NANDフラッシュ
対象元素
- ボロン、ヒ素、リン(ソース-ドレイン)

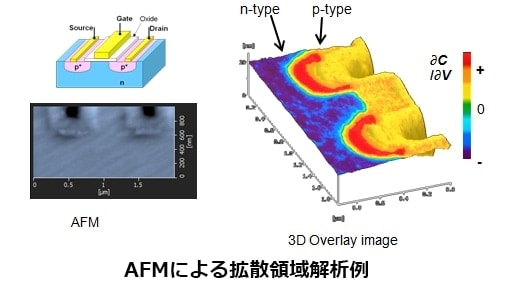
ソリューション
TEM:
関連情報

「S.I.navi」は、日立ハイテク取扱分析装置に関する会員制サイトです。
お客さまの知りたいこと、日々の業務に役立つ情報を「S.I.navi」がサポートします。

日立電子顕微鏡をご使用されているお客さまは、「S.I.navi」上で製品情報をご登録いただくと、日立電子顕微鏡ユーザー限定サイト「Semevolution(セメボリューション)」にて、さらに多くの関連情報をご覧いただけます。


