暗視野式ウェーハ欠陥検査装置 DI4600
特長
量産運用に適した高いスループットと検出感度の両立
- 暗視野式検査装置の特徴を活かした半導体製造ラインの状態管理が可能
高い装置間マッチング性能
- 複数台の運用に適した独自技術の光学系を採用
簡便な操作性
- シンプルなパラメータ設定によるレシピ作成
仕様
| ウェーハサイズ | φ300 mm専用 |
|---|
関連資料
関連製品

ディフェクトレビューSEM CR7300 Series
高速ADR、高精度ADCにより歩留まり改善に貢献するインライン対応レビューSEM

ウェーハ表面検査装置 LSシリーズ
ウェーハ表面検査装置LSシリーズは,パターンなし(鏡面)シリコンウェーハ上に存在する微小異物や欠陥を検査する装置です。

欠陥形状評価SEM CT1000
欠陥及びパターン形状の3D観察でG&Cデバイスの開発TAT短縮と品質向上に貢献
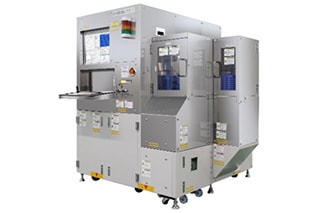
日立暗視野式ウェーハ欠陥検査装置 DI2800
G&Cデバイスの製造工程中のパターンサンプル上に発生する欠陥検出と管理に貢献

