ウェーハ表面検査装置 LSシリーズ

ウェーハ表面検査装置LSシリーズは,パターンなし(鏡面)シリコンウェーハ上に存在する微小異物や欠陥を検査する装置です。レーザー散乱応用技術を用い,パターン形成前の半導体鏡面ウェーハ上の微小異物やさまざまな欠陥を高感度・高速に検査します。低段差・平坦系欠陥であるシャロースクラッチ,ウォーターマーク,スタッキングフォールト(積層欠陥),研磨起因突起欠陥,成膜起因平坦欠陥などが不良の原因となります。LSシリーズは,これら欠陥からの散乱光を捕捉しつつ,同時にウェーハ表面からの背景ノイズを抑制することで高感度検査を実現しました。10 nmオーダーの半導体デバイス製造工程で発生する異物の管理,およびウェーハ出荷・受け入れ品質検査向けに広く活用されています。
取扱会社:株式会社 日立ハイテク
特長
次世代プロセスに対応する高検出感度を実現
- 高効率検出光学系により,高い検出感度を達成し低段差・平坦系欠陥、微小異物をはじめ各種欠陥の検出が可能
- 高いスループットで生産性に貢献
多彩な装置ラインナップ、R&Dから量産ラインまで対応
- 先端ロジックデバイス製造ライン
- 先端メモリーデバイス製造ライン
-
電子デバイス用装置・材料メーカー
ウェーハ裏面吸着タイプでのモニタリング各種評価に対応 -
ウェーハメーカ:
エッジグリップ方式ハンドリングタイプでのウェーハ出荷検に対応。ウェーハ反転裏面測定可
高精度リアルタイム欠陥分離検出
- COP欠陥と付着異物を高精度に分離し、測定と同時に出力。検出ステージによって高精度な欠陥座標出力を実現し、ディフェクトレビューSEMとのスムーズなリンクにより、検出欠陥の観察が可能
仕様
| ウェーハサイズ | φ300mm 専用 (SEMI規格 Vノッチウェーハ) |
|---|
関連資料
関連製品

ディフェクトレビューSEM CR7300 Series
高速ADR、高精度ADCにより歩留まり改善に貢献するインライン対応レビューSEM

暗視野式ウェーハ欠陥検査装置 DI4600
高感度検出と高スループット検査による高速製品モニタリングを実現。歩留まり向上と生産コスト削減に貢献する次世代 対応暗視野式ウェーハ欠陥検査装置です。
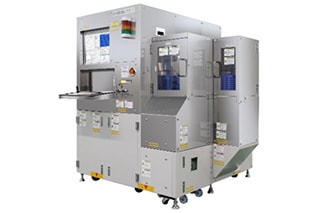
日立暗視野式ウェーハ欠陥検査装置 DI2800
G&Cデバイスの製造工程中のパターンサンプル上に発生する欠陥検出と管理に貢献

欠陥形状評価SEM CT1000
欠陥及びパターン形状の3D観察でG&Cデバイスの開発TAT短縮と品質向上に貢献
