ミラー電子式検査装置 Mirelis VM1000

SiCウェーハの結晶欠陥・加工ダメージの非破壊検査を実現
ミラー電子式検査装置 Mirelis VM1000は、SiC*1バルクウェーハ*2の加工ダメージや基底面転位、エピタキシャルウェーハ*3の積層欠陥や貫通転位などの結晶欠陥の非破壊検査を実現することで、次世代パワーデバイス用SiCウェーハの開発、工程管理、品質管理を強力にサポートします。
*1 SiC(Silicon Carbide):炭化ケイ素
*2 バルクウェーハ:インゴットより切り出し研磨したウェーハ
*3 エピタキシャルウェーハ:気化させた複数の化学物質を バルクウェーハ上に加え加熱することで、バルクウェーハと同様の原子配列である結晶(膜)を、バルクウェーハ上に生成・成長させたウェーハ
取扱会社:株式会社 日立ハイテク
特長
ウェーハ内部の検査
ミラー電子式の特長である電位ポテンシャル変化を捕らえることで、SiCバルクウェーハの加工ダメージや、SiCエピタキシャルウェーハの結晶欠陥(積層欠陥、基底面転位、貫通らせん転位、貫通刃状転位)など、ウェーハ内部の検査が可能。
電子線による非接触・非破壊検査
入射電子線がウェーハに到達する直前で、電位面で反射するため、ウェーハの非接触検査・非破壊検査を実現。これによりウェーハの出荷検査にも活用可能。
複数のウェーハ口径に対応
ウェーハホルダー交換により直径75mm、100mm、150mmの複数ウェーハ口径に対応。
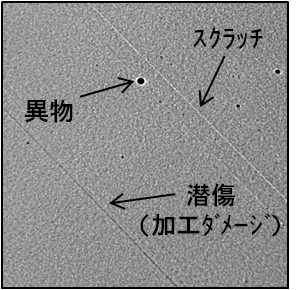
(FOV:80μm)
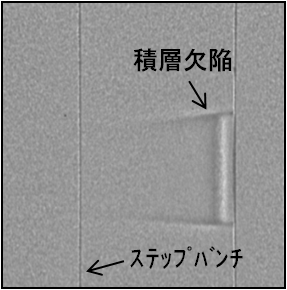
(FOV:80μm)
仕様
| 対応ウェーハサイズ | 直径75mm、100mm、150mm |
|---|---|
| オートローダー | 2ポート |
| 画像処理機能 | タイリング機能、欠陥抽出機能他 |
| 装置寸法(本体) | 1180(W) x 2500(D) x 1990(H)mm |
| 電源 | 単相AC200V、208V、230V、6kVA(50/60Hz) |
関連製品

高分解能FEB測長装置 CS4800
CS4800は 4、6、8インチのウェーハサイズに対応した測長SEMです。
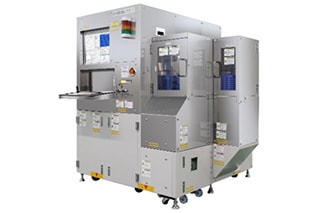
日立暗視野式ウェーハ欠陥検査装置 DI2800
G&Cデバイスの製造工程中のパターンサンプル上に発生する欠陥検出と管理に貢献

欠陥形状評価SEM CT1000
欠陥及びパターン形状の3D観察でG&Cデバイスの開発TAT短縮と品質向上に貢献
