
4. CD-SEM(測長SEM)とは
測長SEM(CD-SEM:Critical Dimension-Scanning Electron Microscope)は、走査型電子顕微鏡(SEM)の応用装置です。特に半導体等のウェーハ上に形成された微細パターンの寸法計測用に特化した装置で、主に半導体等の電子デバイスの製造ラインで使用されます。
CD-SEMの特徴(一般のSEMとの違い)
-
試料に照射する一次電子線の加速を1KV以下の低加速電圧に低減
CD-SEMの電子線のエネルギーを低くすることで、チャージアップや電子線照射による試料の損傷を低減させます。 -
倍率精度を極限まで高めて測定精度(再現性)を保証
標準偏差3σで、測長寸法の1%程度の測長再現性があります。 -
ウェーハ用の微細寸法計測に機能を絞り込むことで、測定を自動化
試料であるウェーハは、ウェーハカセット(またはポッド / FOUP)に入れて、CD-SEMにセットします。測長の条件や手順は、予め"レシピ"に設定しておきます。設定したレシピでCD-SEMを起動すると、CD-SEMは自動的にウェーハカセットから試料を取り出し、CD-SEM内に取り込んで、所望の箇所を計測し、計測終了後は、ウェーハを再びカセットに戻します。
これで一連の動作が完了します。
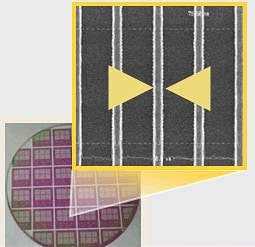
CD-SEMの計測の原理
計測には、SEM画像の濃淡(コントラスト)信号を用います。
- SEM画像上で計測箇所をカーソル等(位置を示すマーク)で指定します。
- 指定された計測箇所のラインプロファイルを求めます。ラインプロファイルとは、計測する寸法の部分の濃淡を高さ方向に取った高さ分布の線のようなものです。
- ラインプロファイルを使って、指定した箇所の寸法を求めます。寸法は、画像の倍率と測定区間の画素数カウントで、自動的に算出されます。
CD-SEMの画像例
以下にCD-SEMで取得したSEM画像の例を示します。図4-1は、1本のフォトレジストラインのSEM画像とその上にラインプロファイルを描いたものです。
フォトレジストのライン断面図とSEM画像の関係は、図4-2に示すようになります。
また、ラインの断面とそのラインプロファイルの関係は、図4-3の様になります。

すなわち、図4-1の画像から、ラインプロファイルを求め、ラインプロファイルから、線幅を求めます。ラインの断面が図4-3のように台形をしている場合、TOP位置とBottom位置の幅は一致しません。この場合どこのエッジ位置を測長値とするかは、レシピで指定します。また、所望の高さ位置を指定することもできます。
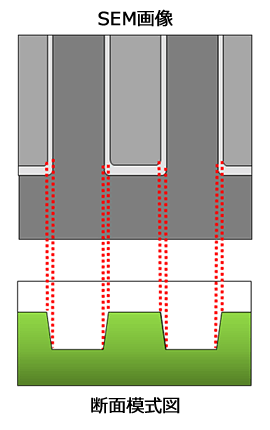
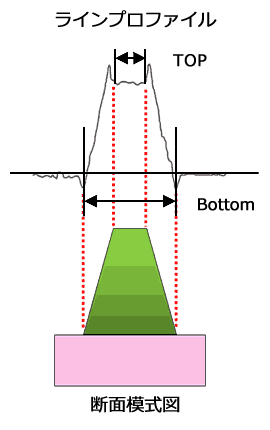
パターン計測工程
ウェーハ処理プロセスにおいて主に以下の工程で、寸法計測が行われます。
現像後のフォトレジストパターンの寸法計測
フォトレジストを現像し、転写したパターンを残します。
現像後、CD-SEMで寸法計測を行います。
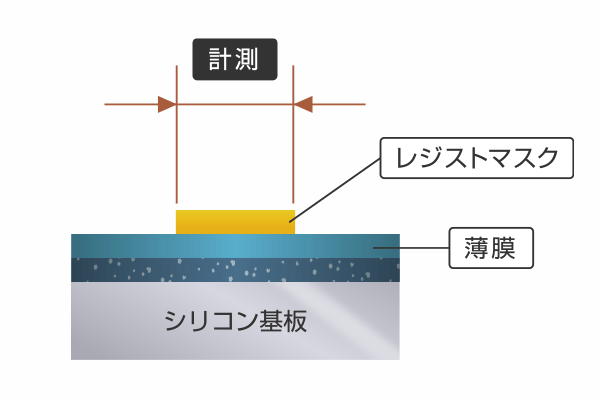
エッチング後の配線幅や、コンタクトホール径/ビアホール径の測定
フォトレジスト等のパターンをマスクとして配線等をエッチングして作製します。
エッチング工程後、不要となったフォトレジストは、オゾンやプラズマで灰化(Ashing)して除去/剥離します。この後、CD-SEMで寸法計測を行います。
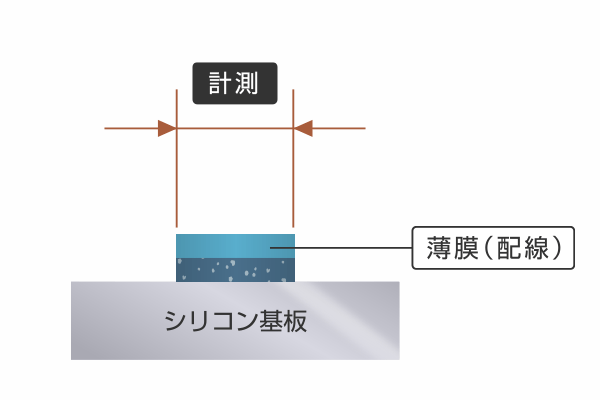
製品紹介
日立高分解能FEB測長装置
1984年、1号機を発売してから約30年。一貫してSEM画像に基づいた測長方式を踏襲し、改良を重ね、高い測長再現性を維持して来ました。半導体の微細化トレンドに対応した高い分解能を保ちながら、堅牢な装置で高稼働率を発揮。製造、開発ラインで求められる様々な新機能を盛り込んで、お客様のニーズに対応しております。
参考文献:
高分解能FEB測長装置(HITACHI CD-SEM)のラインアップをご紹介いたします。

高分解能FEB測長装置 CS4800
CS4800は 4、6、8インチのウェーハサイズに対応した測長SEMです。

- 半導体の製造4. CD-SEM(測長SEM)とは
- 半導体の製造3. 正確度と精度
- 半導体とは5.ウェーハ欠陥検査装置とは
製品サービス






