半導体の部屋
半導体の製造
6
レビューSEMとは
欠陥レビューSEM(Defect Review-SEM:Defect Review-Scanning Electron Microscope)は、走査型電子顕微鏡(SEM)の応用装置です。
半導体ウェーハ欠陥検査装置で検出した欠陥を、SEMを使って欠陥が認識できる程度の高倍率の画像にするのに使用します。したがいまして、半導体等の電子デバイスの製造ラインにて、主に検査装置と一緒に使用されます。

レビューSEMの機能
レビューSEMは、主に以下の様に働きます。
-
事前に欠陥検査装置でウェーハの欠陥を検査します
ウェーハ欠陥検査装置で、ウェーハ上の欠陥を検出します。検査装置では、欠陥がある位置座標を欠陥の情報としてリスト化し、ファイルとして出力します。 -
検査したウェーハと検査結果ファイルをレビューSEMにロードします
レビューSEMでは、検査済みウェーハとその検査結果(欠陥の位置座標情報)が記載されたファイルを取り込みます。 -
リストにある欠陥の写真を撮ります
欠陥リストのファイルの位置情報に基づき、欠陥の位置出しを行います。そして、その欠陥の写真をSEMで撮影し保存します。
検査装置では、数千から数万の欠陥を検出し、ファイルにリスト化する場合があります。
それらの欠陥を全て探し出して写真を撮るか、指定された一部の写真を撮るか、レシピで、作動条件を指定できるものもあります。
レビューSEMの欠陥検出方法
欠陥リストファイルの位置座標情報で、ウェーハ上の位置出しをしても、そこに目的の欠陥が見つからない場合があります。いろいろな誤差のため、位置座標情報だけでは欠陥を探しだすことは、容易ではありません。
欠陥検査装置では、欠陥の画像と隣接するダイの画像(参照画像)とを比較し、画像の差を検出(差画像処理)することによって欠陥を検出します。レビューSEMも欠陥検査装置と同様に、近傍のダイの回路バターンと比較して欠陥を検出し、正確な欠陥位置を割り出します。そしてその欠陥を視野の中心に移動させ、欠陥の拡大写真を撮影します。
メモリー等、同様のセルパターンが繰り返し並んでいる場合は、セルの最小単位の画像を予め参照画像として登録しておきます。そしてこの画像と欠陥の画像とを比較し、差画像処理をすることで、欠陥を検出する方法もあります。この場合、多くの部分に同一の参照画像が使えるので、欠陥検出の高速化を図ることができます。
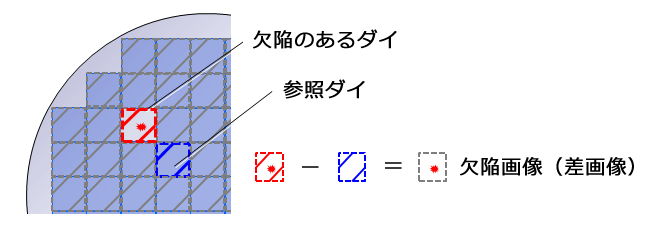
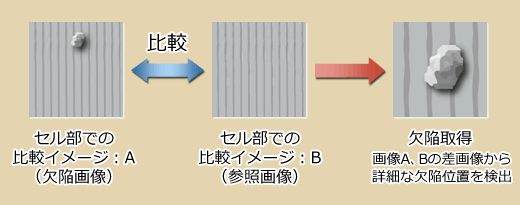
自動欠陥レビュー(ADR)と自動欠陥分類(ADC)
ADR(Automatic Defect Review)
自動欠陥レビューの略。欠陥レビューは、ウェーハ検査装置にて検出した異物、欠陥等の形状、成分等をより詳しく観察、分類、分析することです。自動欠陥レビューは、欠陥検査で取得された欠陥情報(座標など)により、自動的に目的の欠陥画像取得、データ保存を行いデータベース化することです。
欠陥レビューSEMでは、ADR機能により、自動で欠陥の画像を取得して保存します。
ADC(Automatic Defect Classification)
自動欠陥分類の略。画像サーバに格納された欠陥画像情報を、事前に定められたルールに基づき分類ソフトウエアにより欠陥発生原因ごとにクラス分けし、分類サーバに再格納します。分類された情報は歩留り管理システム(YMS)や工場のホストコンピュータに上げ、欠陥の発生原因追求や解析に用いられます。
欠陥レビューSEMのADR機能と連動して、ADCにより欠陥を分類する機能をもつ装置があります。また、ADRで取得した欠陥を後でまとめて分類する場合もあります。
製品紹介
欠陥レビューSEMとウェーハ検査装置のラインアップをご紹介いたします。

ミラー電子式検査装置 Mirelis VM1000
ミラー電子式検査装置 Mirelis VM1000は、SiCバルクウェーハの加工ダメージ、エピタキシャルウェーハの積層欠陥や基底面転位といった結晶欠陥を非破壊で検査します。


暗視野式ウェハ欠陥検査装置 DI4600
高感度検出と高スループット検査による高速製品モニタリングを実現。歩留まり向上と生産コスト削減に貢献する次世代 対応暗視野式ウェーハ欠陥検査装置です。
- 半導体の製造6. レビューSEMとは
- 半導体の製造5.ウェーハ欠陥検査装置とは
- 半導体の製造7.エッチング装置とは
製品サービス