Ion Milling System IM4000II
특징
높은 Milling Rate
IM4000II는 500 µm/h*1 이상의 단면 Milling Rate를 실현한 Ion gun을 탑재했습니다.
경질 재료의 단면 시료 제작에 유효합니다.
*1 가속전압 6kV, Mask Edge에서 Si를 100 µm 돌출시켜 1시간 가공했을 때의 최대 깊이
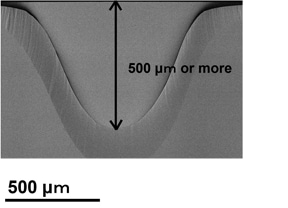
시료 : Si웨이퍼(2mm 두께)
가속전압 : 6.0 kV
스윙 각도 : ±30°
Milling 시간 : 1시간
단면 Milling 시에 스윙 각도가 변하면 가공 폭과 가공 깊이가 변화합니다. 아래 그림은 Si Wafer를 스윙 각도 15°로 단면 Milling했을 때의 결과입니다. 스윙 각도 이외에는 상기 가공 조건과 동일합니다. 상기 결과와 비교하여 가공 깊이가 깊은 것을 알 수 있습니다.
대상 구조가 깊은 곳에 위치해 있는 시료의 신속한 단면 제작에 유리합니다.
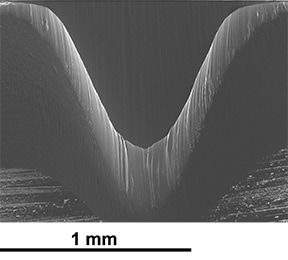
시료 : Si웨이퍼(2mm 두께)
가속전압 : 6.0 kV
스윙 각도 : ±15°
Milling 시간 : 1시간
Hybrid Milling
단면 Milling
- 경도나 Milling Rate가 다른 조성으로 구성된 복합재료에서도 평탄하고 넓은 단면 시료 제작 가능
- 가공조건 최적화로 데미지 경감
- 최대 20 mm(W) × 12 mm(D) × 7 mm(H) 시료 탑재 가능
단면 Milling의 주된 용도
- 금속이나 복합소재, 고분자 등 각종 시료의 단면 제작
- 균열이나 Void 등의 결함 해석을 위한 단면 제작
- 적층 계면이나 결정 정보의 평가·관찰·분석을 위한 단면 제작

평면 Milling (Flat MillingⓇ)
- 직경 약 5mm 범위를 균일하게 가공
- 목적에 맞는 폭넓은 용도로 이용 가능
- 최대 직경 50mm × 두께 25mm의 시료 탑재 가능
- 로테이션 가공과 스윙(±60° ~ ± 90° 반전) 가공의 2가지 방법 중, 선택 가능
Flat MillingⓇ의 주된 용도
- 기계 연마로는 제거가 어려운 미세한 흠집 및 변형 제거
- 시료 표면층 제거
- FIB 가공 데미지 제거

옵션
냉각온도조절기능*1
냉각전용용기에 충전한 액체 질소를 냉각원으로 사용하여 시료를 간접 냉각합니다. 수지 및 고무계 시료의 과냉각을 방지할 목적으로 온도 제어 기능을 탑재했습니다.

*1 본체 동시 출하 옵션입니다.


시료: 플라스틱 사용량을 억제하는 기능성 재료(종이제) 배리어 소재
분위기 차단 시료 홀더 유닛
Ion Milling 처리 후의 시료를 대기 노출 없이 SEM*1, AFM*2에서 관찰하기 위한 홀더입니다. 본 홀더는 냉각 기능과 병용도 가능합니다(평면 Milling 홀더는 제외).

*1 분위기 차단 시료 교환실이 있는 히타치 FE-SEM만 대응
*2 진공 지원 히타치 AFM만 지원
가공시 관찰용 실체현미경
Milling 중 시료를 관찰할 수 있는 실체 현미경입니다. CCD카메라를 탑재할 수 있는 3안 타입에서는 모니터 관찰이 가능합니다. 3안 타입 외에 2안 타입도 준비되어 있습니다.

사양
| 주요 사양 | |
|---|---|
| 사용 가스 | Ar(아르곤) 가스 |
| Ar 가스 유량 제어 방식 | 매스플로우 컨트롤러 |
| 가속전압 | 0.0 ~ 6.0 kV |
| 크기 | 616(W)×736(D)×312(H) mm |
| 질량 | 본체 53 kg+로터리 펌프 30 kg |
| 단면 Milling | |
| 최대 Milling Rate | 500 µm/h*1이상 |
| 최대 시료 사이즈 | 20(W)×12(D)×7(H)mm |
| 시료 이동 범위 | X±7 mm, Y 0 ~+3 mm |
| 이온빔 간헐 조사 ON/OFF 시간 설정 범위 |
1초 ~ 59분59초 |
| 스윙 각도 | ±15°, ±30°, ±40° |
| Wide Area 단면 Milling 기능 | - |
| 평면 Milling | |
| 최대 조사 범위 | φ32 mm |
| 최대 시료 사이즈 | Φ50 X 25 (H) mm |
| 시료 이동 범위 | X 0~+5 mm |
| 이온빔 간헐 조사 ON/OFF 시간 설정 범위 |
1초 ~ 59분59초 |
| 회전 속도 | 1 rpm, 25 rpm |
| 스윙 각도 | ±60°, ± 90° |
| 이온빔 조사 각도 | 0 ~ 90° |
*1 마스크 엣지에서 Si를 100 µm 돌출시켜 1시간 가공했을 때 가공 깊이.
옵션
| 항목 | 내용 |
|---|---|
| 냉각 온도 조절 기능*2 | 액체 질소에 의한 간접 시료 냉각, 온도 설정 범위 0 ~ -100℃ |
| 고빔 내성 마스크(Co-Zero®)*3 | 당사 표준 마스크비로 약 2배의 빔 내성 마스크 (코발트 미함유) |
| 가공 관찰용 실체현미경 | 배율 15×~100× 2안 타입, 3안 타입 (CCD대응) |
*2 본체 동시 출하 옵션. 냉각 온도 조절 사용 시에는 일부 기능에 제한이 있습니다.
*3 Co-ZeroⓇ는 일본 내 주식회사 히타치하이테크의 등록상표입니다.
Photo collections of beauty of metals, minerals, organisms etc. reproduced by the electron microscope and finished more beautifully by computer graphic technology.



