미소디바이스 특성평가 장비 Nano Prober NP8000
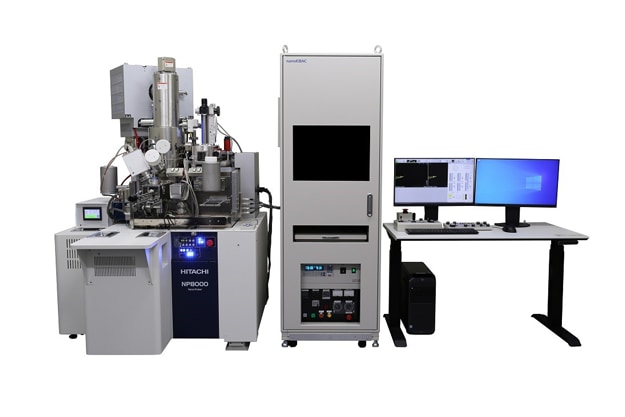
5nm 이후의 첨단 디바이스 해석을 지원하는 SEM 기반 Nano Probing 전용기입니다.
전자 광학계를 비롯한 개량에 의해 종래 장치에 비해 보다 안정적으로 전기 특성 측정 및 EBAC 해석을 실시하는 것이 가능하며, 불량 부분을 nm 오더까지 좁히는 것이 가능합니다.
개요
- 신형 Schottky 전자총에 의해 100V까지의 저가속 관찰 능력
- 대조사 전류에 의한 EBAC Image 질 향상
- 8탐침 대응
- 온도 의존 특성 평가용 고저온 Stage
- 탐침 Coarse 조정용 Top, Side view CCD 카메라
- 탐침으로부터 독립적으로 구동할 수 있는 시료 서브 Stage
- 전용 탐침 교환실
- EBAC(전자선 흡수 전류 Image 측정) 기능
- DI-EBAC(전압인가형 EBAC기능)
- 펄스 평가 기능(특주대응)

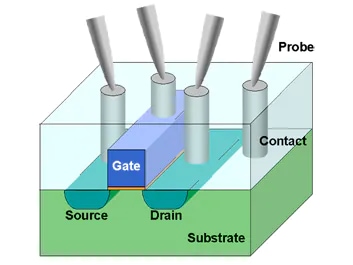
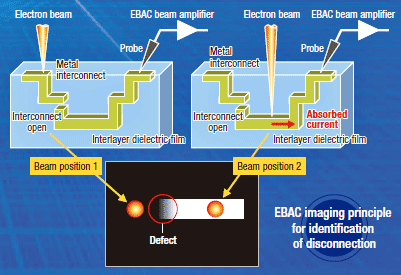
특징

Prober의 위치 제어 및 SEM 관찰을 제어할 수 있는 집약된 GUI
Probe의 접근을 보다 확실하게 하는 Top view/Side view를 동시에 표시

SEM Image와 EBAC Image를 동시에 표시
보다 신속한 결함 부분 발견 접근

Schottky 전자총에 의한 대조사 전류와 개량된 전압 인가 EBAC 앰프로 기존에는 어려웠던 저저항 결함도 가시화

Probe 접근시에 시료 손상 제어에 유효한 저가속 전압 관찰 능력
100 V/8만배 (Live Image)
시료: 5nm SRAM
사양
| 항목 | 내용 | |
|---|---|---|
| Probe Unit | Unit 개수 (탐침수) | 8 |
| 구동방식 | Piezo 소자 사용 | |
| Fine stroke range | 5 µm (X, Y축) | |
| Coarse stroke range | 3 mm (X축), 5 mm (Y축) | |
| 시료 Stage / Base Stage |
시료 크기 | 15 mm × 15 mm, 두께 1 mm이하 |
| 이동 포지션 |
측정 위치, 시료 교환 위치, 탐침 교환 위치 |
|
시료 교환 / |
예비 배기실 있음 | |
| Prober Navigation | Probe 위치로 Stage 이동 | |
| 측정 위치 기억 | ||
| 탐침 rough 조정 | CCD Image 표시기능 | Side / Top 에서 관찰한 Image 표시 |
| 전자광학계 | 전자총 | Schottky형 전자총 |
| 가속전압 | 0.1~30 kV | |
| Image Shift |
±75 µm이상 (1.0 kV, WD=5 mm) |
|
| EBAC Amp / 화상 표시 |
Amp 종류 | Current Amp / Differential Amp / DI Amp |
| 화상 표시 | SEM Image / EBAC Image | |
| 단독 / 병렬 / 결합 표시 | ||
| 화상 처리 | 흑백 반전 표시, 컬러 표시 기능, 밝기 조정, Slow Scan integration, Belt Scan |
|
This journal addresses a wide range variety of research papers and useful application data using Hitachi science instruments.


