중형 Probe 현미경 시스템 AFM5500M

XY200 µm 의 넓은 영역 주사와 더불어, 뒤틀림을 억제한 Flat 스캐너로 직선성 높은 계측을 실현할 수 있는 중형 SPM입니다. 또한 Cantilever의 장착・교환, 광축 조정을 자동화함에 따라 Operator의 부담을 큰 폭으로 경감하였습니다. 또한, SEM과 SPM 시료의 동일한 부분을 간단하게 측정할 수 있는 AFM&SEM Linkage System 탑재가 가능합니다.
특징
자동화
- 자동화를 통한 생산성 향상을 추구
- Operator로부터 기인된 측정 오차의 배제를 추구


신뢰성
* 광역 Flat Scan Mechanical로 측정 오차 배제를 추구
기존의 SPM에 사용되어 왔던 Tube형 Piezo 스캐너는 원호 운동에 의해 휘어진 데이터에 소프트웨어적 보정을 걸어 평골화 처리를 실시해 왔습니다.
그러나 이 보정으로도 원호 운동의 영향을 완전히 제거할 수는 없으므로 Data에 왜곡이 남는 경우가 있었습니다.
AFM5500M은 새롭게 개발한 Flat 스캐너를 탑재하여 원호 운동의 영향을 받지 않는 정확한 측정을 실현했습니다.
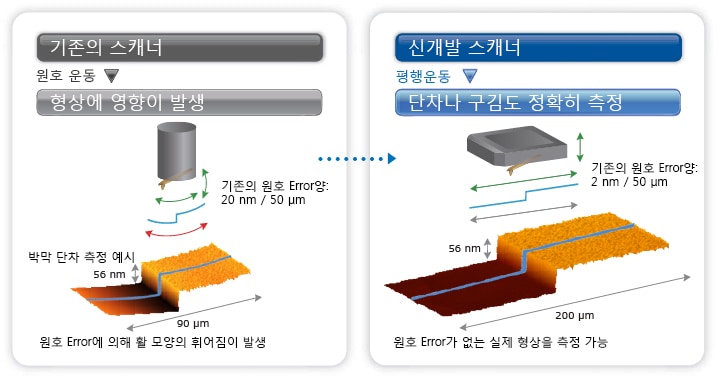
관찰 시료: 실리콘 기판 상의 Amorphous Silicon 박막
* 높은 수직성
기존 SPM에 사용해 왔던 스캐너는 수직 방향의 신축 동작을 행할 때 휘어짐(Cross Toque)이 발생하였습니다. 이는 양 쪽 형상의 차이나 영상이 왜곡되는 원인이었습니다.
AFM5500M에서는 수직 방향에 Cross Toque가 없는 스캐너를 새롭게 개발・탑재하여 좌우 왜곡이 없는 정확한 측정을 실현하였습니다.

관찰 시료: 다이요 전지 Texture 구조 (결정 방위에 의한 좌우대칭 입체 구조)
* AFM5100N (Open Roof 제어) 사용 시
친화성
다른 검사 분석 수단과의 친화성을 추구
SEM-SPM에 공통 좌표 Linkage 홀더가 있어 동일 시야의 형상, 구조, 조성, 물성을 빠르고 간단하게 관찰, 분석할 수 있도록 하였습니다.
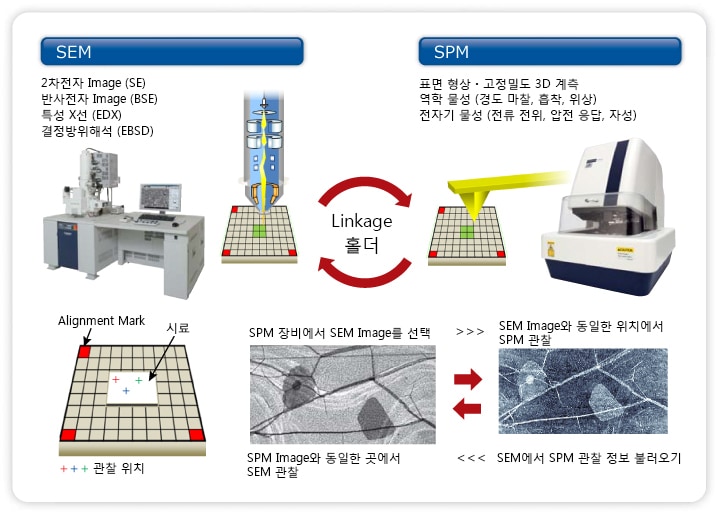
SEM-SPM 동일 시야 관찰 예시 (시료: Graphene/SiO2)
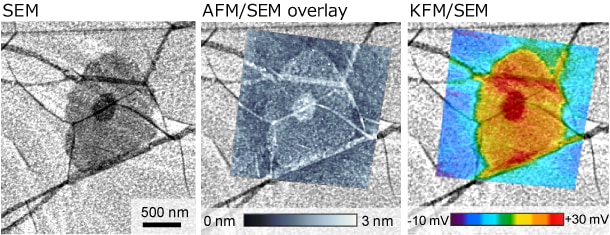
SEM과 SPM Image Overlay: ㈜아스트론사의 어플리케이션 AZblend Ver2.1. 사용
KFM (Kelvin Probe Force 현미경)을 통한 형상 Image (AFM Imager)와 전위 Image (KFM Image) 를 SEM Image에 Overlay시킨 데이터입니다.
- SEM의 Contrast 차를 보면 AFM Image의 Graphene 1층만큼의 높이에 상당한다는 것을 알 수 있습니다.
- Graphene의 층 수 등에 의해 표면 전위 (일함수)가 다르다는 것을 알 수 있습니다.
- SEM Contrast의 기원을 SPM에 의한 고정밀도 3D 형상 계측과 물성 관찰을 통하여 더욱 심도 있게 추구할 수 있습니다.
앞으로도 타 현미경 및 검사 장비와의 Linkage를 강화해 나가겠습니다.
사양
| Stage | 정밀전동Stage 관찰 가능 영역: 100 mm (4인치) 전역 stroke: XY ±50 mm, Z ≥21 mm 최소 Stage: XY 2 µm, Z 0.04 µm |
|---|---|
| 최대 시료 사이즈 | 직경: 100 mm (4인치상당), 두께: 20 mm 시료 하중: 2 kg |
| 주사범위 | 200 µm × 200 µm × 15 µm (XY: Closed loop 제어 / Z:변위 센서 계측) |
| RMS Noise Level* | 0.04 nm이하 (고분해능 모드) |
| 반복 재현성* | XY: ≤15 nm(3σ, 10 µm pitch계측) / Z: ≤1 nm (3σ, 100 nm 깊이 계측) |
| XY 직교도 | ±0.5° |
| BOW* | 2 nm / 50 µm이하 |
| 검출계 | 광 레버 방식 (Low Coherent 광학계) |
| 직상광학현미경 | Zoom 배율: ×1 ~ ×7 시야범위: 910 µm × 650 µm ~ 130 µm × 90 µm 모니터 배율: ×465 ~ ×3,255 (27인치 모니터) |
| 제진대 | 탁상 Active 제진대 500 mm(W) × 600 mm(D) × 84 mm(H), 약 28 kg |
| 방음Box | 750 mm(W) × 877 mm(D) × 1400 mm(H), 약 237 kg |
| 크기 및 중량 | 400 mm(W) × 526 mm(D) × 550 mm(H), 약 90 kg |
* 사양 수치는 시스템 구성 및 설치 환경에 따라 달라질 수 있습니다.
| OS | Windows7 |
|---|---|
| RealTune® II | Cantilever진폭, 접촉력, 주사속도 및 Feedback Gain 자동 조정 |
| 조작화면 | 내비게이션 기능, Multi Layer 표시기능(측정/해석), 3D Overlay 기능, 스캔 가동범위/측정 이력 표시 기능, 데이터 해석 일괄 처리 기능, 탐침 평가 기능 |
| X, Y, Z주사 전압 | 0~150 V |
| 동시측정 (Data Point) |
4화면 (최대 2,048 × 2,048) 2화면 (최대 4,096 × 4,096) |
| 스캔 화면 비율 | 2:1, 4:1, 8:1, 16:1, 32:1, 64:1, 128:1, 256:1, 512:1, 1,024:1 |
| 분석 Software | 3차원 표시 기능, 표면 거칠기 분석, 단면 분석, 평균 단면 분석 |
| 装置制御機構 | カンチレバー自動交換、自動光軸調節 |
| 크기 및 중량 | 340 mm(W) × 503 mm(D) × 550 mm(H), 약 34 kg |
| 전원 | AC100 ~ 240 V ±10% 단상 |
| 측정모드 | 표준: AFM, DFM, PM(위상), FFM 옵션: SIS형상, SIS물성, LM-FFM, VE-AFM, Adhesion, Current, Pico-Current, SSRM, PRM, KFM, EFM(AC), EFM(DC), MFM |
| 히타치 하이테크 SEM 대응기종 |
SU8240, SU8230 (H36 mm타입), SU8220 (H29 mm타입) |
|---|---|
| 시료 홀더 사이즈 | 41 mm(W) × 28 mm(D) × 16 mm(H) |
| 최대 시료 사이즈 | Φ20 mm × 7 mm |
| Alignment 정밀도 | ±10 µm (SPM Alignment 정밀도) |
동영상
Introducing Application Note of our Atomic Force Microscope (AFM).
This journal addresses a wide range variety of research papers and useful application data using Hitachi science instruments.
Describing basic principles and multiple function principles of Scanning Tunnel Microscope (STM), Atomic Force Microscope (AFM) etc.
The trademark that represents our strong bond with the customer and shows our pledge to connect science and society to create new value.


