View according to field: Materials Analysis AFM (inorganic, metal)

Hitachi AFM will prove useful at any stage
By field
Measurement solutions that will take you one step forward
Since modern manufacturing at its core relies on a diverse range of nano materials, high-precision measurement of a sample’s surface topography and chemical composition have become an essential part of materials research. The AFM5500M combines the topography, composition and elemental analysis functions of SEMs with an AFM’s 3D topography measurement capabilities and solutions for analysis of mechanical and electromagnetic properties. It also measures work functions in both ambient and vacuum environments, enabling highly sensitive MFM measurement of vacuums, thus firmly meeting a variety of measurement needs that occur at sites carrying out materials research.
Automated sample navigation for correlated AFM-SEM imaging at the same location
“SÆMic.” is a one-piece solution that combines the topography, composition, and elemental analysis functions of SEMs with the ability of AFMs to conduct 3D measurement and analyze/evaluate mechanical (hardness, adsorbent, abrasive), electromagnetic (electrical current, resistance, potential), and magnetic (magnetism) properties. Through the use of a linkage holder, it also enables easy analysis/evaluation of identical points with a SEM and AFM.
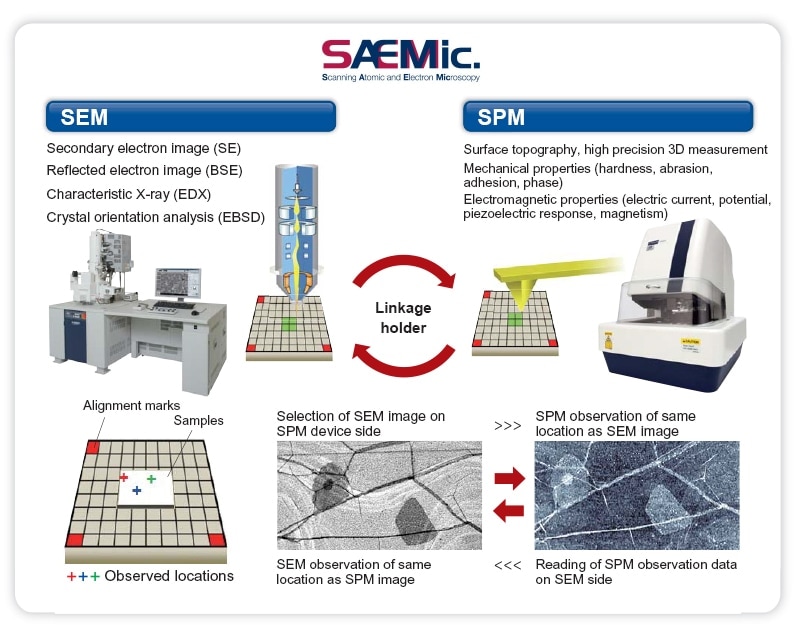
Measurements of work functions in ambient or vacuum environments
This model is capable of carrying out KFM (kelvin force microscopy) of a single sample in both ambient and vacuum environments. Even when using different measurement techniques in ambient and vacuum environments, there will be no gap in results and it is thus possible to calculate the impact of the environment (atmosphere/vacuum) on the calculation of work functions.
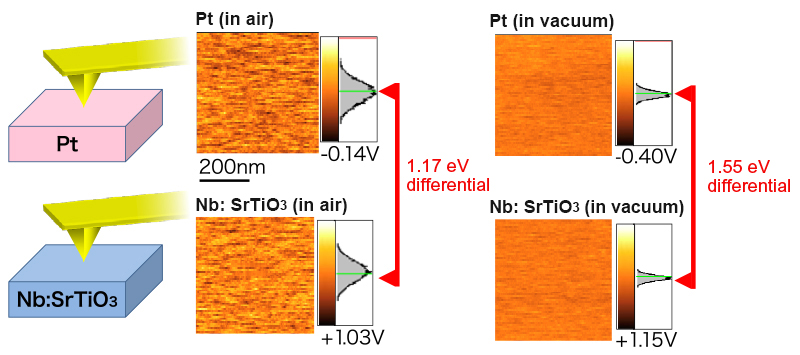
High-sensitivity MFM measurements in ambient or vacuum environments
Capable of isolating and generating an image of the magnetic forces that affect magnetic tips and samples as variations in cantilever vibration. Since it can be used for measurement in a vacuum environment, there is little of the viscosity resistance generated by gas molecules and liquids that might occur in ambient environments or solutions. By setting appropriate Q options automatically, it also enables highly sensitive, high-resolution magnetic imaging.
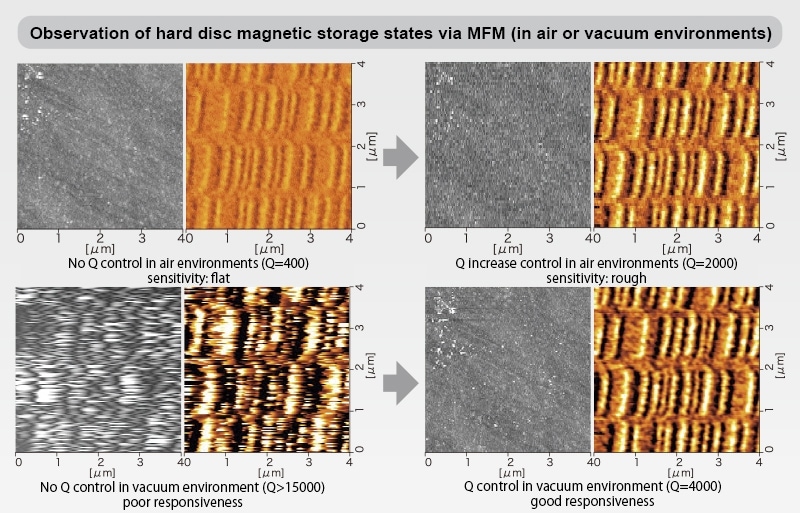
(atmosphere, vacuum)
Product lineup
Hitachi AFM will prove useful at any stage
By application
Automation / Ease of use
High accuracy / High resolution
- High-accuracy measurements of slanted surfaces with a steep slope
- High-accuracy measurements without damaging samples
- High-resolution measurements in a vacuum
- Stable and accurate measurements during sample heating and cooling
- High-accuracy topography measurements
- High-sensitivity MFM measurements in ambient or vacuum environments
- Humidity control / observations in liquid
Physical property measurements /
Environmental Controls
- Measurements of work functions in ambient or vacuum environments
- Observations of dopant distribution
- Quantitative measurements of elastic modulus
- Observations of structural changes in a vacuum
- Enabled true observations of topography and other physical properties
- Enabled quantitative measurements during sample heating and cooling
This section introduces applications (actual measurement cases) for scanning probe microscopes (SPM/AFM).
Information for product users
This section offers information aimed at customers who use our scanning probe microscopes.
For first-time users
Related topics

“S.I.navi” is Hitachi Membership Site for analytical instruments users.
“S.I.navi” provides helpful information for daily analysis.









