走査型プローブ顕微鏡システム「AFM5500M」は、ナノレベルでサンプル表面の立体形状観察と物性マッピングを同時に行うことができる装置である。広域フラットスキャナによりXY200 µmの広域走査に加えて歪みを改善した直線性の高い計測を実現する。さらにカンチレバーの装着・交換、光軸調整及び測定パラメータの調整等を自動化することでオペレーターの負担を大幅に軽減した。また、走査電子顕微鏡(SEM)との異種装置間で試料の同一場所を簡単に測定できるAFM & SEMリンケージシステムを搭載する。

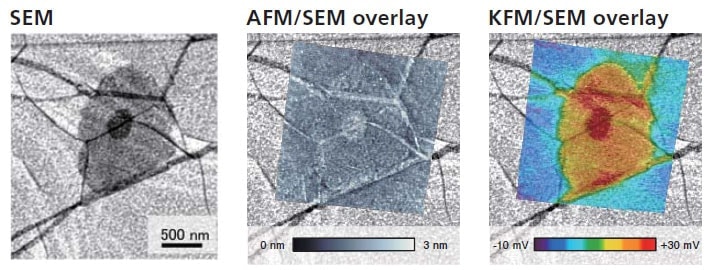
SEM-AFM同一箇所観察例(試料:グラフェン/ SiO2)
形状像(AFM)と電位像(KFM)をSEM画像に重ね合せたデータ
さらに表示