Observation and Measurement Using the Electron Channeling Pattern Function

九州大学 大学院工学研究院
准教授
山﨑 重人博士(工学)
結晶性材料の構造解析を行う上で転位の観察は非常に重要である。図1はSEM 電子チャネリングコントラストイメージング(Electron Channeling Contrast Imaging: ECCI)法により観察されたシリコン中の転位像であり、近年ではSEM でもTEM 像と見紛うような鮮明な転位像を撮ることが可能になってきた。しかし、ECCI 法による転位観察を行った研究において観察時の電子線入射条件までを考慮したものは少なく、転位組織解析としては半定量的な取り扱いに留まったものが多い。転位運動の様式や転位密度を正確に評価するためには、g・b 解析を用いたバーガースベクトルの決定や観察条件下での転位の可視・不可視の明確化が不可欠である。また、ECCI 像における電子線の侵入深さ(消衰距離)を見積もる際にも正確な電子線入射方位の決定が必要である。こういった情報が得られて初めて、TEM 観察と同様の転位組織解析をECCI 観察でも行えるようになる1)。
SEM において電子線入射方位を決定する方法には、ECP(Electron Channeling Pattern)法やSACP(Selected Area electron Channeling Patterns)法、そしてEBSD(Electron Back Scattered Diffraction)法があり、より高速での結晶方位マッピングを可能とするためにECP/SACP 法からEBSD 法へと発展してきた経緯がある。このようにEBSD 法の普及によって一度は活躍の場を失ったECP 法やSACP 法であるが、定量的なECCI 観察のためには高精度な電子線入射方位の探索・決定が必要となることを受けて、近年再び脚光を浴びるようになってきている。本稿では、電子線傾斜照射機構を用いて取得したSACP を併用したECCI 観察の実施例について紹介する。
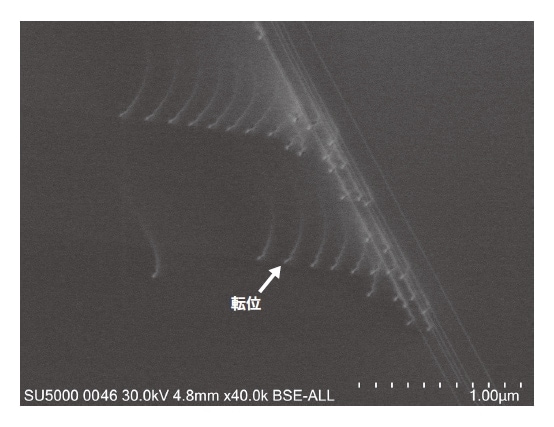
図1 SEM-ECCI法により観察したシリコン中の転位像
上述したように、SEM において電子線入射方位を決定する方法としてはEBSD 法が最も一般的である。しかし、EBSD 法によって結晶方位を測定する際には試料を70°程度傾斜する必要があるが、70°傾斜下で測定された結晶方位情報から無傾斜の状態での電子線入射方位を推定する場合、最大で2°程度の誤差が生じることが報告されている2)。ECCI 観察に適切な電子線入射方位を探索する上で2°の誤差は致命的であり、EBSD 法で得られた方位情報をもとに定量的なECCI 観察を行うことは不可能ではないものの非常に困難を伴う。
EBSD 法以外の電子線入射方位の決定方法としてはECP 法やSACP 法がある。図2(a)に低倍率(×50)で撮影したSi 単結晶の反射電子(Back Scattered Electron: BSE)像を示す。単結晶であるにもかかわらず試料表面上には幾何学的な模様が現れており、これを電子チャネリングパターン(ECP)という。図3(a)の電子線照射方法の模式図に示すように、低倍率でSEM 像を観察する場合には入射ビームと試料表面のなす角度が電子線のスキャン位置によって大きく変化する。その際に、電子線の入射角度がたまたまBragg 条件を満たしたスキャン位置(入射角度)ではBSE 強度が弱くなるため、BSE 像には電子線の入射方位に応じた図形、すなわちECP が観察される3)。ECP は試料の結晶方位が反映された図形であるため、これを解析することで電子線入射方位の決定が可能である。また、図3(b)に示すように、電子線の照射点を1点に固定した上で、電子線照射の傾斜角度を変化(ビームロッキングと呼ばれる)させた場合にも同様の図形を観察することが可能であり、そのようにして得られた図形を制限視野電子チャネリングパターン(SACP)と言う。図2(b)に図2(a)と同じ位置で取得したSACP を示す。電子線傾斜照射機構を用いることによって、ECPと同様の図形がより鮮明かつシャープな像として得られており、SACPを用いればECP よりもさらに高精度に入射方位を決定することが可能である。
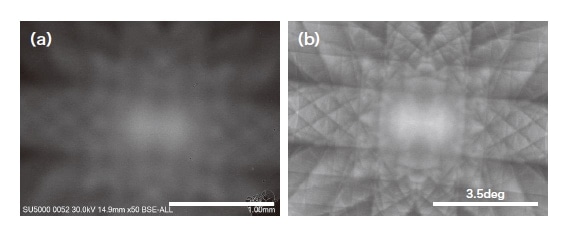
図2 (a)低倍率で撮影したSi単結晶のBSE像と(b)同一試料で取得したSACP

図3 (a)通常のSEMスキャンと(b)SACP取得時の電子線照射方法の模式図
(SU5000 電子線傾斜照射機構 instruction manual より)
また、ECP 法と比較した際のSACP 法の大きな利点に空間分解能の高さが挙げられる。図2(a)からも分かるようにECP法において十分な電子線傾斜角度範囲を確保しようとするとミリメートルオーダーの視野サイズとなってしまい、実質的には単結晶や極めて粗大な結晶粒径の試料に対してしかECP 法による入射方位決定は適用できない。一方、例えばHITACHI SU5000に搭載された電子線傾斜照射機構を用いた場合には、最小で5 μm 程度までSACP 取得時の照射領域を限定することが可能である。ただし、SACP 法において、入射電子線を高角度まで傾斜させた際にはレンズの球面収差の影響が顕著に現れてくるため、SACPモードを搭載する近年のSEM には高角度傾斜と微小領域照射を両立するために球面収差補正機能が付属している。図4に球面収差補正の調整を行った例を示す。調整にはグリッド間隔約25 μm, 線幅約5 μm のCuメッシュを使っており、調整途中の図4(a)では視野内にはまだ数本のメッシュが確認されており照射範囲は200 μm 程度に広がった状態である。また視野の上下で観察されるメッシュの本数が異なっていることから、等方的な照射が行えていないこともわかる。図4(b)は調整が完了した時点の様子であり、メッシュの交点が視野全体に広がっており、照射領域は5 μm 程度まで限定されていることが確認できる。
このように、SACP 法を用いれば多結晶中の個別の結晶粒について約0.1°4)の高精度で電子線入射方位を決定することが可能である。このとき、試料傾斜などの観察条件を一切変更することなくECCIとSACP の観察モードをボタン一つで切り替えられる点が実用上では極めて有益である。例えるなら、TEM 観察においてTEM 像と回折パターンを行き来しながら観察条件や視野を探索するのと同じ感覚でECCI 観察を行うことができる。
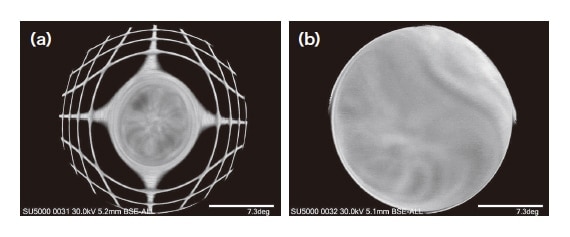
図4 SACPモードにおける球面収差補正の調整
(a)調整途中、( b)調整完了時
図5にECCI像とSACPを交互に使用しながら観察を行った例を示す。試料は多結晶のニッケル基合金である。図5(a)-(c)がECCI像であり、図中の十字はSACPモードでの照射点を示している。図5(d)-(f)は、それぞれ図5(a)-(c)の十字の位置から取得したSACP である。図5(a)および(c)の十字の位置に存在する結晶粒からは明瞭なSACP が取得できており、各SACP の中心の結晶方位がECCI 観察における電子線入射方位に対応している。一方、図5(e)は結晶粒界の極近傍で取得したSACP であるが、このパターンには図5(d)と図5(f)のパターンが重畳している。このように、比較的大きな結晶粒の内部からは明瞭なSACP を得ることができるが、粒界近傍や粒径10 μm 以下の微細粒などでは隣接粒の影響を受けてしまうことに注意が必要となる。また、変形によって結晶粒内で方位回転が生じている場合にもSACP が不鮮明になってしまう。そのため、近年ではSACP の選択照射領域をより小さくすることを目指した研究も進められており、ビームロッキングとビームシフトを組み合わせた方法2, 4)やステージロッキングを組み合わせた方法5)を採用することによって、選択照射領域をサブミクロンスケールにまで小さくできることが報告されている。
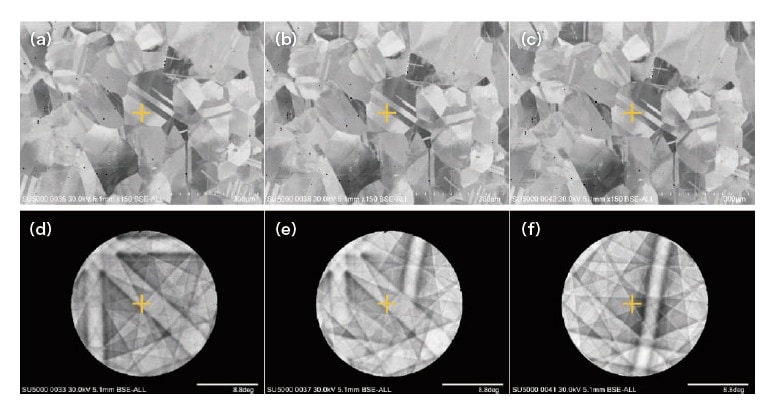
図5 多結晶ニッケル基合金の(a)-(c)ECCI像と(d)-(f)ECCI視野中心部で取得したSACP
図5をよく見ると、ECCI 像の十字部の結晶粒のコントラストとSACP の十字部のコントラストが一致していることがわかる。これはどちらの像も同様に電子線のチャネリング条件に応じた反射電子の放出量によってコントラストを生じているためである。ECCI 法によって転位を観察する場合にはチャネリング条件を満たした結晶粒、つまりECCI 像において暗く観察される結晶粒が適している。多結晶の場合は多数の結晶粒の中でたまたまチャネリング条件を満たしている結晶粒を見つけて観察することも可能ではあるが、SACP を併用すれば任意の結晶粒についてチャネリング条件を満たす電子線入射方位へ試料を傾斜して観察することも可能となる。とくにg・b 解析など、特定の入射方位に制御する必要がある場合にはSACP は目的の入射方位へ向かうための道しるべとして極めて有用なツールとなる。
TEM の場合、電子回折図形を見ながらα軸とβ軸の2つの軸を傾斜させることで任意の回折条件へ制御することができる。これと同様に、ECCI 観察の場合にはSACP を使って特定の入射方位へ試料を傾斜する。ただし、通常のSEM のステージには一軸傾斜の機能しかないため、以下ではステージローテーションと一軸傾斜を組み合わせることで任意の方向へ試料を傾斜させた例を紹介する。
図6にローテーションRと一軸傾斜T を使って、特定の結晶粒についてチャネリング条件を満たすようにした例を示す。試料は多結晶ニッケル基合金である。この実験では図中の挿入図で示すSACP を参考に回転・傾斜を行っている。図6(a)中の線で囲った結晶粒に着目すると、R = 0°, T = 0°の状態では結晶粒が明るく写っておりチャネリング条件を満たしていない。この結晶粒がチャネリング条件を満たすようにするには、SACP 内の暗い部分をパターン中心の十字印の位置に持ってくれば良い。ここでは、SACP 中に描いた三角形の部分がパターンの中心に来るようにステージを回転・傾斜する。ステージを反時計回りに35°回転させると図6(b)のようになる。挿入図のSACP を見ると、目標とする三角形のひとつがパターン中心の真下(6時の位置)に来ている。つぎに、図6(b)の位置から少しずつマイナス側に傾斜していく。このときの結晶粒のコントラスト変化と、対応するSACPの変化を図6(c)-(f)に示す。傾斜していくにつれて結晶粒のコントラストが変化しており、-3.7°傾斜した時点でパターン中心が目標の三角形の中に入っている。このとき、着目していた結晶粒のコントラストが暗くなっており、チャネリング条件を満たしたことがわかる。図7は図6(f)の状態で倍率を上げて観察したECCI 転位像であり、転位線や積層欠陥が明瞭に観察できている。このように、SACP を利用することでチャネリング条件を満たす方位へ試料傾斜を容易に行うことができ、任意の結晶粒での転位観察が可能となる。
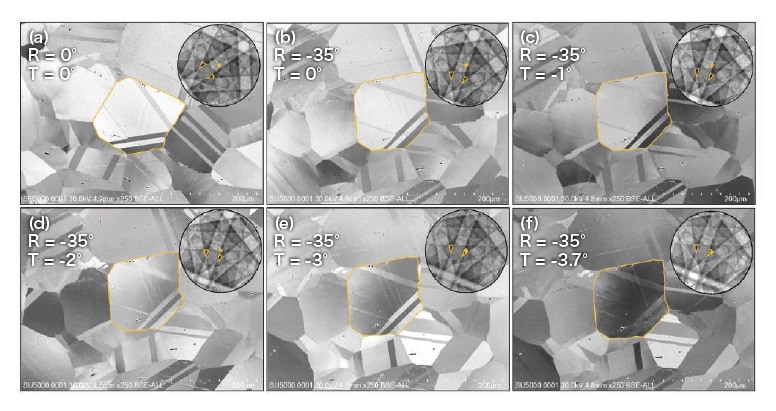
図6 ステージローテーションと一軸傾斜による入射方位制御の例

図7 図6(f)の条件下で撮影したECCI転位像
SACP を使って任意の入射方位への試料傾斜できること利用すれば、g・b 解析による転位のバーガースベクトルの決定をすることも可能である。図8はBCC 鉄単結晶内の同一視野を2つの異なる入射方位から観察したECCI 像である。図8(a)では明瞭に転位線が観察されているのに対し、図8(b)では転位線は観察されない。SACPと菊池パターンシミュレーションを対応させることで各観察条件での電子線入射方位を決定すると、図8(a)の観察条件では20 が、図8(b)では220 が励起された条件であることがわかる。転位線が前者では見えて後者では見えないことから、この視野内の転位のバーガースベクトルは20との内積≠0かつ0との内積=0になる〈11〉、 〈11〉、 〈1〉、 〈1〉が候補となる。さらに、ECCI 像では表面近傍に位置する転位線ほど明るく観察されるため、観察されている一本の転位線に着目すると左側が表面近傍に右側が試料内部に位置していることがわかる。この配置を考慮すると、観察されている転位のバーガースベクトルは〈11〉または〈1〉であることが明らかとなる。このように、SACP 法を併用したECCI 観察では、これまではTEM でしか行えなかった転位のキャラクタリゼーションを行うことも可能である。
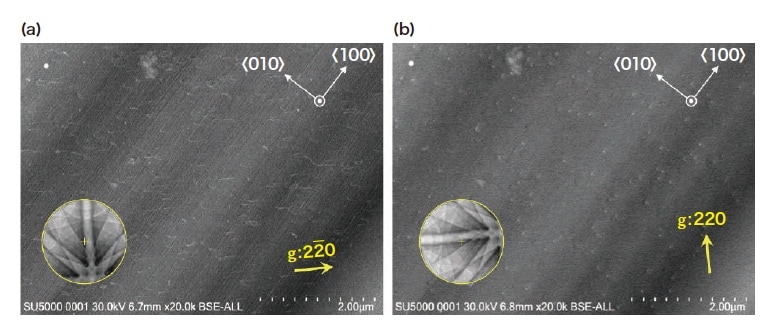
図8 同一視野を異なる入射方位から観察した際のECCI転位像
(a) g=20, (b) g=220
最後にSACP のさらなる可能性について述べる。結晶性試料中の格子ひずみを測定する方法としてはXRD やCBED があるが、XRD で得られる情報はバルク試料全体の平均情報であり、CBED の場合には試料が薄膜であるためバルク内でのひずみが正確に反映されていない可能性がある。これに対してSEM 試料サイズのバルク体についてサブミクロン領域の格子ひずみを測定する方法としてEBSD を利用した手法(Wilkinson 法とも呼ばれる)がある。Wilkinson 法では菊池パターン内の注目領域間(Region Of Interest: ROI)の変位から菊池バンド幅の変化を検出することによって格子ひずみを求めるものであり、材料の弾性定数がわかっていればEBSD 各測定点での応力分布を可視化することも可能である。
しかし、Wilkinson 法が抱える課題のひとつに格子ひずみの分解能の低さが挙げられる。通常のEBSDカメラの解像度は1,000×1,000ピクセル程度と画像相関法によって変位を測定する上では解像度が十分とは言えず、パターン撮像の倍率も固定である。このことがWilkinson 法のひずみ分解能を制限している。これに対して、SEM 像は5,000ピクセル以上の高解像度でも撮像できる。さらに、SEM 像を使うSACP であれば図9に示すように倍率を上げて撮像することも可能である。このようにしてSACP を取得すれば画像相関法によって菊池バンドの変位を測定する際のゲージ長を長くとることが可能となり、ひずみ分解能の向上が期待される。ただし、前述したように現状ではSACP の選択照射領域が数ミクロン程度と大きく、領域内に格子ひずみの分布がある場合にはその影響により鮮明なSACP が得られないことが予想される。したがって、SACPを使った格子ひずみ解析を実現するためには、3節で述べたようなSACP の空間分解能向上がより一層重要になってくるものと思われる。

図9 高倍率で撮影したシリコンのSACP
SACP を使ったECCI 観察の実施例を紹介し、その有用性を示した。ECCI 法による転位組織観察の利点を最大限発揮するためには、本稿で述べたような定量的な解析を容易に行えるようになることが重要であろう。現状では電子線傾斜照射機構を搭載したSEM は非常に少ないが、高速での結晶方位マッピングにはEBSD 法を、高精細なパターンの取得と電子線入射方位の制御にはSACP 法をといったように、用途や目的に応じてこれらの電子回折パターン取得方法を使い分けられるようになればSEM による結晶性材料の構造解析の更なる発展につながるものと期待する。
参考文献
登録記事数 203件
まだまだあります。