Triple Beam FIB-SEM-Ar(Xe) Combined System
清原 正寛*1、佐藤 高広*2、酉川 翔太*1
FIB-SEM複合装置(FIB: Focused Ion Beam、SEM: Scanning Electron Microscope)は、透過電子顕微鏡(TEM: Transmission Electron Microscope)などによる解析に用いる薄片試料作製ツールとして広く使用されています。ところが、近年の被解析物の構造の多様化や微細化に伴い、より高い精度での解析が行われるようになりました。その結果、FIB-SEM複合装置で行う解析試料作製におきましても、高品位な試料の作製を求められるようになりました。その実現に当たりまして、例えば以下に示すような課題の克服が求められています。
FIB-SEM複合装置の担う役割はますます大きくなってきています。日立ハイテクでは、このような課題克服のための技術開発を進めてまいりました。ここでは、その一環として開発してまいりました、トリプルビーム NX2000(図1)を用いた上記課題の解決方法をご紹介いたします。

図1 NX2000装置外観写真及び主要スペック
上述1. の課題克服として、FIB加工によるダメージを抑制するため、FIBの加速電圧を下げて仕上げ加工を行うことが一般的になってきています。日立ハイテクのシステムでは、FIBによるエッチング加工と同時に、分解能を損なうことなく露出した断面をSEM観察できるため、容易に所望箇所にて加工を終了することができます。
また、構造の微細化、分析要求精度の高度化を受けて、さらにダメージ層の少ない高品位試料が求められるようになっています。日立ハイテク独自の装置構成であるトリプルビームは、図2に示す通り、集束イオンビーム(FIB)、電子ビーム(EB)、アルゴン(Ar)イオンビームが試料表面の一点で交差する構成になっており1)FIB加工によって形成されたダメージ層を低加速Arイオンビームによるエッチング加工によって取り除くことができます。
トリプルビームは
こうした特長により、他の装置にない効果を発揮することができ、上述1. および2. の課題克服が容易になります。
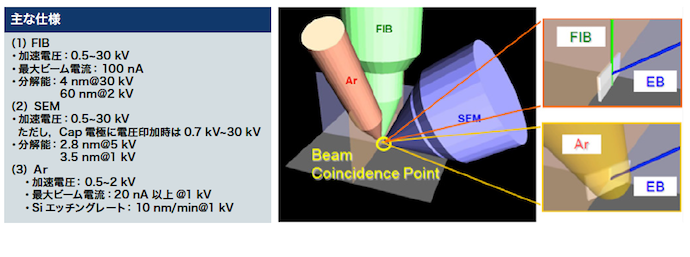
図2 トリプルビーム基本構成
NX2000では、Arの約3.2倍の質量をもつXeイオンビームを新たにオプションとしてラインナップいたしました。Xeイオンビームは、Arイオンビームシステムと同様、加速電圧を 0.5~2.0 kV の範囲で変更することができます。また、供給するイオン源ガスを切り替えることで、同一システムで XeイオンビームとArイオンビームを使い分けることが可能です。
図3に試料(GaN)の試料作製に当たり、ArイオンビームおよびXeイオンビームを仕上げ加工に用いた時のTEM観察像を示します2)。Arイオンビームと同じように、Xeイオンビームを用いた仕上げ加工においても、明瞭な格子像を観察することができました。
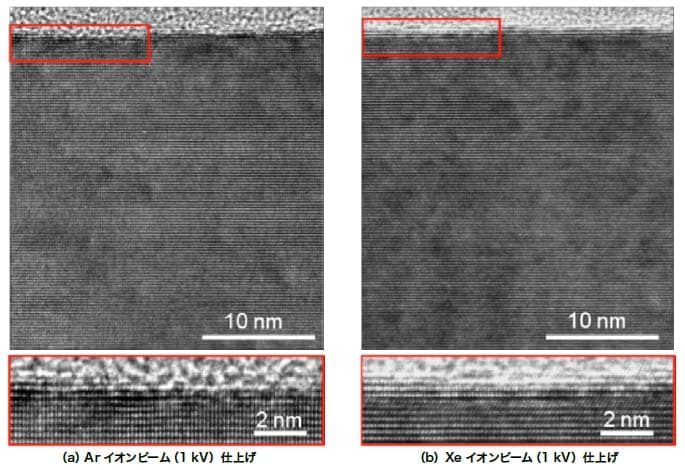
図3 仕上げ加工方法の違いによるTEM観察像比較
試料:GaN 単結晶
観察装置:HF-3300、加速電圧:300 kV
カーテン効果発生抑制のため、日立ハイテクはこれまでACE Technologyと呼ぶ技術開発を進めてまいりました。その一環として、回転軸付マイクロサンプリング®を用いた解析試料の姿勢制御技術などを開発し、その効果を広くご利用いただいてまいりました 3)。しかしながら、近年の最先端高機能デバイスでは、その構造はますます三次元的に複雑化しているため、従来の方法だけでは、カーテン効果の抑制が不十分となってまいりました。そこで、最先端高機能デバイスのような複雑な構造をもつ試料のカーテン効果対策として、新たに「ダブルチルトシステム」を開発いたしましたのでご報告いたします4)。
ダブルチルトシステムは、通常の電動5軸試料ステージ上に搭載する電動2軸の傾斜機構です。このシステムを搭載することにより、合計7軸の電動試料ステージを実現いたします。各軸は独立した制御が可能となっておりますが、オペレータにはこの複雑な構造を意識することなく操作することができる環境をご用意いたしました。また、ダブルチルトシステムは、オペレータの操作により試料室の真空を破ることなく着脱をすることができます。従いまして、通常の電動5軸試料ステージの装置としてもご使用いただくことができます。
このダブルチルトシステム採用により、TEM試料作製において、リアルタイムにSEM観察をしながら、FIBの入射方向および入射角度を任意に変更することができるようになりました。
図4に本システムを使用した3D NANDフラッシュメモリの試料作製結果比較を示します。3D NANDフラッシュメモリでは、加工断面の広範囲にわたって複数材料構造体が広がっています。そのため、従来の方法では図4(a)のようにカーテン効果の影響が顕著となってしまいます。このような試料に対してダブルチルトシステムを用いますと、FIBの入射方向を変えながらエッチング加工を行うことができるようになります。その結果、図4(b)のようにカーテン効果の影響が大幅に抑制された試料を作製することができます。
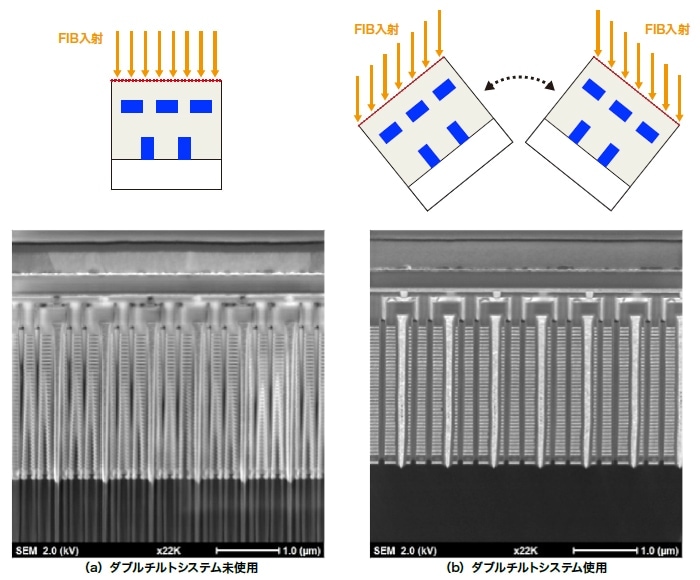
図4 ダブルシルトシステムによるカーテン効果の低減
試料:市販3D NANDフラッシュメモリ
日立ハイテク独自技術であるトリプルビームと、NX2000の新機能である低加速Xeイオンビームシステム、ダブルチルトシステムを紹介いたしました。
従来のトリプルビーム技術に加えて、ダブルチルトシステムなどのACE Technologyを駆使して低加速Xeイオンビーム仕上げ加工を行うことにより、高品位な試料を少ない作業時間で多く作製することができるようになりました。
日立ハイテクは、解析のための試料作製に伴う負担を軽減し、より精度の高い解析環境を構築することにより、お客様の開発、品質管理などに貢献してまいります。
注釈
参考文献
著者紹介
さらに表示