HF5000 Field-emission Transmission Electron Microscope: High Spatial Resolution and Analytical Capabilities for Material Science
稲田 博実
近年、高機能材料・デバイスの研究開発や品質管理などの分野において、ナノメートルから原子サイズにおいて簡単かつ安定した観察や分析性能の向上が求められている。これらの幅広い材料解析の要求に対応するため、加速電圧200 kVの冷陰極電界放出形電子銃を搭載し、空間分解能と、試料傾斜・分析性能を同時追求した電界放出形透過電子顕微鏡「HF5000」形(図1)を開発した。
「サブオングストローム(Å)レベルの高分解能観察・高感度分析を、200 kV TEMプラットフォームで実現する」というコンセプトのもと、78 pmのSTEM空間分解能と、高試料傾斜・大立体角EDXを、シングルポールピースで実現した。
走査透過電子顕微鏡「HD-2700」搭載の日立製球面収差補正器やその自動補正機能、球面収差補正SEM像やシンメトリーDual SDDなどの特長を受け継ぐとともに、透過電子顕微鏡HFシリーズで培ってきた技術を結集・融合した装置である。
ハイエンドユーザーだけでなく、ユーザビリティも向上し、幅広いユーザーに向け、より多様な観察・分析手法を提供する高分解能・高感度分析TEM/STEMである。

図1 日立HF5000形電界放出形透過電子顕微鏡の外観写真
HF5000形透過電子顕微鏡は、従来機種の特長を踏襲しつつ、原子サイズ領域での解析性能と種々様々な試料に対する応用性を高めるため電子銃や電子光学系、装置の機械的構造や電気的安定性について基本ユニットから見直し、開発、刷新した。鏡筒は装置カバーに覆われ、温度変化などの外的変化に対しての影響を小さくする構造とし、従来TEMに搭載されていた蛍光板用ルーペを観察用のCCDカメラに置き換え、明るい部屋やTEMを設置した部屋の外からリモート制御で運用することを可能にした。制御パネルには調整に必要な機能を集約し、STEMとTEMはボタンを押すとそれぞれの条件に応じて検出器・カメラや絞り位置、レンズ条件が設定されるため、ユーザーがどの検出器やカメラ、絞りを挿入するかという意識をすることなく観察することができる。
表1に本製品の主な仕様を示す。加速電圧は200 kVだけでなく、オプションで低加速電圧にも対応し、電子線ダメージに対して弱い試料に対応することも可能である。加速電圧の切り替えは3分程度である。加速電圧200 kVでのTEMの分解能(格子)は0.102 nm、STEMの分解能は78 pmである。STEMにおける最低倍率の視野サイズは1.1 mm × 1.1 mmに相当し、視野探しや観察位置の記録のための広視野観察が可能である。
| 加速電圧 | 60*, 200 kV |
|---|---|
| 電子銃 | 冷陰極電界放出形電子銃 |
| Csコレクタ | STEM(Probe)コレクタ |
| STEM分解能 | 78 pm |
| STEM倍率 |
High Mag ×300 - ×4,000,000
Low Mag ×20 - ×260 |
| TEM分解能 | 0.102 nm(格子) |
| TEM倍率 カメラ長 |
High Mag ×3,000 - ×1,500,000
Low Mag ×100 - ×3,000Diff 0.1 - 1.5 m |
| 試料傾斜角(日立製二軸傾斜ホルダ*) | α ±25°, β ±35° |
| EDX検出器*
Single Dual |
100 mm2シリコンドリフト検出器(SDD) 1.01 sr 2.02 sr |
| 観察像モード TEM STEM |
TEM像, 回折パターン SE, DF, BF-STEM |
*はオプション。分解能や倍率など200 kVの場合。
本製品に搭載できるカメラや検出器の構成を表2にまとめた。TEM像や回折パターン観察や記録のために用いられるカメラはそれぞれの特徴がある。お客様が選択する自由度を高められるよう2台の日立製カメラと、オプション用の35 mmカメラポートを設けており、さらに社外オプション品の高分解能観察用のCCDやCMOSカメラやEELS検出器を鏡筒下部に設けることができる。
一方、STEMの検出器は、試料よりも下方に設けられた明視野STEM(BF-STEM)、円環状暗視野STEM(DF-STEM)検出器と、試料よりも上方、対物レンズの上部に設置したEverhart-Thornleyタイプの二次電子(SE)検出器(E-T型)を備えている。これら三つの信号は静止画、動画ともに同時に記録保存できる。別のSTEM像を観察するために、もう一度観察した視野位置にてスキャンして記録する必要がない。電子線ダメージの影響を受けやすい試料などでは、一回のスキャンで、試料から得られた種々の情報を比較することが可能である。STEM像と表面情報に敏感なSE像を同時に高速で観察できることは、解析に適した視野を探すことにも有用である。図2はカーボン薄膜上に蒸着した直径20 nm程度の金微粒子を同時記録した高分解能STEM像の一例で、DF-STEM像は原子番号に依存するいわゆるZコントラスト像(特に高角度散乱を検出するため一般的にHAADF-STEM:High Angle Annular Dark Fieldと呼ぶが、本編では以下DF-STEMと記す)、BF-STEM像は位相コントラスト、SE像では試料の三次元的な表面構造を反映した情報を得ることができるという特徴がある。図2に示すような原子分解能のSE像をリアルタイムで観察できることは本製品の大きな特徴のひとつである1-8)。
| TEM/STEM | カメラ/検出器 | 主な用途・特長 |
|---|---|---|
| TEM | 35 mmカメラポート用カメラ(*1) | 回折パターン、広視野 |
| 日立製スクリーンCCDカメラ(*2) | 視野探し、回折パターン、調整 | |
| 日立製標準CCDカメラ(*2) | TEM観察、収差補正用 | |
| 高分解能記録用カメラ(*1) | 高分解能TEM像記録、動画記録 | |
| 電子線エネルギー損失分光検出器(*1) | エネルギーフィルター像、 スペクトラムイメージング |
|
| STEM | 二次電子検出器(SE) | 表面情報観察 |
| 円環状暗視野STEM検出器(DF) | 試料原子番号依存Zコントラスト像 | |
| 明視野STEM検出器(BF) | 位相コントラスト像 | |
| EDX検出器 | 元素スペクトル分析、マッピング |

図2 カーボン薄膜上に蒸着された金微粒子をSTEMとSE検出器で同時観察した高分解能STEM像の一例(加速電圧200 kV、下方は観察倍率を上げて記録したもの)
次章にて本製品の技術的なキーポイントについて紹介する。
材料解析に要求される表記の課題をクリアするために、本製品の開発では分解能を向上させ、EDX検出感度を高め、試料傾斜角をできるだけ大きく確保するために、対物レンズポールピースの光学的設計値とEDX検出器位置の最適化、試料ステージ構造の刷新を行った(図3)。またEDX分析におけるXの検出感度を高めるためには、立体角を大きくすること、検出器を複数搭載できること、ウィンドウレスタイプの検出器を用いることで実現できる9-10)。HF5000形ではウィンドウレスタイプで検出器面積が100 mm2のOxford Instruments社製のX-MaxN 100TLE形シリコンドリフト検出器を試料に対して左右対称に2台対向して配置できる。二つの検出器から得られた信号を合成することができ、また試料の傾斜によって試料ホルダ構造の影になって生じる感度劣化を一方の検出器で補うことができることから、試料傾斜角による検出感度低下の影響を小さくできる。したがって、評価する材料に対しての試料方位合わせを優先しても感度低下の影響を小さく抑えられるメリットがある。図4はNiOx薄膜試料から得られたNi-Kα線を試料傾斜角が0°(傾斜なし)と、検出器1側に10°傾斜させた場合の2台のEDX検出器からの強度とそれらの強度和を示したグラフである。試料傾斜0°の場合、両検出器からの強度に差はなく合成したカウントは23000であった。一方、検出器1側に10°傾斜させた場合、検出器1のカウントが上昇するが、対向する検出器2のカウントは低下、これらの合成カウントはおよそ22000カウントであった。2台の検出器合成カウントは試料の傾斜角に依存することなく、おおむね等しく、この検出器配置は試料傾斜角依存性が小さいことを示している。
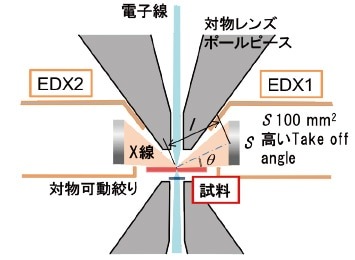
図3 対物レンズ部の模式図

図4 Ni-Kα線の試料傾斜角依存性(左:試料傾斜角0°、右:10°)
(赤:検出器1、青:検出器2、黄:1と2の合成カウントを示す。試料:NiOx薄膜)
EDXにおける高感度分析に必要なもう一つの要件は、試料に照射されるプローブ電流を大きくすることである。図5は本製品における代表的なSTEMの照射条件(照射モード)で記録した種々の試料でのDF-STEM像の比較を行ったものである。電子線は、凸レンズの機能を持つ電子レンズで試料上に収束するが、実際には球面収差によって像面での広がりを生じる。球面収差は電子顕微鏡の分解能阻害の要因の一つである。収差補正器は凹レンズ同様のはたらきを持ち、近軸上の電子ビームを発散する作用を持つ。収差補正器を搭載することで、試料上に電子線をサブオングストローム径に絞り、かつ高角度の電子線を収束することでより大きなプローブ電流を得ることができる。本製品では超高分解能観察条件(UHRモード:Ultra high resolution)から分析用に大きな電流を得られる条件(NormalモードやEDXモード)によって1 nA程度のプローブ電流を与える。これらの照射モードの光学条件は制御ソフトにプリセットされており用途に応じて選択することができる。
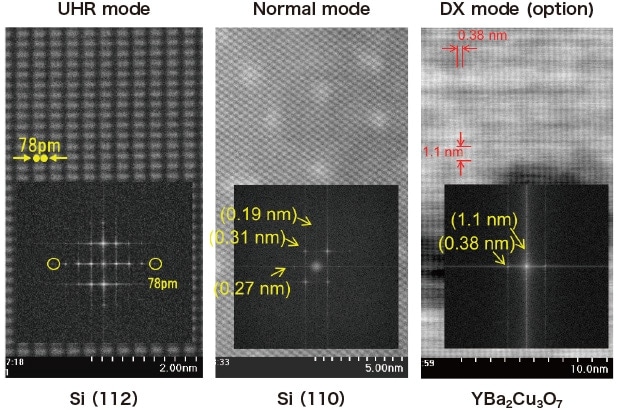
図5 STEMにおける各照射モードと観察できる像の関係
(プローブ電流はUHR<Normal<EDX、プローブ径はUHR<Normal<EDXの関係がある)
原子レベルで観察・分析を安定して行うためには、電子光学的な性能を上げるだけでなく、電子顕微鏡の電子ビームの安定性、電気的、機械的な安定性を高め、外乱などの性能阻害要因を低減することが大きな課題となる。
搭載した冷陰極電界放出形電子銃は現有の電子銃では輝度が高く、干渉性に優れているが、プローブ電流の時間的な変動に起因するチップノイズの低減と長時間のビーム電流安定化が課題であった。これらの要求にこたえるため、長時間安定でプローブ電流変動のより少ない電子ビームを提供するために、電子銃アノード近傍の真空度を改善させる改良を施した11)。また、電気的電子顕微鏡の分解能性能を決める高圧電源、レンズ系、偏向器電源の安定度を向上させ、かつ電子顕微鏡鏡体へ外乱としての影響をできるだけ小さくするため構造変更を行った。機械的には、鏡体カバーによる外乱影響を低減させ、振動源の抑制と機械的伝達特性を計算的に最適化させ設計に反映させた。コンタミネーションを低減するための真空排気系に加え、加速電圧を変えるなど電子光学条件を大きく切り替えた際の安定性も維持し、スループット良く観察・分析に供せられるような技術的な開発と工夫を盛り込んだ。
CsコレクタはSTEMにおいて高い有用性がある一方で、球面収差を補正する際に生じる寄生収差を取り除かないと性能を発揮することができない。この調整はユーザーが画像を見ながら調整することは不可能ではないが、極めて熟練を有する調整である。本製品ではHD-2700で搭載した日立製のCsコレクタと自動収差補正機能を備え、アモルファス試料を用いて収差を補正することが可能である。図6はこのフローの概念を示したもので、収差補正モードを呼び出しウィンドウのStartボタンを押下すると自動的に三次収差までの補正を行い、高分解能観察に供することができるようになる。
TEM、STEMのプローブ条件を決める照射系、倍率や検出角を決める結像系のレンズ条件や絞り、偏向器のデータはあらかじめプリセットされていると同時に、エキスパートなユーザー自身が自由に調節して任意の観察条件を作る、いわゆるフリーレンズコントロールも可能である。任意に作成されたレンズ条件は、PDS(Personal Data Set)機能によって保存、呼び出しでき、後の再評価に役立てることができる。また、オプションのリモートオペレーション機能により、クローンの操作パネルとPCモニタを準備すると遠隔操作ができるため、電顕室とオペレーション室を分離するような要求にも応えられる。この際、社外品の分析装置も遠隔操作が可能である。

図6 日立製Csコレクタの自動調整機能動作前後での画像例(Si単結晶)
ここまで紹介したような、電子光学系の性能向上、安定性向上、Csコレクタをはじめとした機能、操作性の向上によって得られた分析データや画像などアプリケーションデータの一例を紹介したい。
図7は加速電圧200 kVで取得したSrTiO3薄膜単結晶試料のDF-STEM像と原子分解能EDXマッピングの結果である。DF-STEM像からは原子番号が大きいSr(Z = 38)が明るく、Ti(Z = 22)は若干暗い原子カラム位置として同定することができる。一方軽元素であるO(Z = 8)は識別できない。EDXマッピングは2本の検出器で同時取得した。ウィンドウレスタイプの検出器を用いているので、酸素カラムも位置が同定できる。2本のEDX検出器は対向位置に配置されるため、結晶方位合わせでの試料傾斜の影響が小さいことが特徴である。
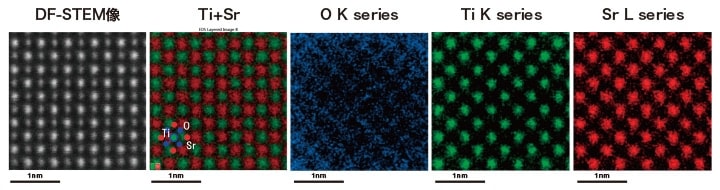
図7 SrTiO3試料のDF-STEM像と原子分解能EDXマッピングの結果
軽元素の原子カラムをSTEM像で観察するための円環状明視野絞り(ABF:Annular Bright Field)をオプションで提供している。BF-STEM検出器の直上に設けたリトラクタブル機構を有したBF-STEM絞りと切り替えて使用すると、軽元素観察に適した検出角度に設定され、いわゆるABF-STEM像を観察できる。
金属触媒粒子の活性状態を評価するために、SE像とSTEM像を対比させることにより、試料の全体構造について材質の観点と材料表面の三次元的構造から重要な情報を得ることができる。図8はCeO2担体上に付着した5 nm程度の粒径を持つAuナノ微粒子を原子分解能で同時取得したDF-STEMとSE像である。DF-STEM像からは原子番号に依存したコントラストから試料の材質的な情報が得られる。二次電子像ではAuが担持体にどのように付着しているか、表面状態を反映しトポグラフィックな情報を得ることができる。
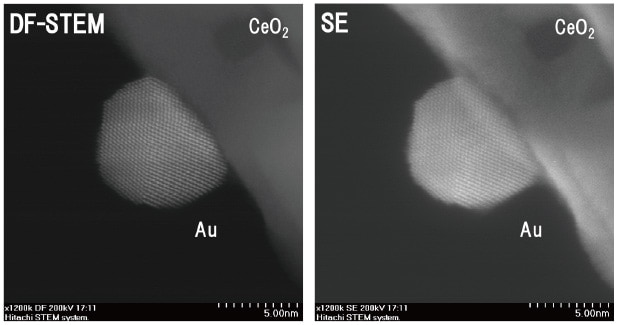
図8 CeO2に担持されたAu微粒子の触媒試料(春田触媒)の高分解能DF-STEM像とSE像
電子線によるダメージを受けやすい試料を観察するためには、照射電子線量(ドーズ)を抑えたり、加速電圧を下げて照射電子線のエネルギーを下げて損傷を抑える。また加速電圧を下げることで、TEMの像コントラストを向上させる効果がある。図9は加速電圧60 kV(オプション)にてシリコンデバイスの基板部近傍を高分解能で観察したTEM像の一例で、コントラスト高い格子分解能像を記録した。
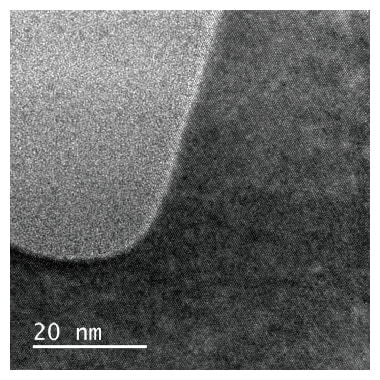
図9 加速電圧60 kVで撮影したシリコンデバイスの高分解能TEM像
以上、日立の電界放出形透過電子顕微鏡HF5000に搭載された技術の概要やSTEMを中心とした応用の一例を紹介した。本製品は分析電子顕微鏡としてさまざまなアプリケーションに適用できるようオプション機能も充実させている。高機能材料やデバイスなどのキャラクタリゼーションに貢献するためのツールとして、ハイエンドユーザーをはじめ幅広いユーザー層に向けてサブオングストロームの空間分解能と高分析性能を、より多様な観察、分析手法と共に提供していく。
参考文献
略語
著者紹介
稲田 博実
(株)日立ハイテク 科学システム営業本部 マーケティング部
さらに表示