長岡 豊*1、平戸 達也*2
走査電子顕微鏡(SEM)は電子線で試料表面を走査することにより発生する信号を検出し、画像化する装置である。電子線照射により発生する信号は、二次電子(SE)、反射電子(BSE)や特性X 線、カソードルミネッセンス(CL)などがあり、これらを検出することにより試料の詳細な表面分析が可能なことから、半導体デバイス解析から材料開発など様々な分野で使用されている。
しかし、非導電性試料を観察する場合、入射電子が試料表面に帯電することによるチャージアップ現象が発生し、異常コントラストやドリフトなどの像障害が発生する。この現象を回避する手法として低真空SEM が開発された。低真空SEM では、入射電子とチャンバー内の残留ガス分子が衝突することにより生成された正の電荷が、サンプル表面に帯電した負の電荷と中和することにより、チャージアップが低減される。低真空領域の観察では、低エネルギーの二次電子を検出することが困難であることから、日立の低真空SEM では、低真空領域で二次電子情報を検出可能な高感度検出器(Ultra Variable-pressure Detector : UVD)を開発した1)。このUVD は、二次電子検出器としての機能に加え、その特徴を生かした応用が開発されている。本稿では、UVD を用いた応用観察事例として、材料のCL 観察やナノ材料、液中試料の走査透過電子顕微鏡(STEM)観
察事例を紹介する。
UVD の概略図を図1(a)に示す。低真空下では、試料へ電子線を照射した際に発生する二次電子を効率よく収集するため、検出器先端にバイアス電圧を印加する。これにより検出器と試料間の間に電界を形成すると、試料表面で発生した二次電子は加速され、低真空環境下での残留ガス分子に衝突し正イオンと電子に電離し、同時に光が発生する。UVD ではその光を検出することで、低真空観察においても二次電子情特有の試料表面の凹凸情報を反映した画像を取得することができる。
図1(b)にSU3800形タングステンSEM(W-SEM)に搭載されたUVD を用いて炭素繊維強化プラスチック(CFRP)破断面を観察した結果を示す。樹脂破面の微細な凹凸や炭素繊維周囲の樹脂の様子を低真空領域でチャージアップを抑えながら観察が可能である。当社では、多様なニーズに応えるため熱電子銃を搭載したW-SEM からショットキー電子銃を搭載した電界放出型SEM(FE-SEM)までUVD を搭載可能とした。
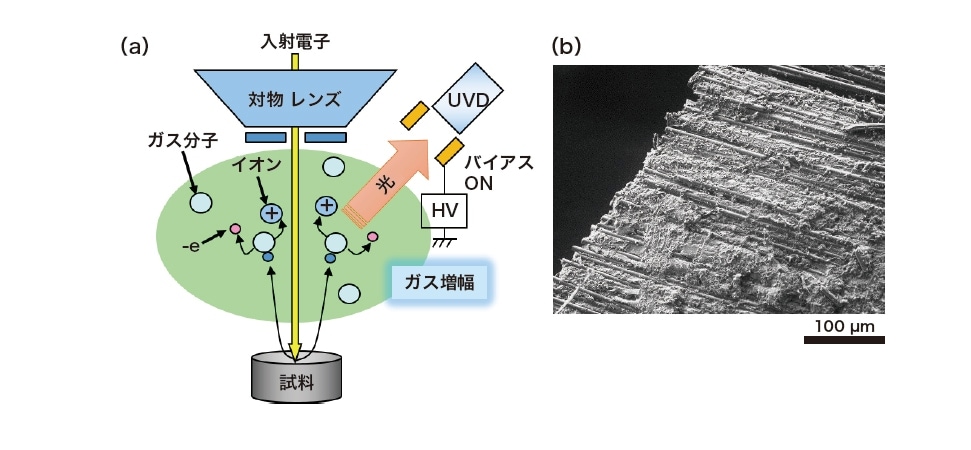
図1 UVDの(a)信号検出の概略図と(b)CFRPのUVD像
試料に電子線を照射し発生したCL は、材料の結晶状態、化学的性質などの情報が得られることから、半導体、セラミックス、鉱物、蛍光材料などの試料の解析に活用されている。UVD はCL の情報も検出可能な高感度検出器である。UVDを用いたCL 像の取得では、検出器先端に印加されているバイアス電圧をOFF にすることで、前項で述べた二次電子情報を有する光を検出不能となり、試料から発生したCL 信号のみを検出する。図2 はパワー半導体で用いられている窒化ガリウム(GaN)の結晶転位(欠陥)をSU5000形FE-SEM で観察した例である。GaN 基板に電子線を照射すると、結晶性の良い箇所からCL が発生し明るいコントラストであるが、貫通転位部分は非発光であることから暗いコントラストを示す。図2の黒点部は転位による非発光箇所に該当しており、GaN の結晶転位が明瞭に観察できている。

図2 窒化ガリウム基板のCL観察結果(加速電圧:5 kV)
(試料提供:名古屋大学 未来材料・システム研究所附属エレクトロニクス集積研究センター・本田善央氏)
次に二酸化チタン(TiO2)ナノ粒子のCL 観察事例について説明する。TiO2ナノ粒子にはルチル型とアナターゼ型があり、アナターゼ型は光触媒として用いられている。これらの違いは結晶構造であるため、SEM 像で識別することは困難である。しかし、アナターゼ型はルチル型に対してCL 発光強度が高く、UVD を用いたCL 観察において、明るく発光する様子を捉えることができる。図3は、SU7000形FE-SEM を用いて、ルチル型とアナターゼ型が混合されたTiO2ナノ粒子を観察した結果を示す。SE 像、BSE 像では違いが識別できないが、CL 像[図3(c)]では一部の粒子が発光していることが確認できる。またBSE 像にCL 像を重ね合わせることにより、発光している粒子を特定することが可能となる。UVD を用いたCL 観察は半導体の結晶欠陥から鉱物中のジルコンの累帯構造観察、アルミナや蛍光体など幅広い応用が可能である。

図3 二酸化チタンナノ粒子の観察結果(加速電圧:3 kV)
[(a)SE像、(b)BSE像、(c)CL像、(d)BSE像とCL像の重ね合わせ]
SEM によるSTEM 観察はSEM の電子光学系をそのまま利用し、TEMグリッドなどにのせられた薄膜試料から透過電子を検出する観察手法である。一般的なSEM では加速電圧が30 kV 以下で用いられるため低加速STEMとも呼ばれ、密度の小さい試料においても電子散乱が多く、高コントラストで観察ができることが知られている2)。ここでは、UVD を用いて明視野STEM 観察が可能な新型のSTEMホルダー3)について紹介する。
図4は新型のSTEMホルダーの概略図を示したものである。このホルダーでは、試料下部にシンチレーターが配置され、薄膜の試料から透過した電子がシンチレーターに衝突した際に発生する光を像信号としてUVD で検出することにより、明視野STEM 像が形成される。このホルダーは、既存の金属板反射型のSTEMホルダーと比較して、透過した電子で発生した光信号のみを効率よく検出できることから、高いS/N 比でSTEM 像の観察が可能となった。
図5にSTEMホルダーを用いてSU5000形FE-SEM で観察した磁性ナノ粒子の観察結果と画像解析ソフトによる粒径測定結果を示す。加速電圧30 kV の低加速電圧であるが、数十nm の小さな粒子を鮮明に観察することができた。さらに、画像解析ソフトImage-Pro(Media Cybernetics 社製)を用いて画像処理を行い、ナノ粒子の直径とその粒度分布を解析した。STEM 像を用いることで、粒子の重なりなどによる誤った解析を軽減することが可能となった。
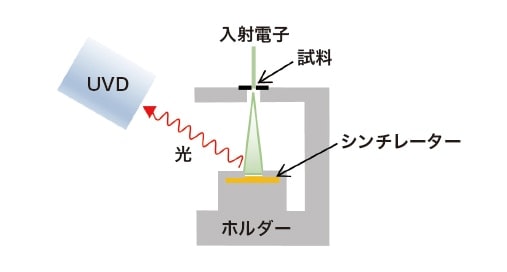
図4 STEMホルダーの概略図
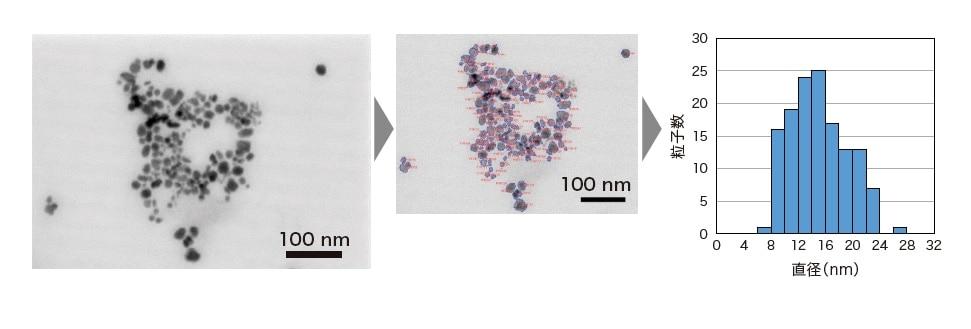
図5 STEMホルダーを用いた磁性ナノ粒子の観察・粒径分析結果(加速電圧:30 kV)
(試料提供:東洋大学 バイオ・ナノエレクトロニクス研究センター・前川透氏)
次に、STEMホルダーと液中観察ホルダーを用いた液中試料観察事例を紹介する。今回は液中観察カプセルとして市販されているK-ki(t Bio MA-Tek社製)を用いた。これは窒化シリコン製の隔膜を有するシリコン製のカプセルであり、液注入孔より毛細管現象を利用して試料を注入後、接着剤で封入することにより、SEMチャンバー内でも液体状態を保持したままの観察を可能とする。観察領域はホルダー中央部にある窒化シリコンの隔膜部分であり、ここに電子線を照射し、透過電子を検出する。
図6に粒径40 nm のスラリーをSU3900形W-SEM でSTEM 観察した結果を示す。図6(a)はコロジオン膜付きメッシュにスラリーを滴下し、乾燥後に観察したものであるが、乾燥の過程でスラリーの粒子が凝集し、分散状態を確認することが困難である。一方、図6(b)は、K-kit を用いて、スラリーを注入後封入したものを観察した結果で、良く分散したスラリーの粒子を黒い点のコントラストで確認することができた。このように、SEM を用いたSTEM 観察でも、液中の粒子の分散状況を明瞭に観察することが可能となる。
![図6 スラリーのSTEM観察結果(加速電圧:30 kV)[(a)メッシュに滴下、(b)K-kit使用]](/image/jp/sinews/technology/6220311/index_06.jpg)
図6 スラリーのSTEM観察結果(加速電圧:30 kV)[(a)メッシュに滴下、(b)K-kit使用]
本稿では、W-SEM、FE-SEM に搭載可能なUVD を用いた観察事例を紹介した。CL 観察では、GaN 基板の貫通転位やTiO2ナノ粒子のアナターゼ型が識別できることを示した。STEM 観察では、新規開発したSTEMホルダーを用いて磁性ナノ粒子の観察と粒径分布解析やK-kitとSTEMホルダーを組み合わせた液中観察が可能であることを示した。UVD は低真空下における二次電子検出器としての機能だけではなく、従来専用検出器が必要であったCL 像やSTEM 像も取得できる多機能な検出器である。今後、UVD を搭載したSEM が、半導体デバイスやナノ材料などの観察および分析に貢献することを期待する。
参考文献
1)西村雅子ほか,SU3500 用新型低真空検出器(UVD)の特徴と応用,S. I. News,56,4761-4765(2013).
2)日本電子顕微鏡学会関東支部編,新・走査電子顕微鏡,137-138,共立出版株式会社(2000)
3)K. Hosoya et al., Microsc. Microanal.,25(Suppl 2),552-553(2019).
出典
月刊誌「工業材料」2020 年12 月号掲載
著者紹介
*1長岡 豊
(株)日立ハイテク ナノテクノロジーソリューション事業統括本部 評価解析システム製品本部 解析ソリューション開発部
*2平戸 達也
(株)日立ハイテク ナノテクノロジーソリューション事業統括本部 評価解析システム製品本部 制御システム設計部
さらに表示