相蘇 亨
近年、走査電子顕微鏡(SEM)は低加速電圧による試料最表面の観察や、複数検出器によるさまざまな情報の同時取得が可能となった。一方で、加速電圧や検出器によって像質が変わり、入射電子の侵入深さや各検出器の検出エネルギー帯を考慮して像解釈することがある。走査型プローブ顕微鏡(SPM)は形状計測モードだけでなく、電磁気特性や機械特性などの物性測定モードも多様化しており、各物性データの解釈が高度化している。白色干渉顕微鏡(CSI)は、mmオーダーの広域において非接触かつ高スループットでサブnmオーダーの高さ計測が可能なことから、工場の検査用途にも広く用いられている。一方で、空間分解能が光の波長に制限される。このように、各装置単独で顧客の課題解決が困難な場合、SEM、SPM、CSI の3つを複合的に用い、同一箇所の観察により、それぞれの長所を活かしながら、お互いのデータを補完して解釈を深めるコリレーション解析が有効である。当社では、2016年9月からSEM とSPM の同一箇所測定技術をSÆMic.(セーミック)と称したソリューションを提供してきた。現在はSÆMic.としてCSIも取り込んだ活動を行っている。本稿では、実例を挙げながらSEM-SPM-CSI によるコリレーション解析事例を紹介する。
(1)走査電子顕微鏡(SEM)
SEM は、真空中で磁場や静電場によって電子ビームを絞り、試料表面に照射し走査することで発生する2次電子や反射電子を検出する顕微鏡である。また、同時に発生する特性X 線のスペクトルから元素分析を行うEDX(エネルギー分散型X 線分光)や、電子線回折パターンから結晶方位や相分布を計測するEBSD(後方散乱電子回折)などと組み合わせて用いられることも多い。
図1に示すように、ほとんどのSEM は複数の検出器を有し、2次電子起因の最表面の凹凸情報や反射電子起因の組成情報などを同時に取得し、像解釈することが一般的である。近年は観察や分析が主目的であったSEM でも、対物レンズ直下に配置した分割型反射電子検出器を用いた3D 計測も可能となり(図2)、SPM やCSI との相関解析の重要性が高まっている。
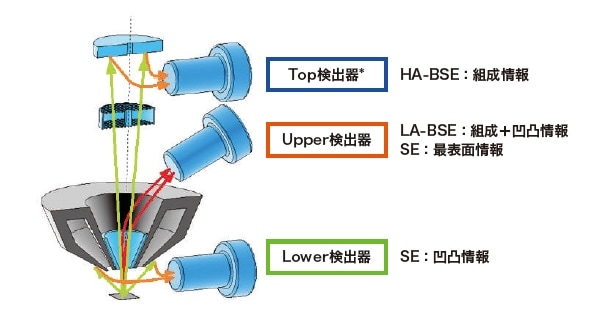
図1 FE-SEM(Regulus8200シリーズ)の検出器レイアウト
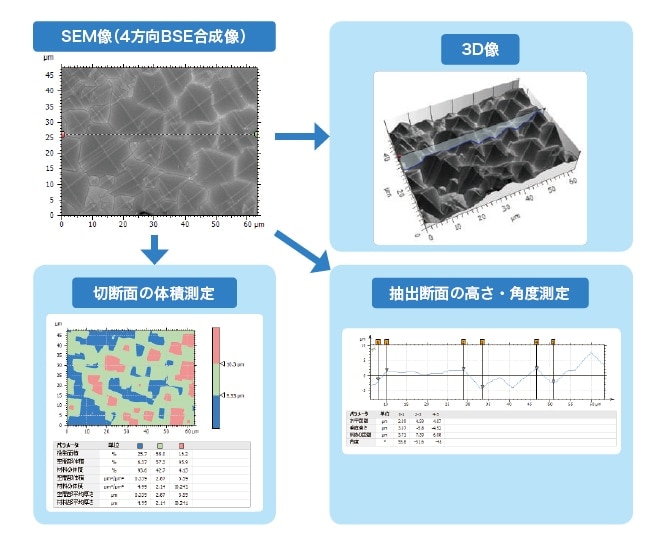
図2 卓上SEMによる太陽電池表面の3D計測
(2)走査型プローブ顕微鏡(SPM)
SPM は、先端が数nm 程度に尖った探針を有するカンチレバーを用い、ピエゾスキャナを用いて試料表面を走査し、サブnm から数100 μm の領域における試料表面の形状計測が可能な顕微鏡である。図3に示すように、カンチレバー背面に照射したレーザーの反射光をフォトディテクタで捉え、探針−試料表面の相互作用によって生じる微小な力を検出し、表面形状を捉える。また、探針−試料間に働く摩擦力や粘弾性、磁気力や静電気力の検出や、探針をナノプローバーとして用いた導電性や誘電特性の測定など、さまざまな物性計測にも用いられている。
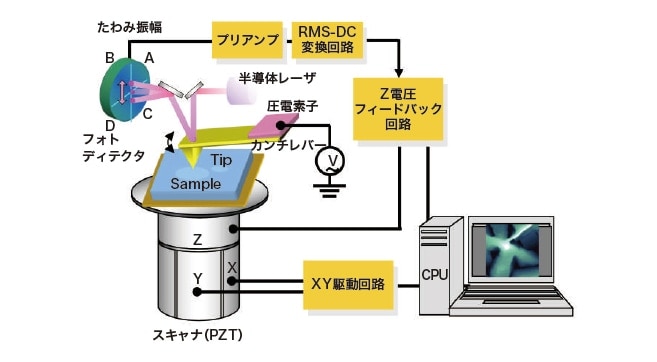
図3 SPMの原理図
(3)白色干渉顕微鏡(CSI)
CSI は、図4に示すように、白色光源から照射された光をビームスプリッターで2つに分け、一方を参照面、もう一方を試料表面に照射し、試料表面の凹凸によって生じる光路差で得られる干渉縞の情報を高さ情報に変換して3D 形状を計測する顕微鏡である。また図5のように、透明多層構造の各界面から得られる反射光を用い、断面を作製する手間をかけずに、非破壊で断面の情報を得ることも可能である。
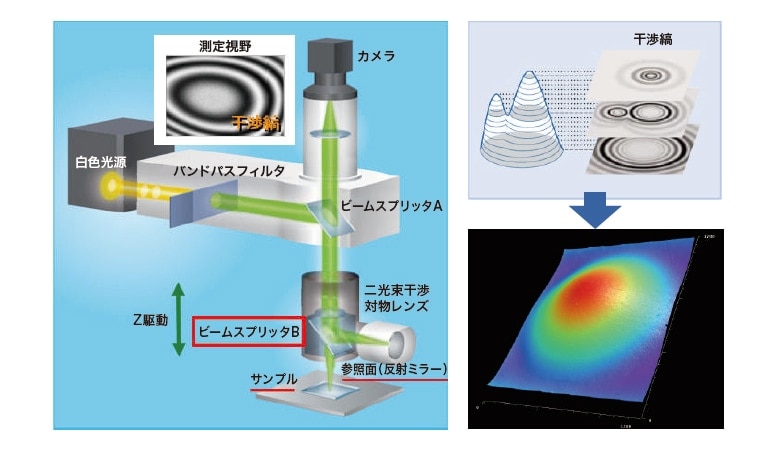
図4 CSIの原理図

図5 層断面解析の概略図と多層バリアフィルム測定例
コリレーション解析には、各装置で同一箇所の観察が求められる。当社では、SEM、SPM、CSI 共に座標情報の取得が可能な高精度電動ステージ搭載モデルを有しているため、容易に同一箇所を観察できる(図6)。特に、高分解能が求められるSEM-SPM 間のコリレーション解析では、共有可能なアライメントマーク付き専用ホルダに試料を固定し、ソフトウェアによるステージアライメントで高精度座標リンケージを実現している。この方式の優位性は、SEMチャンバー内にSPMを配置する複合機方式と比べて、各装置の性能や機能が制限されない点にある。
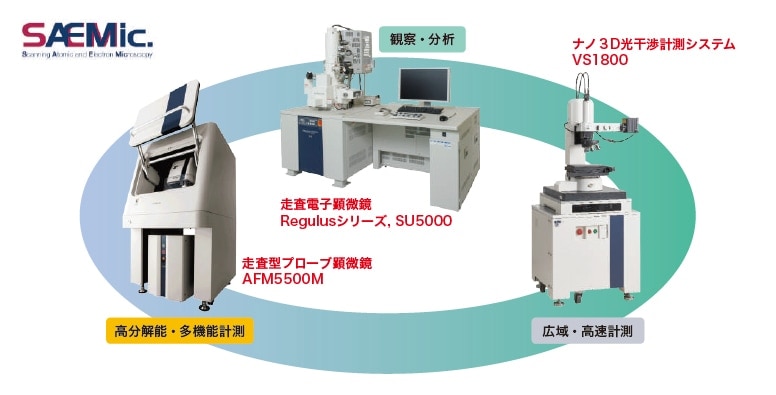
図6 SEM-SPM-CSIリンケージの概略図
Liイオン電池(LIB)などに用いられるセパレータは電子線照射によってダメージを受けやすく、SEM 観察の際に加速電圧や照射電流の最適化が必要である。SPM では試料へのダメージなく形状計測が可能であるが、視野範囲や観察のスループットが限られるため、SEM による広域ダメージレス観察の要求が高い。
そこで、SPM 形状像をリファレンスとして、SEM の観察条件検討を行った例を図7に示す1)。SEM 観察の前処理には、帯電を抑制し細部まで明瞭に観察するため、帯電軽減に効果のあるイオン液体IL1000を塗布した2)。0.5 kV や1 kV の加速電圧でのSEM 像ではSPM 像に比べて大きな穴が開いており、電子線によってセパレータがダメージを受けていると考えられる。加速電圧を0.06 kV まで下げると、SPM 像と同等の形状が得られ、電子線ダメージのないSEM 観察条件が明らかとなった。本事例は同一箇所観察ではないが、SPM がSEM のクロスチェックをするという点で、相関解析の典型的な事例といえる。
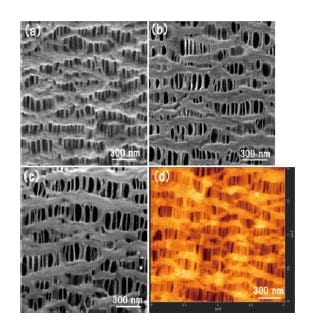
図7 IL1000を塗布したセパレータのSEM像(×50k) (a)-(c) と無処理のセパレータのAFM像(d)
(a) 0.06 kV、(b) 0.5 kV、(c) 1.0 kV
LIB の高性能化、長寿命化には充放電サイクル試験による劣化要因の分析などが欠かせない。ここではSiOx を混合した黒鉛系の負極について、SPM 電気特性評価モードの1つである走査型拡がり抵抗顕微鏡(SSRM)とSEM-EDX による、サイクル試験前および、常温サイクル後、高温サイクル後の構造、元素分布、電気抵抗分布の相関分析を行った結果を図8に示す3)。イオンミリング-SEM-SPM 間で共用可能な雰囲気遮断ミリングホルダにより、試料作製から装置間の搬送を大気非暴露の状態で実施した。充放電サイクル前のSSRM 像は、黒鉛系活物質の境界付近が比較的低抵抗であるのに対し、常温サイクル後および高温サイクル後SSRM 像では、活物質の境界が明るく観察されており、この領域が高抵抗化していることがわかる。サイクル試験後に黒鉛系活物質と、特にSi 系活物質の境界に濃化しているフッ素の存在から、この領域はSEI(Solid Electrolyte Interface)と考えられ、その領域で電気抵抗が大きくなったものと推測される。SSRM は104 ~ 10Ωの広い範囲の抵抗分布を一度のスキャンで確認できる特長を有する。このように、LIB の内部抵抗増大の一因を、SEM-EDX とSSRM とのコリレーション解析によって調べることができる。
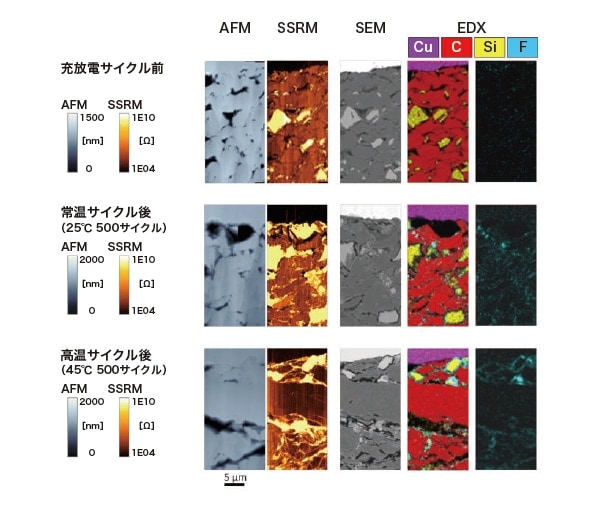
図8 充放電サイクル前後のリチウムイオン電池負極のミリング断面SSRM/SEM/EDX測定結果
試料の断面構造解析には、機械研磨やイオンミリングなどを用いて断面出しした試料をSEM 観察する手法が広く用いられている。広い範囲にわたって断面構造を高分解能で観察できる反面、断面作製に数時間を要する場合も多い。例として、飲料缶の溶接部断面のコーティング厚を、CSI の層断面解析機能と断面SEM 観察でコリレーション解析した事例を図9に示す4)。SEM 像では明瞭な断面構造が得られているが、断面作製には2時間程度を要した。一方、CSI では非破壊で任意の箇所の断面構造が得られ、約20秒で一視野を観察できる。CSI で得られたコーティング厚は断面SEM の結果と同程度であり、測定スループットを重視するのであれば、CSI の方が適していると言える。
次に透明積層フィルムの異物解析事例を図10に示す5)。CSI 層断面解析では表面から109 μm の深さに異物があることがわかるが、その異物の構成元素まではわからない。そこでSEM に取り付けたμXRF(微小部蛍光X 線分析)から、50 kVのX 線を試料の同一箇所に照射し、異物の構成元素をEDX 検出器で特定した。このように、断面構造解析のスクリーニングにCSI を用い、詳細な分析にはSEM を用いるようなコリレーション解析も、測定時間を効率化する上で有用である。
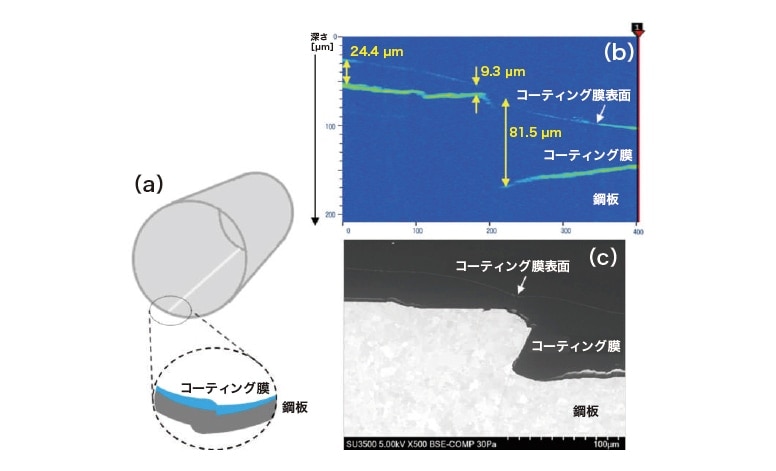
図9 飲料缶の溶接部の概略図(a)とCSI層断面解析像(b)および断面SEM像(5 kV、×500、イオンミリング処理)(c)

図10 積層フィルムの光学顕微鏡像(a)とCSI層断面解析像(b)およびμXRF-SEM-EDX像(c) (d)
(c) Crマップ、 (d) Feマップ
SPM で得られた最表面の物性情報について、深さ方向の影響範囲を可視化したいとの要望がある。1% NaCl 水溶液で30分間腐食させたアルミ合金について、表面電位分布が可能なSPM の電気特性評価モードの1つであるKPFM(ケルビンプローブフォース顕微鏡)とFIB(収束イオンビーム)-SEM による3D-SEM/EDX 像とのコリレーション解析事例を図11に示す6)。
本測定では、座標リンケージ機能を用いて、KPFM 測定箇所と同一箇所において、加工と観察を繰り返すCut&See 機能により3D-SEM/EDX 像を取得し、KPFM 像と重ね合わせを行った。SEM-EDX 像から、Al 合金表面にFe 系介在物が存在しており、周囲が酸化していることがわかる。KPFM 像から、周囲に比べてFe 介在物が最も電位が低く、酸化している領域も電位が低い。この電位差が腐食を進行させる要因の1つと考えられ、KPFM は腐食の進みやすい部位を特定するのに役立つ。一方で、試料内部への腐食の進行はKPFM だけではわからない。そこで図12に示すように、FIB-SEM を用いて試料内部の元素分布観察を試みたところ、腐食を示す酸素はFe 系介在物に沿って内部まで侵食し始めている様子[図12(b)↑1]がわかった。一方、表面に近い内部に存在するFe 系介在物[図12(b)←2]が、表面電位には影響しておらず、腐食にもまだ関与していないと考えられる。このように、AFM で捉える“ 表面物性” の起源を、FIB-SEM で捉える内部の構造からも検証していくことができる。
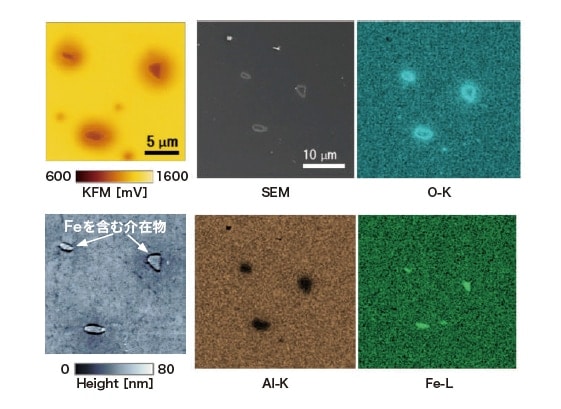
図11 腐食させたAl合金のKFM/SEM/EDX測定結果
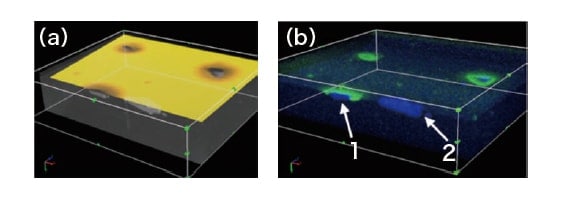
図12 腐食させたAl合金のKFM/3D-SEM像の重ね合わせ(a) 3D-EDX像(青: Fe-L, 緑: O-K)(b)
(1) 最表面に露出しているFe系介在物、 (2) 表面近傍に埋まっているFe系介在物
本稿で紹介した事例から、複数の装置を用いて同一試料の同一箇所を解析することにより、データの信頼性確認やデータ解釈の深化、スクリーニングとしての利用など、さまざまなメリットが得られることがわかった。
今後は、課題解決の手段としてコリレーション解析を積極的に運用しながら、リンケージ手順の簡略化やリンケージ精度の向上を目指し、誰もが簡単にコリレーション解析できるシステムを構築していきたい。
参考文献
出典
月刊誌「工業材料」2020 年5 月号掲載
著者紹介
相蘇 亨
(株)日立ハイテク 解析ソリューション開発部
さらに表示