計測装置・検査装置 / サポート情報
計測装置・検査装置
計測装置・検査装置のラインアップをご紹介いたします。
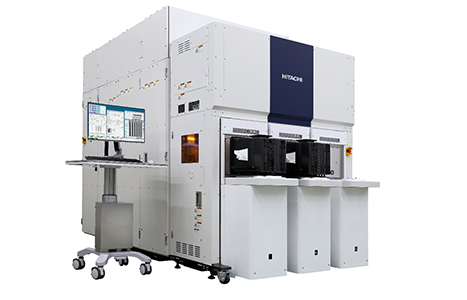
高精度電子線計測システム GT2000
High-NA EUV世代のデバイス開発と量産におけるニーズに応えたCD-SEM

高分解能FEB測長装置 CS4800
CS4800は 4、6、8インチのウェーハサイズに対応した測長SEMです。
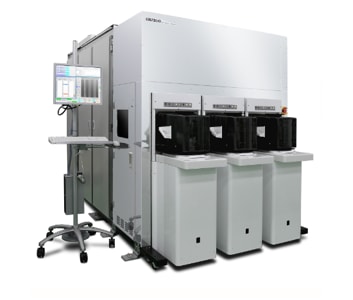
高分解能FEB測長装置 CG7300
EUV世代デバイスの量産に対応した高信頼性CD-SEM

高分解能FEB測長装置 CG6300
CG6300では、電子光学系を一新することにより分解能を高め、測長再現性および画質の向上を図りました。

高加速CD-SEM装置 CV7300
高加速電圧60kVのインラインCD計測SEM装置

ディフェクトレビューSEM CR7300 Series
高速ADR、高精度ADCにより歩留まり改善に貢献するインライン対応レビューSEM

ウェーハ表面検査装置 LSシリーズ
ウェーハ表面検査装置LSシリーズは,パターンなし(鏡面)シリコンウェーハ上に存在する微小異物や欠陥を検査する装置です。

暗視野式ウェーハ欠陥検査装置 DI4600
高感度検出と高スループット検査による高速製品モニタリングを実現。歩留まり向上と生産コスト削減に貢献する次世代 対応暗視野式ウェーハ欠陥検査装置です。

欠陥形状評価SEM CT1000
欠陥及びパターン形状の3D観察でG&Cデバイスの開発TAT短縮と品質向上に貢献
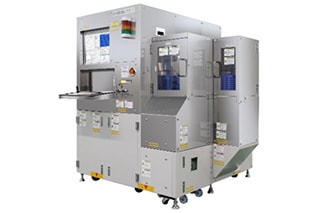
日立暗視野式ウェーハ欠陥検査装置 DI2800
G&Cデバイスの製造工程中のパターンサンプル上に発生する欠陥検出と管理に貢献

オフラインレシピ作成システム
RecipeDirector
設計データの活用でウェーハやCD-SEMを使用せずにレシピを作成、HSS(Hitachi Spread Sheet)を用いた自動生成機能によりレシピ作成時間を大幅に短縮

レシピのリモート管理PC
Data Station
データステーションは、レシピをリモートで一括管理するためのPC。データステーション上でレシピ編集を行うことでCD-SEMの稼働率を向上
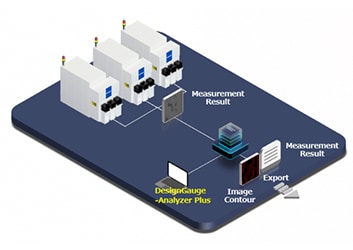
オフライン多機能測長システム
DesignGauge-Analyzer Plus
OPCモデリングやプロセス評価など、大量データの測長に対応、計測作業の効率化を支援し、デバイス開発のリードタイム短縮に貢献
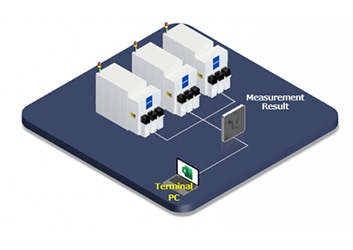
オフライン測長・解析 PC
Terminal-PC
CD-SEMと同様の測長環境をPC上に構築して再計測を実行、測長結果はMicrosoft Excelと連携し、スムーズなデータ解析を実現
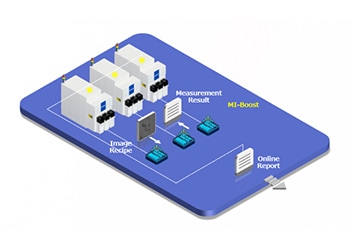
オンライン高速・多項目計測システム
MI-Boost
CD-SEMとの並列処理により、多項目・多点計測とリアルタイム通知を両立、デバイスパターンの変動を的確に捉え、品質管理の高度化を支援

メンテナンスサービス
メンテナンスサービスを紹介します。
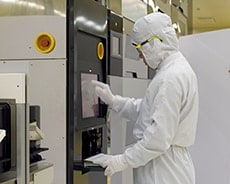
ユーザートレーニング
ユーザートレーニングを紹介します。
