マイクロレンズの高精度立体計測
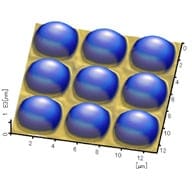
| ジャンル | 半導体・エレクトロニクス, 無機材料, 有機・高分子 |
|---|---|
| モード | SIS |
| 測定領域 | 5-15µm |
| ステーション | AFM5000 |
| 装置 | AFM5400L |
解説

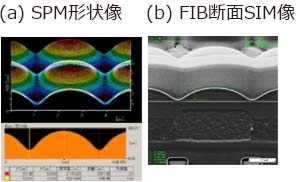
タイトル画像は、市販のデジタルカメラから取り出した200万画素程度のCCDセンサ上マイクロレンズを、AFM5400Lを使用し、アキュレートスキャナとSISモードにより測定したものです。マイクロレンズ形状を高精度に計測することが出来ました。
測定に使用したアキュレートスキャナは、素子の感度ムラによるクロストークを解消し、スキャナの垂直方向の動きを高精度化したものです(1)。また、SISモードは、DFMを進化させた最新の測定モードで、凹凸の大きな試料、吸着の大きな試料、柔らかい試料など、従来のSPMでは探針の制御が不安定になり測定に熟練を要したものが、容易かつ安定して行なえます(2)(3)。 アキュレートスキャナとSISモードを組み合わせることで、マイクロレンズや、半導体パターンのような凹凸数100nm~数µm程度の比較的大きな形状を正確に計測することが可能になりました。
Fig.1は、マイクロレンズ形状の、アキュレートスキャナと従来スキャナでの測定結果比較です。アキュレートスキャナでは、球面形状がXY方向にゆがみ無く測定できていることが分かります。中心軸からのずれは1%以内に計測されました。
Fig.2は、マイクロレンズのSPM断面解析結果と、FIB断面加工面のSIM像です。FIB断面試料は解析角度ごとに試料作製する必要がありますが、SPMでは一回の測定で得られたデータから、任意の角度での断面解析やレンズピッチ、曲率、表面形状の微細な凹凸といった各種パラメータを高精度に評価することが可能で、製品開発、不良解析の時間短縮に有効です。
2007年8月幕張メッセで開催された Tokyo Conference 2007 において、このアプリケーションに関する日立ハイテクサイエンスの発表 “原子間力顕微鏡(AFM)による高精度立体形状計測” が 優秀講演賞 に選ばれました。
引用等:
-
野坂尚克、”ハイアスペクト形状評価と計測制度の追求、新製品L-traceⅡの紹介”、
日立ハイテクサイエンス、走査型プローブ顕微鏡セミナーテキスト、2007、pp.47-62. -
M. Yasutake, K. Watanabe, S. Wakiyama and T. Yamaoka: ” Critical Dimension
Measurement Using New Scanning Mode and Aligned Carbon Nanotube SPM Tip”, JJAP, 45, No.3B (2006). -
T.Nishimura, M.Yasutake, K.Watanabe, S.Wakiyama; "Critical dimension measurement
using new scanning mode and aligned Carbon nanotube SPM Tip",The 16th International Microscopy Congress(IMC16), Abstracts(2006).
関連文献:
関連情報
走査型プローブ顕微鏡(SPM/AFM)に関する測定手法、測定例の一部を、会員制情報検索サイト「S.I. navi」でご提供しています。
リストの一部はこちらからご覧いただけます。

「S.I.navi」は、日立ハイテク取扱分析装置に関する会員制サイトです。
お客さまの知りたいこと、日々の業務に役立つ情報を「S.I.navi」がサポートします。

日立電子顕微鏡をご使用されているお客さまは、「S.I.navi」上で製品情報をご登録いただくと、日立電子顕微鏡ユーザー限定サイト「Semevolution(セメボリューション)」にて、さらに多くの関連情報をご覧いただけます。


