Siウェハ表面処理前後での表面観察と粗さ評価

| ジャンル | 半導体・エレクトロニクス, 無機材料 |
|---|---|
| モード | DFM |
| 測定領域 | 1µm |
| ステーション | NanoNaviⅡ |
| 装置 | Nanocute |
解説

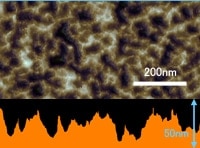

Fig.1 Siウェハ表面(化学エッチング処理後)



Fig.2 Siウェハ表面(化学エッチング処理前)
SPMは非常に鋭利な先端の探針を使用しているためナノレベルの凹凸での高精度な表面粗さ評価が可能です。
ここでは、化学エッチング処理前後におけるSiウェハ表面凹凸観察と粗さ評価の結果についてご紹介します。
Fig.1,2は、化学エッチング処理前後でのSiウエハ表面のDFM形状像(a)、断面プロファイル(b)、JISB0601に準拠した粗さパラメータ(c)です。化学エッチング処理前の表面粗さは0.092nmであるのに対し、処理前の表面粗さは6.0nmと桁違いに大きくなっています。
近年、ナノスケールにおける表面粗さのJIS規格が制定されましたが、この事例のように、ナノレベルの平滑面を品質管理するのに最適です。日立ハイテクサイエンスでは、いち早くこの手法をシステムに組み込んでいます。
関連情報
走査型プローブ顕微鏡(SPM/AFM)に関する測定手法、測定例の一部を、会員制情報検索サイト「S.I. navi」でご提供しています。
リストの一部はこちらからご覧いただけます。

「S.I.navi」は、日立ハイテク取扱分析装置に関する会員制サイトです。
お客さまの知りたいこと、日々の業務に役立つ情報を「S.I.navi」がサポートします。

日立電子顕微鏡をご使用されているお客さまは、「S.I.navi」上で製品情報をご登録いただくと、日立電子顕微鏡ユーザー限定サイト「Semevolution(セメボリューション)」にて、さらに多くの関連情報をご覧いただけます。


