微小ハイアスペクト形状の評価

| ジャンル | 半導体・エレクトロニクス |
| モード | SIS |
| 測定領域 | 1µm |
| ステーション | NanoNavi |
| 装置 | L-trace |
解説

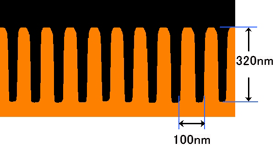
近年、半導体産業を中心とした電子デバイスの微細化、高集積化にともない、 SPMに求められる測定の守備範囲は“面”から“立体”へと要求が高まってきています。半導体デバイスのビアホール、トレンチなどの切り立った微細形状や、ナノインプリント等のハイアスペクト形状については、例えばこれまで収束イオンビーム(FIB)で加工した断面をSEM観察するなど破壊的な検査も行われてきました。SPMは高精度かつ非破壊で、このようなハイアスペクト形状を観察するツールとして使用されています。
fig.1はNTT-ATN製シリコンパターンサンプル(高さ320nm、ライン&スペース50nm)のハイアスペクト形状(7:1)測定例です。SISモードを組み合わせることにより側面からの吸着影響は著しく低減され、従来測定が困難であったナノスケールのハイアスペクト形状測定が容易に行えるようになりました。
SISモードは、DFMを進化させた最新の測定モードで、凹凸の大きな試料、吸着の大きな試料、柔らかい試料など、従来のSPMでは探針の制御が不安定になり測定に熟練を要したものが、容易かつ安定して行なえます(1)(2)。
引用等:
- M. Yasutake, K. Watanabe, S. Wakiyama and T. Yamaoka: ” Critical Dimension Measurement Using New Scanning Mode and Aligned Carbon Nanotube SPM Tip”, JJAP, 45, No.3B (2006).
- T.Nishimura, M.Yasutake, K.Watanabe, S.Wakiyama; "Critical dimension measurement using new scanning mode and aligned Carbon nanotube SPM Tip",The 16th International Microscopy Congress(IMC16), Abstracts(2006).
関連情報
走査型プローブ顕微鏡(SPM/AFM)に関する測定手法、測定例の一部を、会員制情報検索サイト「S.I. navi」でご提供しています。
リストの一部はこちらからご覧いただけます。

「S.I.navi」は、日立ハイテク取扱分析装置に関する会員制サイトです。
お客さまの知りたいこと、日々の業務に役立つ情報を「S.I.navi」がサポートします。

日立電子顕微鏡をご使用されているお客さまは、「S.I.navi」上で製品情報をご登録いただくと、日立電子顕微鏡ユーザー限定サイト「Semevolution(セメボリューション)」にて、さらに多くの関連情報をご覧いただけます。


