"Ethos NX5000" High-Performance FIB-SEM
鈴木 秀和
(株)日立ハイテク(以下、日立ハイテク)のコア技術である世界トップレベルの高輝度冷陰極電界放出型電子銃と新開発の電磁界重畳型複合対物レンズ(以下、Dual Modeレンズ)を搭載した、高性能FIB(*1)-SEM(*2)複合装置「Ethos NX5000」を開発しました。
FIB-SEM複合装置は、試料の加工を行うFIB鏡筒と、高倍率で観察を行うSEM鏡筒を同一試料室に配置し、試料表面や試料内部の特定箇所の微細構造や組成を高倍率で解析することができます。半導体をはじめ、ナノテク、材料、医学・生物など幅広い分野において、試料の断面観察・分析やTEM(*3)用薄膜試料作製に活用されています。特に近年、微細化が進む最先端デバイスや高機能ナノ材料の研究開発現場においては、その微細構造・組成解析に不可欠となる高品位なTEM用薄膜試料を作製する装置として重要な役割を担っています。
「Ethos NX5000」の開発コンセプトは「高分解能観察」、「究極のTEM試料作製」、「多用途」です。そこで、低加速電圧での高分解能SEM観察を可能とし、ACE(*4)技術(FIBによる断面加工の際に発生する加工スジ(*5)を抑制する技術)を組み合わせることで、加工ダメージが小さく、加工断面が均一で高品位なTEM用薄膜試料作製を実現しています。また新開発の大容量試料室には、EDS(*6)やEBSD(*7)などの各種解析オプション用ポートを設置するとともに、直径150 mmサイズの試料の全面で加工・観察ができる新開発の大型試料ステージを搭載しています。これにより、最先端半導体デバイスだけでなく生物組織から鉄鋼などの磁性材料まで、さまざまな試料の複合解析に対応しています。
本稿では高性能FIB-SEM複合装置「Ethos NX5000」の特長について説明します。

図1 高性能FIB-SEM複合装置「Ethos NX5000」
| SEM光学系 | |
|---|---|
| 電子源 | 冷陰極電界放出形 |
| 加速電圧 | 0.1~30 kV |
| 分解能 | 1.5 nm@1 kV, 0.7 nm@15 kV(HRモード) |
| FIB光学系 | |
| 加速電圧 | 0.5~30 kV |
| 最大ビーム電流 | 100 nA |
| 分解能 | 4.0 nm@30 kV |
| ステージ | |
| 駆動範囲 | X:0~155 mm, Y:0~155 mm, Z:0~16.5 mm, T:-10~59°, R:360° * 試料ホルダにより駆動範囲に制約がある場合があります。 |
| 試料サイズ | 最大150 mm径 |
新型電子ビーム光学系の開発コンセプトは高分解能と観察拡張性の両立です。高分解能化を実現するために、高輝度冷陰極電界放出型電子銃と新開発のDual Modeレンズを実装しました。このDual Modeレンズはシングルポール(HR)/アウトレンズ(FF)の二つの機能を有しています。HRモードでは試料の高分解能観察ができます。FFモードではFIBによる試料加工の様子をリアルタイムで観察することができます。
またSEM観察の拡張性を実現するために、SEM鏡筒内部にSE(U)/BSE(U)/BSE(L)の3つの検出器を実装しました。更に試料室にもSE(L)検出器が実装されており、同時に4つの検出器の画像を表示することができます。これにより、二次電子による形状コントラストや反射電子による組成コントラストの同時観察が可能になりました。
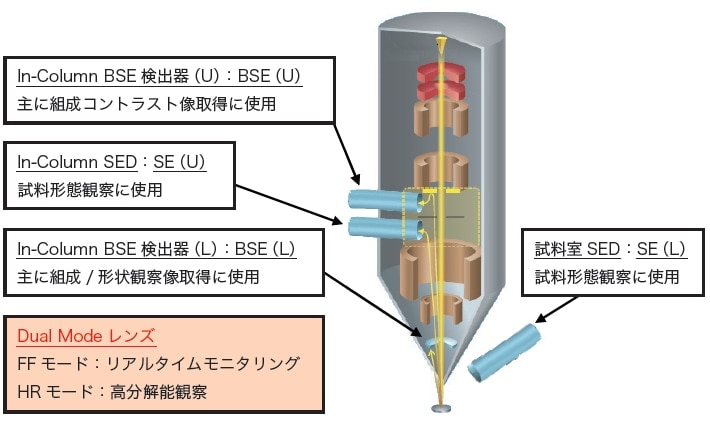
図2 新型電子ビーム光学系の模式図
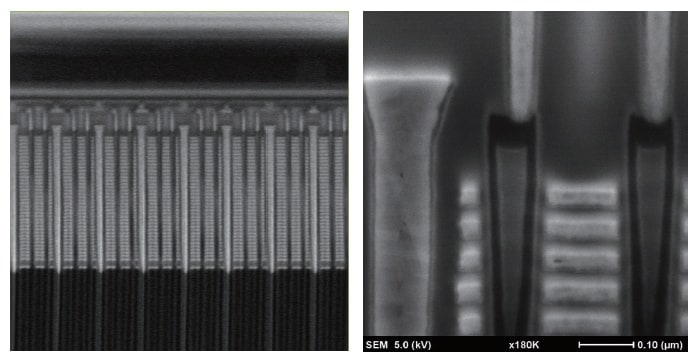
図3 (左)FFモードによるリアルタイム観察像(Acc:2 kV、視野サイズ:6 µm)
(右)HRモードによる高分解能観察像(Acc:5 kV、視野サイズ:0.6 µm)
試料:市販品の3D-NANDフラッシュメモリ
「Ethos NX5000」には、高品位なTEM試料作製を支援する機能として「トリプルビーム」と「ACE技術」を搭載しています。本機能は従来機種にも搭載しており、幅広い分野でのTEM試料作製現場で高い評価をいただいています。
日立ハイテク独自の装置構成であるトリプルビームは、FIB加工によって発生したTEM試料上のダメージ層を低加速アルゴン・キセノンビーム(ArIB、XeIB)によるエッチング加工で除去する技術です。トリプルビームでは、FIB、EB、ArIB(XeIB)が試料上の一点で交差する構造になっており1)、FIB、ArIB(XeIB)加工の結果をその場でSEM観察することができます。これによってTEM試料のダメージ除去の作業効率を大幅に向上させることができます。
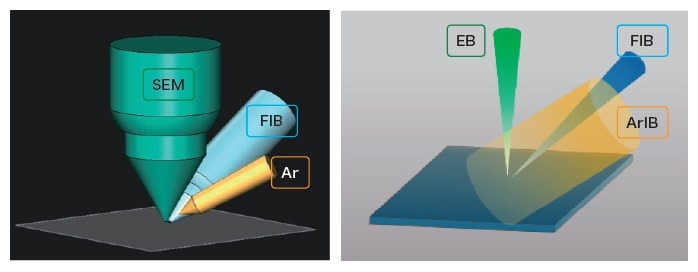
図4 トリプルビーム概要図
ACE技術とは、TEM試料の作製過程で発生する試料断面に現れるカーテン効果を抑制する技術です。試料内部にエッチングレートの異なる材料が混在する場合、試料の薄片化に伴って試料断面に加工スジが発生します。これをカーテン効果と呼びます。観察対象領域上にカーテン効果の加工スジが重なると、TEM観察像に悪影響を及ぼします。そこでEthos NX5000には、ACE技術の一環である回転軸付マイクロサンプリング®(*9)を用いた解析試料の姿勢制御技術2)を搭載しています。この技術を用いることで、薄片試料のTEMメッシュへの固定時の姿勢を制御することができます。これによって試料へのFIBの入射方向を制御することが可能になり、カーテン効果による影響を抑制することができます。

図5 回転軸付きマイクロサンプリングを用いた薄片試料の姿勢制御の様子
「Ethos NX5000」ではSEMによる各種解析を可能とするために拡張性の高いプラットフォームを開発しました。従来のFIB-SEM複合装置「NX2000」では、FIB鏡筒が垂直、SEM鏡筒が斜めに試料室上に配置していたため、SEM鏡筒の周辺に各種オプション用ポートをレイアウトすることができませんでした。新型プラットフォームでは、SEM鏡筒を垂直に試料室上に配置することで、13個の各種オプション用ポートを準備することができました。それによってEDS、EBSD、挿入型CL、挿入型STEM検出器、挿入型BSD検出器などのSEMによる解析用オプションの搭載が可能となりました。
また新開発の150 mm対応5軸ステージによって、最大6インチウェハの全面観察が可能な上、各種試料ホルダによって幅広いサンプルサイズに対応することが可能になりました。
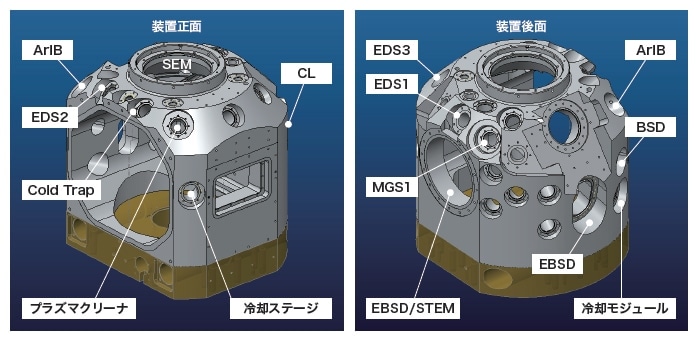
図6 Ethos NX5000の試料室のポートレイアウト
今回開発した「Ethos NX5000」は、2014年9月発売の「NX2000」、2015年6月発売の「NX9000」に続く、日立ハイテクと(株)日立ハイテクサイエンスの共同開発製品です。
今後も両社がこれまでに培ってきたSEM・FIB技術を融合することで、最先端分野の研究開発に貢献してまいります。
参考文献
著者紹介
鈴木 秀和
(株)日立ハイテクサイエンス BT設計部 BT設計一グループ
さらに表示